PCB沉金(ENIG)工藝中的檢測環節是確保鍍層質量、可靠性和一致性的核心手段,貫穿于整個工藝流程。以下是沉金工藝各階段的關鍵檢測項目及方法詳解:
一、前處理階段檢測
銅面清潔度檢測
目的:確保銅面無氧化、油污、指紋等污染物,保證鍍層附著力。
方法:
水膜試驗:滴去離子水于銅面,觀察是否均勻鋪展(連續水膜≥30秒為合格)。
硫酸銅點滴試驗:檢測微蝕后銅面活性(均勻發黑為合格)。
二、沉鎳階段(化學鍍鎳)檢測
鎳層厚度
方法:X射線熒光光譜儀(XRF)非破壞性測量(標準:3-6μm)。
關鍵點:測量焊盤、孔壁等關鍵位置,避免過薄(焊接脆裂)或過厚(應力裂紋)。
鎳層磷含量
目的:磷含量(7-9%)影響耐蝕性及焊接性能。
方法:能量色散X射線光譜儀(EDX)分析。
鎳層均勻性
方法:
切片分析(Cross-section):觀察孔內鎳層覆蓋是否完整(避免“狗骨”現象)。
微蝕后色差對比:微蝕銅面后,觀察鎳層色差判斷均勻性。
三、沉金階段(置換金)檢測
金層厚度
方法:XRF測量(標準:0.05-0.15μm)。
注意:過薄導致孔隙率高,過厚增加成本且可能引起焊點脆化(金脆)。
金層外觀
目檢/AOI:檢查顏色均一性(金黃色)、無露鎳、發黑、污漬、劃傷等缺陷。
孔隙率測試
方法:
電圖形法(如IPC-4552):通過電解顯色檢測針孔(藍色斑點表示鎳層暴露)。
硝酸蒸汽法:暴露鎳層后觀察變色點數量。
四、后處理階段檢測
潔凈度測試
離子污染度(ROSE測試):測量清洗后板面離子殘留(標準:≤1.56 μg/cm2 NaCl當量)。
表面有機污染:FT-IR紅外光譜或接觸角測試。
干燥度驗證
濕度指示卡:包裝內濕度監控(要求RH<10%)。
五、最終出貨前可靠性檢測
可焊性測試
焊球試驗(Solder Ball Test):焊料在鍍層表面應均勻鋪展,無收縮。
潤濕平衡測試:量化潤濕力與時間(標準:IPC-J-STD-003)。
附著力測試
膠帶法(Peel Test):3M膠帶粘貼后撕離,金層無脫落。
熱應力測試
熱循環(TCT):-55°C至125°C循環,驗證鍍層抗熱疲勞能力。
回流焊模擬:3次以上288°C回流,檢查鍍層起泡或剝離。
黑盤(Black Pad)專項檢測
目的:識別鎳層過度腐蝕導致的焊接失效隱患。
方法:
SEM/EDS截面分析:觀察鎳磷層晶界腐蝕及磷富集。
焊點剪切力測試:力值異常下降提示黑盤風險。
六、過程監控與槽液分析
沉鎳槽監控
鎳離子濃度:滴定法或電位滴定。
pH值/溫度:實時監測(pH 4.6-5.2,85-90°C)。
次磷酸鈉還原速率:定期化驗防止老化。
沉金槽監控
金含量:原子吸收光譜(AAS)。
鎳污染:金槽中鎳累積>50ppm需更換。
檢測標準依據
IPC-4552:ENIG鍍層性能及厚度規范。
IPC-A-600:PCB外觀驗收標準。
IEC-60068:環境可靠性測試方法。
常見缺陷與檢測對應關系
?

關鍵控制建議
實時監控槽液參數(溫度/pH/濃度),避免批量異常。
首件檢驗必須包含厚度、外觀、可焊性。
黑盤預防:嚴控沉鎳時間/溫度,避免過度活化。
高可靠性產品增加100%XRF測厚+抽樣切片分析。
通過系統化的檢測策略,可顯著提升ENIG工藝良率,確保PCB在苛刻環境下的長期可靠性。
拍明芯城(www.iczoom.com)是快速撮合的智造服務平臺,服務于一個持續增長的萬億規模的市場。我們為電子產業提供從設計到量產的全流程服務。我們構建了涵蓋PCB打板、BOM配單、SMT貼裝和元器件采銷等關鍵環節的第三方服務平臺,打造一站式元器件供采、PCBA智造及綜合供應鏈解決方案。憑借快速響應、高效交付和全面覆蓋的服務優勢,我們專注于為中小微電子企業提供數字化綜合服務,助力客戶降本增效,加速產品創新及量產上市。

審核編輯 黃宇
-
pcb
+關注
關注
4414文章
23926瀏覽量
425584 -
沉金
+關注
關注
0文章
29瀏覽量
9855
發布評論請先 登錄
激光焊接機在焊接冷凝管的工藝流程

激光焊接機在焊接罐體的工藝流程

激光焊接機在焊接儀表外殼的工藝流程
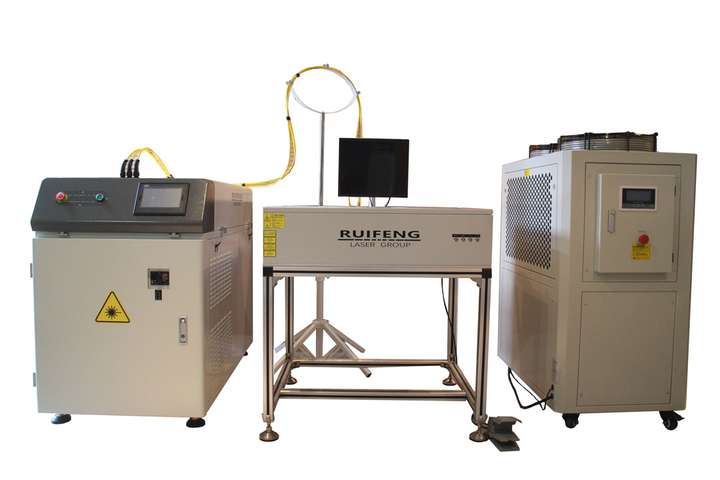
激光焊接機在焊接鋸片的工藝流程

激光焊接機在焊接壓力腔組件的工藝流程
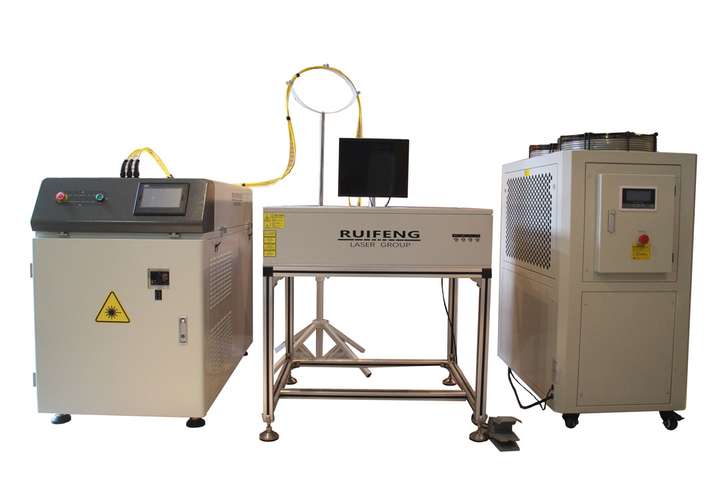
激光焊接機在焊接電加熱管的工藝流程

主板 PCB 工藝之沉金工藝,沉得是真黃金嗎?看完本期你就知道了
哪種工藝更適合高密度PCB?
淺談回流焊接技術的工藝流程
晶圓蝕刻擴散工藝流程

PCB表面處理丨沉錫工藝深度解讀
半導體封裝工藝流程的主要步驟




 PCB沉金工藝流程簡介「檢測環節」
PCB沉金工藝流程簡介「檢測環節」






評論