文章來源:學(xué)習(xí)那些事
原文作者:前路漫漫
本文介紹了半導(dǎo)體封裝框架的外部及封裝體設(shè)計(jì)規(guī)范。
概述
封裝框架的外部結(jié)構(gòu)設(shè)計(jì),核心包含聯(lián)筋(Dambar)與假腳(False leads)兩大關(guān)鍵部分,以下將針對各設(shè)計(jì)要素及技術(shù)要求展開詳細(xì)說明。
聯(lián)筋(Dambar)設(shè)計(jì)規(guī)范
聯(lián)筋的結(jié)構(gòu)形式可參考圖1所示。在封裝工藝中,聯(lián)筋承擔(dān)著雙重核心作用:一是在塑封工序中有效阻隔塑封料的無序流動,二是在切筋工藝實(shí)施前維持外引腳的結(jié)構(gòu)形態(tài)穩(wěn)定性。從設(shè)計(jì)參數(shù)來看,聯(lián)筋的最小寬度通常需設(shè)定為框架厚度的1.2倍,若聯(lián)筋尺寸過薄,極易引發(fā)塑封料溢出現(xiàn)象,影響封裝質(zhì)量。此外,封裝體邊緣至聯(lián)筋區(qū)域的最小間距需控制在0.127mm,該參數(shù)的確定主要基于切筋工序中沖壓模具的實(shí)際加工能力限制。

假腳(False leads)設(shè)計(jì)規(guī)范
假腳的典型設(shè)計(jì)方案如圖2所示。其設(shè)計(jì)初衷是為引腳提供更可靠的支撐,尤其在需要精確定位引腳的場景中,能在切筋成型工序(特別是成型階段)發(fā)揮關(guān)鍵作用——當(dāng)最后一個(gè)功能引腳完成分離成型時(shí),可有效維持封裝體的結(jié)構(gòu)穩(wěn)定性。值得注意的是,若采用一體成型切割工藝,假腳通常不具備實(shí)際功能,反而會增加框架材料消耗及制造成本,因此假腳屬于可選設(shè)計(jì)要素,而非強(qiáng)制要求。
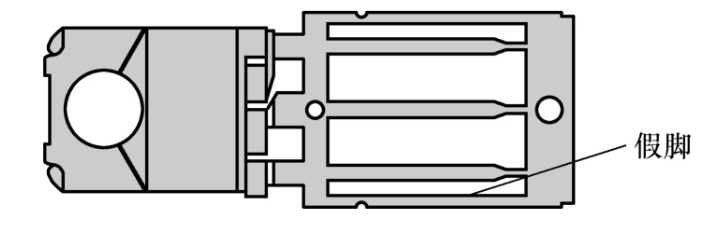
外框架其他設(shè)計(jì)要求
針對多排框架這類特殊結(jié)構(gòu),主聯(lián)筋的寬度設(shè)計(jì)需重點(diǎn)考量劃片工序所用金剛刀的厚度參數(shù),通常應(yīng)使聯(lián)筋寬度小于金剛刀厚度。這是因?yàn)椴糠址庋b體采用金剛刀片切割而非模具沖壓的分離方式,因此在設(shè)計(jì)中預(yù)留專用切割道,并設(shè)置便于圖像識別的花紋或標(biāo)記,對后續(xù)刀片分離工序中設(shè)備的編程校準(zhǔn)至關(guān)重要,具體結(jié)構(gòu)可參考圖3。
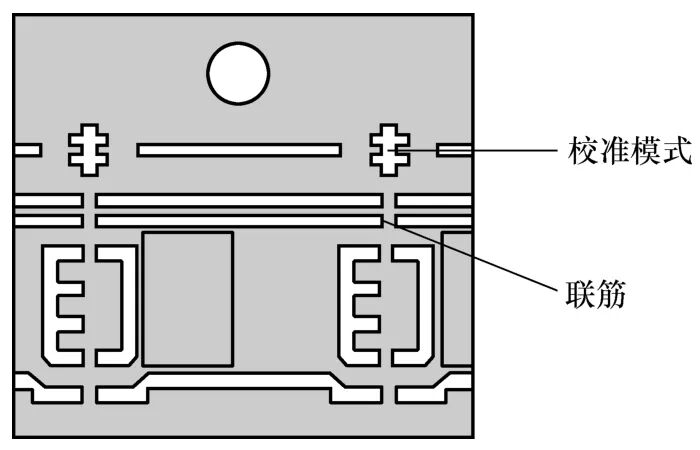
封裝體設(shè)計(jì)規(guī)范
封裝體的核心構(gòu)成材料為金屬與塑封料,二者的體積配比是設(shè)計(jì)關(guān)鍵。理想狀態(tài)下,金屬材料的體積占比應(yīng)不超過封裝體總體積的50%。若金屬含量超出該閾值,必須深入分析材料間的應(yīng)力分布特性,以及在恒定溫度與交變溫度環(huán)境下的可靠性表現(xiàn)。這是因?yàn)槎鄶?shù)半導(dǎo)體器件在PCB板安裝過程中,需承受200~300℃的高溫回流焊,而不同材料的熱膨脹系數(shù)存在差異,易在結(jié)合部位產(chǎn)生應(yīng)力集中,導(dǎo)致封裝體出現(xiàn)分層、裂紋、爆米花等缺陷,嚴(yán)重時(shí)會喪失對芯片的保護(hù)功能(關(guān)于封裝質(zhì)量問題的詳細(xì)分析可以參考之前的文章)。
因此,為保障封裝體設(shè)計(jì)的可靠性與穩(wěn)定性,當(dāng)出現(xiàn)金屬含量占比超標(biāo)(超過50%)、采用未經(jīng)驗(yàn)證的封裝結(jié)構(gòu)、使用新型塑封料配方或框架基板材料變更等情況時(shí),設(shè)計(jì)者需重點(diǎn)掌握以下內(nèi)容:
對于無參考依據(jù)的全新封裝體設(shè)計(jì),必須通過有限元建模、模流仿真及力學(xué)仿真(重點(diǎn)針對切筋成型工藝),全面掌握結(jié)構(gòu)力學(xué)特性,并將分析結(jié)果納入設(shè)計(jì)DFMEA文件。
需系統(tǒng)掌握芯片、內(nèi)互聯(lián)導(dǎo)線、裝片材料、框架及塑封料的馮·米塞斯應(yīng)力(Von Mises Stress)分布情況,確保封裝體設(shè)計(jì)參數(shù)不超過材料的極限應(yīng)力閾值。
完成框架設(shè)計(jì)相關(guān)的受力分析,尤其是切筋成型工藝中的受力狀態(tài)研究,將分析結(jié)果及改進(jìn)措施同步納入設(shè)計(jì)DFMEA文件。
(一)封裝體傾斜角設(shè)計(jì)
封裝體的傾斜角(Draft Angle)設(shè)計(jì)與脫模工藝直接相關(guān),其最小設(shè)計(jì)值可參考圖4,具體規(guī)范如下:

全包封塑封體若采用型腔彈出針(cavity ejector pin)輔助脫模,傾斜角一般設(shè)計(jì)為5°;
全包封塑封體未使用型腔彈出針時(shí),傾斜角通常控制在7°~10°;
半包封塑封體未使用型腔彈出針時(shí),傾斜角標(biāo)準(zhǔn)值為7°。
(二)封裝體倒角半徑設(shè)計(jì)
封裝體倒角半徑的設(shè)計(jì)需結(jié)合封裝形式及模具加工工藝:全包封結(jié)構(gòu)的典型倒角半徑為0.05~0.127mm;采用電火花加工或精磨工藝制造的模具,其對應(yīng)封裝體的倒角半徑應(yīng)控制在0.13~0.17mm。
(三)外引腳抬起高度(Stand-off)設(shè)計(jì)
外引腳抬起高度需符合JEDEC與EIAJ標(biāo)準(zhǔn)要求(結(jié)構(gòu)示意如圖5)。對于無標(biāo)準(zhǔn)參考的全新封裝體,不同類型的高度參數(shù)規(guī)范如下:薄型封裝(Low Profile)為0.0127~0.10mm;高型封裝(High Profile)為0.127~0.254mm;多排封裝類型則為0.00~0.05mm。
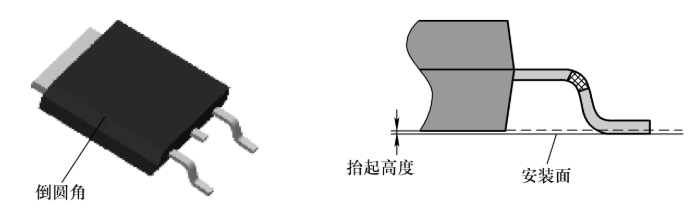
(四)引腳肩部長度(Lead Shoulder Length)設(shè)計(jì)
引腳肩部長度的設(shè)計(jì)參數(shù)需結(jié)合成型工藝及封裝類型確定(如圖6所示),具體要求如下:
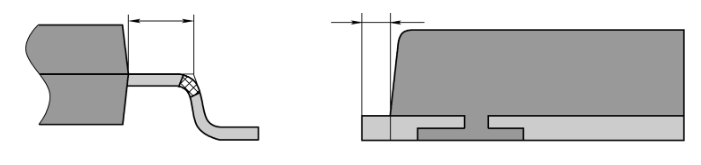
成型過程中使用墊塊時(shí),其典型值取(框架厚度+引腳電鍍層厚度)的1/2;
無墊塊直接成型時(shí),封裝體本體成型誤差通常在0~0.025mm。需明確的是,引腳肩部長度指封裝體邊緣至引腳彎曲圓弧中心的距離,該平坦區(qū)域處于首次與二次彎曲的中間位置,可通過相機(jī)視覺系統(tǒng)清晰識別;
多排封裝結(jié)構(gòu)中,引腳肩部長度定義為封裝體邊緣至引腳邊緣的距離,一般取值0.075~0.125mm;
引腳彎曲半徑(BR)的最小值為(框架厚度+引腳電鍍層最大厚度)平方根的1/2,即BR=1/2×√(框架厚度+引腳電鍍層最大厚度)。
(五)引腳接觸長度與角度設(shè)計(jì)
引腳接觸長度(Foot Landing)的標(biāo)準(zhǔn)設(shè)計(jì)值為0.10mm,具體結(jié)構(gòu)如圖7所示。引腳角度(Lead Angle)的設(shè)計(jì)規(guī)范為:相對垂直方向的角度范圍為0°~10°,引腳端部相對水平方向的角度范圍為0°~5°,詳細(xì)示意如圖8。
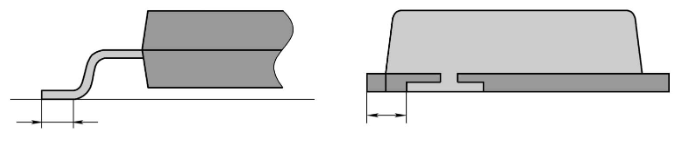 ?
? 
-
半導(dǎo)體
+關(guān)注
關(guān)注
339文章
30916瀏覽量
265219 -
封裝
+關(guān)注
關(guān)注
128文章
9283瀏覽量
148816 -
工藝
+關(guān)注
關(guān)注
4文章
715瀏覽量
30360
原文標(biāo)題:半導(dǎo)體封裝框架外部及封裝體設(shè)計(jì)規(guī)范
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
操作系統(tǒng)結(jié)構(gòu)設(shè)計(jì)
招聘結(jié)構(gòu)設(shè)計(jì)師
招聘半導(dǎo)體封裝工程師
招聘--結(jié)構(gòu)設(shè)計(jì)師
淺談產(chǎn)品結(jié)構(gòu)設(shè)計(jì)特點(diǎn)
蝶式五軌滑蓋結(jié)構(gòu)設(shè)計(jì)與磁動力滑蓋結(jié)構(gòu)設(shè)計(jì)的不同之處在哪?
軸系結(jié)構(gòu)設(shè)計(jì)實(shí)驗(yàn)
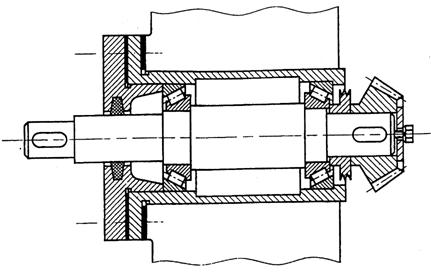
輪輻轉(zhuǎn)子的結(jié)構(gòu)設(shè)計(jì)
淺談產(chǎn)品結(jié)構(gòu)設(shè)計(jì)類別及產(chǎn)品結(jié)構(gòu)設(shè)計(jì)的重要性
電機(jī)控制器結(jié)構(gòu)設(shè)計(jì)框架介紹
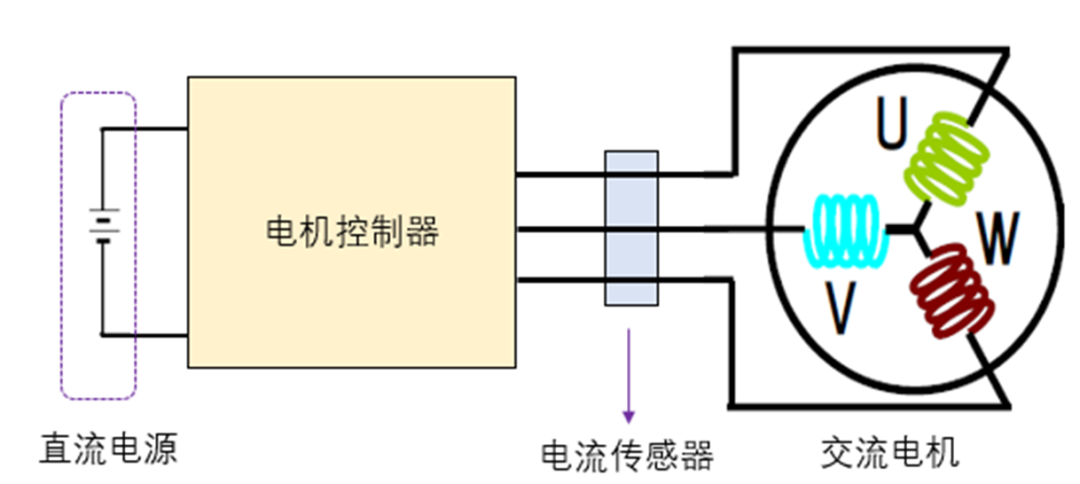
自主創(chuàng)新賦能半導(dǎo)體封裝產(chǎn)業(yè)——江蘇拓能半導(dǎo)體科技有限公司與 “半導(dǎo)體封裝結(jié)構(gòu)設(shè)計(jì)軟件” 的突破之路




 半導(dǎo)體封裝框架的外部結(jié)構(gòu)設(shè)計(jì)
半導(dǎo)體封裝框架的外部結(jié)構(gòu)設(shè)計(jì)




評論