InP-on-Si(IMOS)作為一種新興的光子集成平臺,因其能夠將高性能有源與無源光子器件異質集成在硅基電路之上而備受關注。然而,隨著波導尺寸的急劇縮小,光場與波導表面的相互作用顯著增強,導致刻蝕工藝引入的側壁與底面粗糙度成為制約傳播損耗的主要因素。同時,為實現緊湊的光路設計與低偏振串擾,要求刻蝕剖面具有近乎垂直的側壁形貌。同時,為實現緊湊的光路設計與低偏振串擾,要求刻蝕剖面具有近乎垂直的側壁形貌。Flexfilm探針式臺階儀可以實現表面微觀特征的精準表征與關鍵參數的定量測量,精確測定樣品的表面臺階高度與膜厚,為材料質量把控和生產效率提升提供數據支撐。
傳統單步反應離子刻蝕(RIE)工藝難以同時滿足低粗糙度、高垂直度及高選擇性的要求,通常存在側壁傾斜與掩模底切問題。為此,本文提出一種基于CH?/H?/Ar氣體的優化單步RIE工藝。通過精細調控RF功率等關鍵參數,該工藝首次在單步刻蝕中實現了高側壁垂直度(88°)、無掩模底切、高選擇性(>100:1)與超平滑刻蝕表面(RMS < 0.7 nm),為制備低損耗、高性能的InP膜波導提供了有效的解決方案。
1
單步RIE工藝設計
flexfilm

波導基模(TE模式)與InP膜波導表面粗糙度的相互作用示意圖

刻蝕實驗中使用的樣品截面幾何結構示意圖:(a) 薄膜樣品;(b) 厚膜樣品
實驗采用兩種膜結構樣品:薄膜(用于無源波導)與厚膜(用于放大器與探測器),刻蝕深度分別約為200 nm與800 nm。刻蝕在SENTECH Si500 ICP設備上進行,運行于RIE模式(ICP射頻源關閉)。選擇RIE工藝因其相比ICP-RIE具有更高的選擇性與更平滑的刻蝕表面。
選用CH?/H?氣體組合,因其刻蝕后表面損傷小、掩模消耗低且刻蝕深度易于控制。主要挑戰在于聚合物形成:一方面可保護掩模以提高選擇性,另一方面也會影響刻蝕剖面。通過添加氬氣(Ar)可調控聚合物形成過程。氣體比例中較高的氫氣份額有助于防止因過量聚合物沉積引起的自發微掩蔽。
單步刻蝕方案相比循環工藝(交替進行CH?/H?刻蝕與O?去膠)具有工藝時間短、可直接使用光刻膠掩模的優點,但以往報道的單步工藝側壁角度較差(84–85°),且因側壁傾斜導致硬掩模下方出現底切,影響波導關鍵尺寸精度。
2
工藝參數優化實驗
flexfilm

刻蝕測試參數表

使用表中配方刻蝕的薄膜樣品的掃描電子顯微鏡(SEM)圖片(傾斜頂視圖):(a) 測試1;(b) 測試2;(c) 測試3;(d) 測試4
通過一系列實驗研究CH?/H?比例與工藝壓力對刻蝕表面粗糙度的影響,實驗條件如表所示。結果顯示,CH?/H?比例對表面粗糙度影響顯著,低CH?濃度導致聚合物形成減少、濺射增強;較高的工藝壓力(75 mT)因由物理濺射向化學刻蝕的轉變,可獲得更平滑的表面。

使用測試3配方刻蝕的波導截面SEM圖片:(a) 薄膜樣品;(b) 厚膜樣品。圖中標出了SiN?硬掩模及底切區域
然而,采用優化配方(測試3)刻蝕的波導剖面顯示側壁斜率較大,且SiN?掩模下存在明顯底切,隨著刻蝕深度增加,底切進一步擴大。
3
垂直度改善與底切消除
flexfilm

刻蝕測試結構的測量側壁角度和底切(以每500 nm刻深對應的納米數表示)隨RF功率變化的函數關系圖
通過精細調節RF功率(75–250 W),首次實現了具有平滑表面、垂直側壁且無掩模底切的單步RIE工藝。結果表明,隨著RF功率降低,刻蝕垂直度顯著提升。
在100 W RF功率下獲得88°側壁角度,為單步RIE工藝中最佳值。其機理在于低RF功率下等離子體密度與離子能量降低,低動能離子無法濺射側壁聚合物鈍化層,從而維持垂直剖面。RF功率高于200 W時出現底切,低于200 W則底切消失。

刻蝕測試結構的測量刻蝕速率和選擇性隨RF功率變化的函數關系圖
刻蝕速率隨RF功率降低近乎線性下降,歸因于等離子體密度降低。InP與SiN?掩模的選擇性始終高于100,有利于波導定義。

AFM測量的刻蝕測試結構底部表面RMS粗糙度隨RF功率變化的函數關系圖
刻蝕底部表面RMS粗糙度維持在0.6–0.7 nm,與文獻報道的低粗糙度結果相當,且未發現RF功率對粗糙度的明顯影響。

使用優化工藝刻蝕的波導結構SEM圖片:(a) 薄膜樣品;(b) 厚膜樣品

優化后的工藝參數
綜合各項指標,初步實驗表明,較高的工藝壓力(75 mT)和適當的CH?/H?比例(如30/70)有利于獲得更平滑的刻蝕底面。
4
波導制備與損耗測量
flexfilm

InP膜波導制備工藝流程圖:(a) 晶圓鍵合;(b) 去除InP襯底及InGaAs犧牲層;(c) 第一次電子束光刻定義波導圖案;(d) 波導刻蝕;(e) 第二次電子束光刻定義光柵圖案;(f) 光柵刻蝕后的最終器件結構
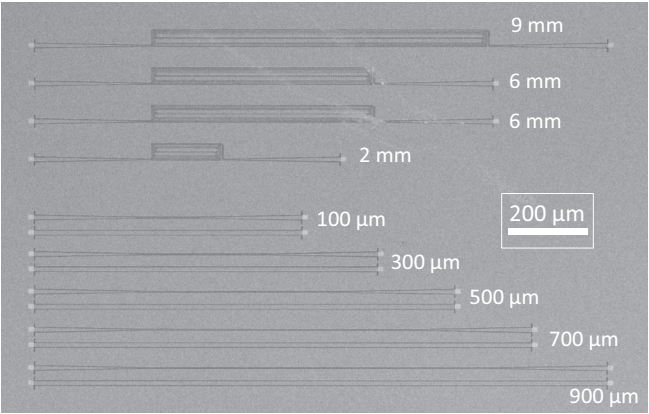
在InP膜上制備的波導的SEM圖片,圖中標注了不同波導的長度
基于上述優化工藝,制備了不同長度的InP膜波導以測量傳播損耗。制備流程,包括SiO?沉積、晶圓鍵合、襯底與犧牲層濕法去除、兩次EBL(分別定義波導與光柵耦合器)等步驟。波導寬度為400 nm,刻蝕深度280 nm,在1550 nm波長下為單模工作。

測量的InP膜波導插入損耗(包含傳播損耗和光柵耦合損耗)隨波導長度變化的函數關系圖
損耗測量采用1550 nm激光,通過光柵耦合器將光耦合進/出波導。顯示插入損耗與波導長度的關系,線性擬合得到傳播損耗為2.5 dB/cm,每個光柵耦合器的光纖-光柵耦合損耗為5.6 dB。相比之前報道的3.3 dB/cm,該結果創下新低。
本文報道了一種基于單步RIE與CH?/H?/Ar化學的新型InP光波導刻蝕工藝。首次通過精細調節RF功率,在單步RIE工藝中顯著改善了刻蝕剖面的垂直度并消除了底切。優化工藝實現了接近垂直的側壁(88°)、無掩模底切、高選擇性(約130)以及平滑的刻蝕表面。制備的膜波導傳播損耗降至2.5 dB/cm,證明了該工藝在低損耗InP膜波導刻蝕中的優越性,且對其他類型InP基光波導刻蝕具有重要應用潛力。
Flexfilm探針式臺階儀
flexfilm

在半導體、光伏、LED、MEMS器件、材料等領域,表面臺階高度、膜厚的準確測量具有十分重要的價值,尤其是臺階高度是一個重要的參數,對各種薄膜臺階參數的精確、快速測定和控制,是保證材料質量、提高生產效率的重要手段。
- 配備500W像素高分辨率彩色攝像機
- 亞埃級分辨率,臺階高度重復性1nm
- 360°旋轉θ平臺結合Z軸升降平臺
- 超微力恒力傳感器保證無接觸損傷精準測量
費曼儀器作為國內領先的薄膜厚度測量技術解決方案提供商,Flexfilm探針式臺階儀可以對薄膜表面臺階高度、膜厚進行準確測量,保證材料質量、提高生產效率。
原文參考:《Vertical and Smooth Single-Step Reactive Ion Etching Process for InP Membrane Waveguides》
*特別聲明:本公眾號所發布的原創及轉載文章,僅用于學術分享和傳遞行業相關信息。未經授權,不得抄襲、篡改、引用、轉載等侵犯本公眾號相關權益的行為。內容僅供參考,如涉及版權問題,敬請聯系,我們將在第一時間核實并處理。
-
測量儀器
+關注
關注
3文章
906瀏覽量
46644 -
刻蝕工藝
+關注
關注
2文章
43瀏覽量
8825
發布評論請先 登錄
白光干涉儀可以測曲面粗糙度嗎?
什么是表面粗糙度?如何測量表面粗糙度?
臺階儀應用 | 半導體GaAs/Si異質外延層表面粗糙度優化

臺階儀在3D打印中的應用:精確測量物體表面粗糙度

臺階儀在機翼氣動性能中的應用:基于NASA案例的表面粗糙度精確量化

NIST研究院:表面粗糙度與臺階高度校準規范

臺階儀在Mo?C薄膜測量中的應用 | 粗糙化比率&gt;1的薄膜材料




 臺階儀在刻蝕工藝RIE中的應用:關鍵參數精確調控與表面粗糙度控制
臺階儀在刻蝕工藝RIE中的應用:關鍵參數精確調控與表面粗糙度控制









評論