傾佳電子基于 BMF360R12KA3 的固態(tài)變壓器 (SST) 功率單元設(shè)計(jì)方案與關(guān)鍵技術(shù)分析

傾佳電子(Changer Tech)是一家專(zhuān)注于功率半導(dǎo)體和新能源汽車(chē)連接器的分銷(xiāo)商。主要服務(wù)于中國(guó)工業(yè)電源、電力電子設(shè)備和新能源汽車(chē)產(chǎn)業(yè)鏈。傾佳電子聚焦于新能源、交通電動(dòng)化和數(shù)字化轉(zhuǎn)型三大方向,并提供包括IGBT、SiC MOSFET、GaN等功率半導(dǎo)體器件以及新能源汽車(chē)連接器。?
傾佳電子楊茜致力于推動(dòng)國(guó)產(chǎn)SiC碳化硅模塊在電力電子應(yīng)用中全面取代進(jìn)口IGBT模塊,助力電力電子行業(yè)自主可控和產(chǎn)業(yè)升級(jí)!
傾佳電子楊茜咬住SiC碳化硅MOSFET功率器件三個(gè)必然,勇立功率半導(dǎo)體器件變革潮頭:
傾佳電子楊茜咬住SiC碳化硅MOSFET模塊全面取代IGBT模塊和IPM模塊的必然趨勢(shì)!
傾佳電子楊茜咬住SiC碳化硅MOSFET單管全面取代IGBT單管和大于650V的高壓硅MOSFET的必然趨勢(shì)!
傾佳電子楊茜咬住650V SiC碳化硅MOSFET單管全面取代SJ超結(jié)MOSFET和高壓GaN 器件的必然趨勢(shì)!
1. 導(dǎo)言:系統(tǒng)化分析 BMF360R12KA3 模塊用于 SST 應(yīng)用
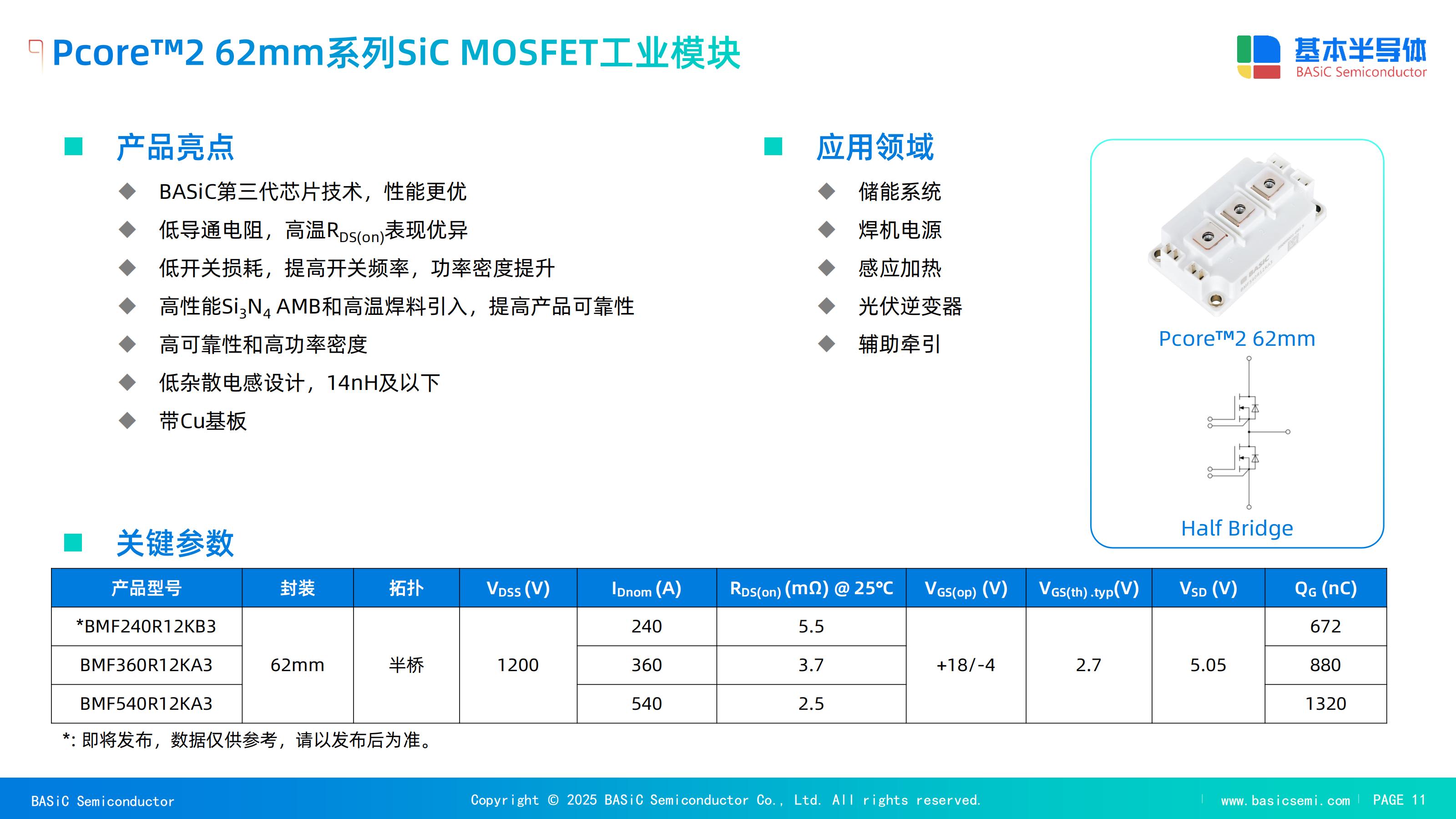
固態(tài)變壓器 (SST) 代表了電力電子技術(shù)在智能電網(wǎng)和先進(jìn)配電系統(tǒng)中的一個(gè)關(guān)鍵發(fā)展方向。SST 的核心是一個(gè)高功率、高頻、隔離的雙向 DC/DC 變換器 。此類(lèi)應(yīng)用對(duì)功率半導(dǎo)體器件提出了極端要求:高阻斷電壓、大電流能力、低導(dǎo)通損耗、極低的開(kāi)關(guān)損耗以及在高溫下的高可靠性。
本報(bào)告的目標(biāo)是基于基本半導(dǎo)體 (BASIC Semiconductor) 提供的 BMF360R12KA3 型 1200V SiC MOSFET 模塊,設(shè)計(jì)一個(gè)完整的高性能 SST 功率單元。BMF360R12KA3 是一款基于碳化硅 (SiC) 技術(shù)的半橋功率模塊,其選型表明設(shè)計(jì)目標(biāo)是高功率密度和高效率 3。本分析將深入探討該模塊的關(guān)鍵參數(shù),識(shí)別設(shè)計(jì)瓶頸,并提出一個(gè)集成了拓?fù)浣Y(jié)構(gòu)、柵極驅(qū)動(dòng)、保護(hù)電路、損耗優(yōu)化、熱管理和物理布的完整工程設(shè)計(jì)方案。
1.1 關(guān)鍵電氣規(guī)格與設(shè)計(jì)解讀
BMF360R12KA3 模塊的初步規(guī)格表 提供了設(shè)計(jì)的基礎(chǔ)輸入:
額定電壓 ($V_{DSS}$): 1200 V。
額定電流 ($I_D$): 360 A (在 $T_C = 90^{circ}text{C}$ 時(shí))。
典型導(dǎo)通電阻 ($R_{DS(on)}$): $3.7text{ m}Omega$ (在 $V_{GS} = 18text{ V}, T_{vj} = 25^{circ}text{C}$ 時(shí))。
封裝: 62mm 工業(yè)標(biāo)準(zhǔn)半橋模塊,采用 $Si_3N_4$ 氮化硅陶瓷襯底和銅基板 。
設(shè)計(jì)解讀 (一):額定電流的務(wù)實(shí)性
模塊規(guī)格在 90°C 殼溫 ($T_C$) 而非傳統(tǒng)的 25°C 下標(biāo)定 360 A 的額定電流,這是一個(gè)關(guān)鍵的務(wù)實(shí)性指標(biāo)。在 SST 這樣的高功率應(yīng)用中,25°C 的 $T_C$ 是不切實(shí)際的。90°C 的標(biāo)定為設(shè)計(jì)者提供了更接近實(shí)際工況的性能基線。然而,這也意味著器件的熱設(shè)計(jì)裕量在“規(guī)格層面”已經(jīng)被部分使用。一個(gè)穩(wěn)健的工程設(shè)計(jì)必須基于一個(gè)更嚴(yán)苛、更真實(shí)的 $T_C$(例如 100°C 或 110°C)進(jìn)行進(jìn)一步的降額計(jì)算,以確保系統(tǒng)在各種負(fù)載條件下的可靠性。
設(shè)計(jì)解讀 (二):封裝技術(shù)的先進(jìn)性
采用 $Si_3N_4$ 陶瓷襯底而非傳統(tǒng)的 $Al_2O_3$(氧化鋁),提供了卓越的熱循環(huán)能力和更高的可靠性。銅基板則確保了從芯片到散熱器的高效熱量傳遞 3。這表明該模塊專(zhuān)為嚴(yán)苛的工業(yè)應(yīng)用而設(shè)計(jì),能夠承受 SST 運(yùn)行中可能出現(xiàn)的功率波動(dòng)。
1.2 靜態(tài)特性的關(guān)鍵挑戰(zhàn):$R_{DS(on)}$ 與溫度的關(guān)系
SST 功率單元的效率在很大程度上取決于器件的導(dǎo)通損耗。BMF360R12KA3 的靜態(tài)特性 顯示了一個(gè)必須正視的核心挑戰(zhàn)。
$R_{DS(on)}$ 的溫度敏感性:
$T_{vj} = 25^{circ}text{C}$: 典型 $R_{DS(on)} = 3.7text{ m}Omega$ (芯片值)。
$T_{vj} = 175^{circ}text{C}$: 典型 $R_{DS(on)} = 6.4text{ m}Omega$ (芯片值)。
設(shè)計(jì)解讀 (三):高溫?fù)p耗的主導(dǎo)地位
從 25°C 到 175°C, $R_{DS(on)}$ 上升了約 73%。這意味著器件在接近其最高結(jié)溫運(yùn)行時(shí),其導(dǎo)通損耗 ($P_{cond} = I_{RMS}^2 times R_{DS(on)}$) 將比室溫下高出近四分之三。
這是一個(gè)災(zāi)難性的警告:任何基于 25°C 數(shù)據(jù)進(jìn)行的損耗估算或散熱設(shè)計(jì),都將導(dǎo)致系統(tǒng)性、嚴(yán)重的散熱不足,并最終導(dǎo)致熱失控和模塊失效。因此,本報(bào)告中所有的損耗和熱設(shè)計(jì)計(jì)算,必須基于 175°C (或降額后的 150°C) 的 $R_{DS(on)}$ 數(shù)據(jù)進(jìn)行。
同時(shí),這種強(qiáng)正溫度系數(shù)特性對(duì)于模塊內(nèi)部并聯(lián)的多個(gè) SiC MOSFET 芯片的均流是有益的。當(dāng)某個(gè)芯片溫度升高時(shí),其電阻相應(yīng)增大,從而抑制流經(jīng)該芯片的電流,迫使電流流向其他溫度較低的芯片,實(shí)現(xiàn)被動(dòng)的自均流。
柵極閾值電壓 ($V_{GS(th)}$): 典型值為 2.7 V (范圍 2.3 V 至 3.5 V) 。這是一個(gè)相對(duì)較低的閾值。在 SiC 器件經(jīng)受極高 $dV/dt$(電壓變化率)的橋式電路中,這種低閾值使得器件極易受到 Miller 電流的干擾而發(fā)生寄生導(dǎo)通(誤導(dǎo)通)。這直接決定了柵極驅(qū)動(dòng)設(shè)計(jì)必須采用強(qiáng)大的負(fù)偏壓(如 -4 V)和主動(dòng) Miller 鉗位技術(shù),以確保關(guān)斷狀態(tài)的穩(wěn)定性。
1.3 動(dòng)態(tài)特性的決定性影響:ZVS 的必要性
SST 的高功率密度是通過(guò)高開(kāi)關(guān)頻率(例如 100 kHz 或更高)實(shí)現(xiàn)的 。BMF360R12KA3 的動(dòng)態(tài)參數(shù) 揭示了本設(shè)計(jì)的最關(guān)鍵約束。
開(kāi)關(guān)能量 (在 $V_{DS}=600text{V}, I_D=360text{A}, R_{G(on)}=2.0Omega, R_{G(off)}=0.5Omega$):
$T_{vj} = 175^{circ}text{C}$:
開(kāi)通能量 ($E_{on}$): 8.8 mJ (包含二極管反向恢復(fù)能量) 。
關(guān)斷能量 ($E_{off}$): 4.6 mJ 。
設(shè)計(jì)解讀 (四):硬開(kāi)關(guān)的不可行性
讓我們進(jìn)行一個(gè)基于 100 kHz 開(kāi)關(guān)頻率 ($f_{sw}$) 的硬開(kāi)關(guān) (Hard Switching) 損耗計(jì)算。單個(gè) MOSFET 的開(kāi)關(guān)損耗為:
$P_{sw} = (E_{on} + E_{off}) times f_{sw} = (8.8text{ mJ} + 4.6text{ mJ}) times 100text{ kHz}$
$P_{sw} = 13.4text{ mJ} times 100,000text{ Hz} = 1340text{ W}$
查閱數(shù)據(jù)手冊(cè),該模塊的最大允許功耗 ($P_D$) 在 $T_C = 25^{circ}text{C}$ 時(shí)僅為 1143 W 。
結(jié)論是明確且不容置疑的:在 100 kHz 下,僅硬開(kāi)關(guān)損耗 (1340 W) 就已經(jīng)超過(guò)了模塊的總最大耗散功率 (1143 W),這甚至還沒(méi)有考慮占主導(dǎo)地位的導(dǎo)通損耗。
因此,使用 BMF360R12KA3 模塊在 100 kHz 下進(jìn)行硬開(kāi)關(guān)操作在物理上是不可能的。
設(shè)計(jì)解讀 (五):零電壓開(kāi)關(guān) (ZVS) 的強(qiáng)制性、
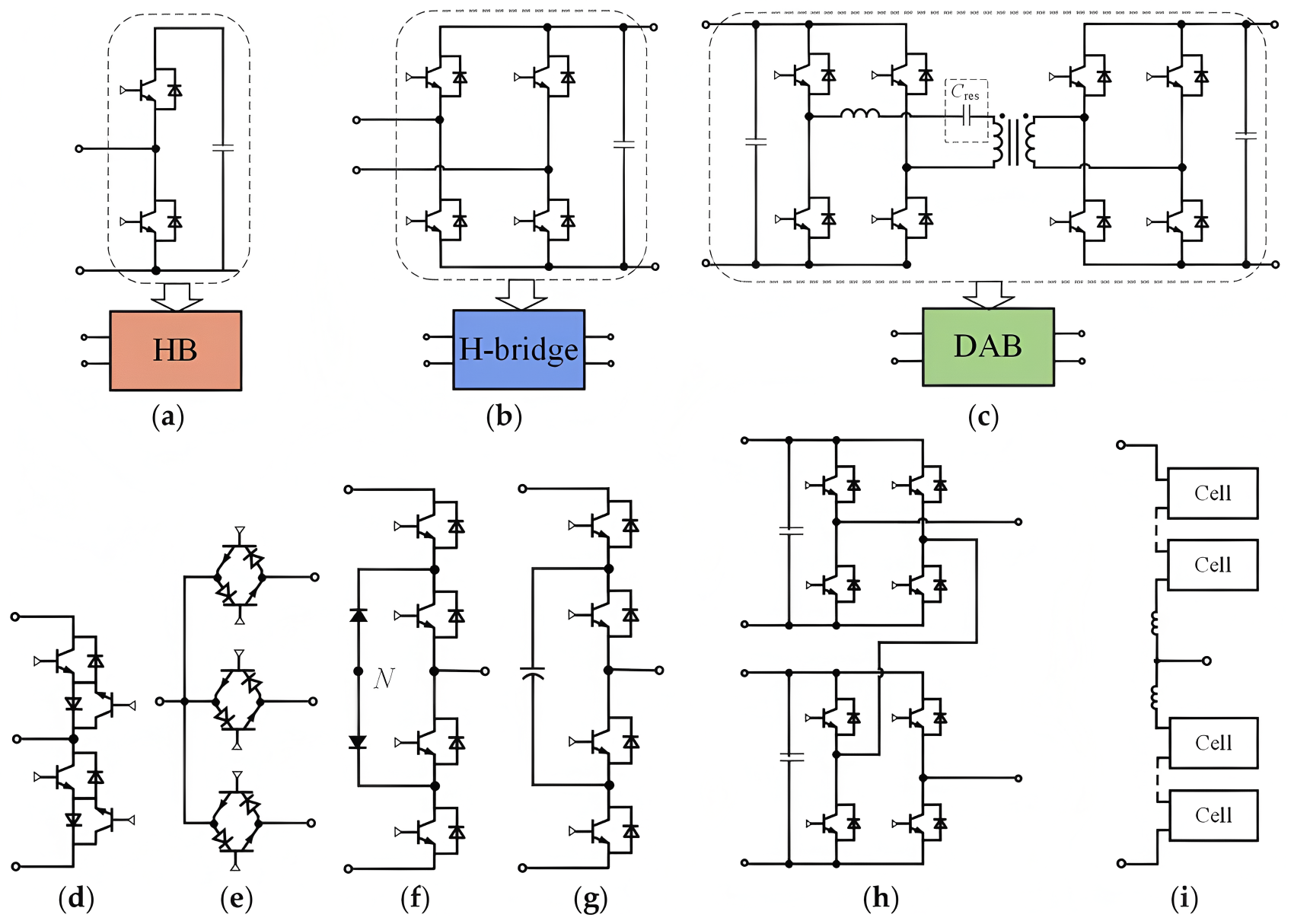
唯一的解決方案是采用軟開(kāi)關(guān)拓?fù)洹T?SST 應(yīng)用中,這意味著必須采用雙有源橋 (DAB) 拓?fù)洌⑼ㄟ^(guò)精確控制,實(shí)現(xiàn)零電壓開(kāi)關(guān) (ZVS)。
ZVS 的目標(biāo)是在 MOSFET 導(dǎo)通前,利用電感電流將其漏源電壓 $V_{DS}$ 降至零。這將使 $E_{on}$ 損耗(包含二極管反向恢復(fù))幾乎降至零 7。$E_{on}$ (8.8 mJ) 遠(yuǎn)大于 $E_{off}$ (4.6 mJ) 的事實(shí)進(jìn)一步強(qiáng)化了 ZVS 的必要性,因?yàn)?ZVS 恰好消除了最大的損耗來(lái)源。因此,本設(shè)計(jì)的拓?fù)溥x擇和控制策略必須強(qiáng)制實(shí)現(xiàn) ZVS。
輸出電容儲(chǔ)能 ($E_{oss}$): 在 $V_{DS} = 800text{V}$ 時(shí)為 343 $mu$J 。這是在 ZVS 過(guò)渡期間,在死區(qū)時(shí)間內(nèi)需要從 $C_{oss}$ 中抽走的能量。該參數(shù)是計(jì)算 ZVS 實(shí)現(xiàn)條件(所需電感電流)的核心依據(jù)(詳見(jiàn)第 5 節(jié))。
熱阻 ($R_{th(j-c)}$): 結(jié)到殼熱阻為 0.11 K/W (每顆 MOSFET) 。這是一個(gè)極低(即極好)的數(shù)值,證實(shí)了 $Si_3N_4$ 襯底和銅基板的高性能。它為耗散 ZVS 運(yùn)行下仍然存在的大量導(dǎo)通損耗和關(guān)斷損耗提供了可能。
1.4 運(yùn)行條件與風(fēng)險(xiǎn)管理
柵極驅(qū)動(dòng)電壓: 數(shù)據(jù)手冊(cè)推薦值為 $V_{GS(on)} = +18text{ V}$ 和 $V_{GS(off)} = -4text{ V}$ 3。+18 V 確保器件完全導(dǎo)通,實(shí)現(xiàn)最低的 $R_{DS(on)}$;-4 V 提供了對(duì)抗 Miller 效應(yīng)和 $V_{GS(th)}$ 漂移的魯棒噪聲裕度 。這是本設(shè)計(jì)的強(qiáng)制性輸入?yún)?shù)。
設(shè)計(jì)解讀 (六):基于驗(yàn)證的設(shè)計(jì)流程
依賴(lài)初步數(shù)據(jù)手冊(cè)構(gòu)建一個(gè)高成本、高功率的 SST 原型機(jī)具有極大風(fēng)險(xiǎn)。設(shè)計(jì)必須是靈活的,并且必須包含一個(gè)強(qiáng)制性的驗(yàn)證階段。
靈活性: 關(guān)鍵無(wú)源元件(如柵極電阻 $R_G$、DESAT 保護(hù)的空白電容 $C_{BLK}$)必須設(shè)計(jì)為易于調(diào)諧和更換。
裕量: 熱設(shè)計(jì)(第 6 節(jié))必須留有顯著裕量,例如,目標(biāo)結(jié)溫 $T_{vj}$ 應(yīng)限制在 150°C,而不是 175°C。
驗(yàn)證: 在構(gòu)建完整的 DAB 之前,必須搭建一個(gè)雙脈沖測(cè)試 (DPT) 平臺(tái) ,以實(shí)測(cè)購(gòu)入模塊的 $R_{DS(on)}$, $E_{sw}$ 和 $Q_{rr}$。這些實(shí)測(cè)數(shù)據(jù)將用于修正損耗模型和保護(hù)電路參數(shù)。
表 1:BMF360R12KA3 用于 SST 設(shè)計(jì)的關(guān)鍵高溫運(yùn)行參數(shù)
| 參數(shù) | 符號(hào) | 測(cè)試條件 | 典型值 | 單位 | 數(shù)據(jù)來(lái)源 |
|---|---|---|---|---|---|
| 阻斷電壓 | $V_{DSS}$ | - | 1200 | V | 3 |
| 導(dǎo)通電阻 | $R_{DS(on).typ}$ (芯片) | $V_{GS}=18text{V}, I_D=360text{A}, T_{vj}=175^{circ}text{C}$ | 6.4 | $text{m}Omega$ | 3 |
| 體二極管正向壓降 | $V_{SD.typ}$ (芯片) | $V_{GS}=-4text{V}, I_{SD}=360text{A}, T_{vj}=175^{circ}text{C}$ | 4.47 | V | 3 |
| 開(kāi)通能量 | $E_{on.typ}$ | $V_{DS}=600text{V}, I_D=360text{A}, T_{vj}=175^{circ}text{C}$ | 8.8 | mJ | 3 |
| 關(guān)斷能量 | $E_{off.typ}$ | $V_{DS}=600text{V}, I_D=360text{A}, T_{vj}=175^{circ}text{C}$ | 4.6 | mJ | 3 |
| 輸出電容能量 | $E_{oss}$ | $V_{DS}=800text{V}, V_{GS}=0text{V}$ | 343 | $mutext{J}$ | 3 |
| 總柵極電荷 | $Q_G$ | $V_{DS}=800text{V}, I_D=240text{A}$ | 880 | nC | 3 |
| 結(jié)殼熱阻 | $R_{th(j-c)}$ | 每顆 MOSFET | 0.11 | K/W | 3 |
| 推薦柵極電壓 | $V_{GS(on)} / V_{GS(off)}$ | - | +18 / -4 | V | 3 |
2. 拓?fù)涠x:雙有源橋 (DAB) 作為 SST 核心

2.1 DAB 拓?fù)涞暮侠硇?/p>
SST 的核心功能是在兩個(gè)不同的(通常是中壓和低壓)DC 總線之間提供高功率、雙向的能量交換,同時(shí)實(shí)現(xiàn)電流隔離 。雙有源橋 (Dual Active Bridge, DAB) 拓?fù)涫菍?shí)現(xiàn)這一功能的行業(yè)標(biāo)準(zhǔn)和最優(yōu)選擇 。
DAB 拓?fù)涞膬?yōu)勢(shì)與 SST 的要求完美契合:
高功率密度: 通過(guò)高頻隔離變壓器(例如 100 kHz)傳遞功率,使得變壓器和濾波器的尺寸及重量相比于工頻變壓器大幅減小 。
高效率: 利用 SiC MOSFET 的高速特性,DAB 拓?fù)淠軌蛟诖蠊β史秶鷥?nèi)實(shí)現(xiàn) ZVS(零電壓開(kāi)關(guān)),從而幾乎消除開(kāi)通損耗(如第 1 節(jié)所證,這是本設(shè)計(jì)的強(qiáng)制要求)。
雙向潮流: 拓?fù)浣Y(jié)構(gòu)天然對(duì)稱(chēng),只需調(diào)整原邊和副邊H橋之間的移相角,即可平滑控制功率在兩個(gè)方向上的流動(dòng) 。
控制簡(jiǎn)單: 其最基本的控制方式——單移相 (Single Phase Shift, SPS) 控制——非常成熟且易于實(shí)現(xiàn) 。
2.2 功率級(jí)構(gòu)建:從半橋模塊到全 DAB 架構(gòu)

設(shè)計(jì)挑戰(zhàn): BMF360R12KA3 是一個(gè)半橋模塊,包含一個(gè)高端 (High-Side) 和一個(gè)低端 (Low-Side) MOSFET 。
設(shè)計(jì)方案: DAB 拓?fù)湫枰獌蓚€(gè)完整的 H 橋(一個(gè)原邊,一個(gè)副邊)。一個(gè) H 橋由兩個(gè)“橋臂”(即兩個(gè)半橋)構(gòu)成 。
具體實(shí)施方案:
構(gòu)建一個(gè) H 橋: 需要使用 兩個(gè) BMF360R12KA3 半橋模塊。
構(gòu)建一個(gè)完整的 DAB 功率單元: 共需要 四個(gè) BMF360R12KA3 半橋模塊(兩個(gè)用于原邊 H 橋,兩個(gè)用于副邊 H 橋)。
詳細(xì)電路連接(以原邊 H 橋?yàn)槔?jiàn)圖 2.1):
模塊 1 (M1 - 橋臂 A):
DC+ (Pin 3) 連接到原邊直流母線正極 ($V_{DC,pri}$)。
DC- (Pin 2) 連接到原邊直流母線負(fù)極 (GND)。
AC (Pin 1) 作為 H 橋的交流輸出端 A ($AC_A$),連接到高頻變壓器。
控制端:G1 (Pin 4), S1 (Pin 5), G2 (Pin 6), S2 (Pin 7)。
模塊 2 (M2 - 橋臂 B):
DC+ (Pin 3) 連接到原邊直流母線正極 ($V_{DC,pri}$)。
DC- (Pin 2) 連接到原邊直流母線負(fù)極 (GND)。
AC (Pin 1) 作為 H 橋的交流輸出端 B ($AC_B$),連接到高頻變壓器。
控制端:G1 (Pin 4), S1 (Pin 5), G2 (Pin 6), S2 (Pin 7)。
副邊 H 橋(模塊 M3 和 M4)采用完全相同的連接方式,連接到 $V_{DC,sec}$ 和高頻變壓器的副邊。
V_DC,pri (+)
|
+---------+---------+
| | |
[Pin 3] [Pin 3] |
[ M1 ] [ M2 ] | (Primary H-Bridge)
(G1, S1) (G1, S1) |
[Pin 1]-----L_k-----+ | L_k = 變壓器漏感
(G2, S2) (G2, S2) | +----(Tx)----+
[Pin 2] [Pin 2] | | |
| | | ( ) ( )
+---------+---------+ ( ) ( )
| | +----(Tx)----+
GND (-) | |
| [Pin 1]-----L_k-----+ [ M4 ]
| (G2, S2) (G1, S1)
| [Pin 2] [Pin 3]
| | |
| +---------+---------+
| |
| V_DC,sec (+)
|
+------------[Pin 1] [ M3 ]
(G2, S2) (G1, S1)
[Pin 2] [Pin 3]
| |
+------------+
|
V_DC,sec (-)
2.3 四模塊拓?fù)涞纳顚釉O(shè)計(jì)影響
采用四個(gè)獨(dú)立的 62mm 模塊構(gòu)建 DAB 架構(gòu),帶來(lái)了超出電氣連接本身的深遠(yuǎn)影響,這些影響主導(dǎo)了后續(xù)的機(jī)械、散熱和寄生參數(shù)管理設(shè)計(jì)。
設(shè)計(jì)解讀 (七):機(jī)械與散熱挑戰(zhàn)
使用四個(gè) 62mm 模塊 3 意味著功率級(jí)具有相當(dāng)大的物理尺寸。這四個(gè)模塊必須安裝在一個(gè)共同的散熱基板上,以確保熱量被有效帶走。如第 6 節(jié)將詳細(xì)分析的,該系統(tǒng)產(chǎn)生的總損耗將高達(dá)數(shù)千瓦,必須使用一個(gè)大型的、高性能的液冷冷板 。這決定了整個(gè) SST 功率單元的機(jī)械結(jié)構(gòu)和冷卻系統(tǒng)(泵、散熱排等)的復(fù)雜性。
設(shè)計(jì)解讀 (八):寄生電感的困局
這種分布式布局(四個(gè)模塊物理上分離)是高頻 SiC 設(shè)計(jì)的噩夢(mèng),因?yàn)樗鼤?huì)引入巨大的寄生電感。
DC 鏈路電感 ($L_{sigma,DC}$): 電流必須從(物理上可能較遠(yuǎn)的)DC 鏈路電容庫(kù)流經(jīng)總線排 (Busbar),分別到達(dá) M1 和 M2 的 DC+ (Pin 3) 和 DC- (Pin 2) 端子。這個(gè)換流回路(例如 M1 高端關(guān)斷、M2 低端導(dǎo)通)的路徑很長(zhǎng),其寄生電感 $L_{sigma,DC}$ 會(huì)在 SiC 的高速 $di/dt$ 下產(chǎn)生巨大的電壓過(guò)沖 ($V_{os} = L_{sigma,DC} times di/dt$) 。
AC 鏈路電感 ($L_{sigma,AC}$): 交流電流必須從 M1 的 AC (Pin 1) 流出,通過(guò)走線或總線排到達(dá)變壓器,再?gòu)淖儔浩鞣祷氐?M2 的 AC (Pin 1)。這條 AC 回路的電感同樣不可忽視。
這種布局的直接后果是,如果不采用極端的低電感布局技術(shù),模塊在 100 kHz 下切換 360A 電流時(shí)產(chǎn)生的電壓尖峰將輕易超過(guò) 1200V 的 $V_{DSS}$ 限制,導(dǎo)致器件擊穿。因此,第 7 節(jié)將要討論的疊層母排 (Laminated Busbar) 設(shè)計(jì),不是一個(gè)可選項(xiàng),而是確保該拓?fù)涞靡詫?shí)現(xiàn)的關(guān)鍵前提 。
3. 關(guān)鍵的柵極驅(qū)動(dòng)子系統(tǒng)設(shè)計(jì)
SiC MOSFET 的性能和可靠性完全依賴(lài)于其柵極驅(qū)動(dòng)器的設(shè)計(jì)。BMF360R12KA3 的高速特性和低 $V_{GS(th)}$ 對(duì)驅(qū)動(dòng)電路提出了遠(yuǎn)超傳統(tǒng) Si-IGBT 的要求。本設(shè)計(jì)需要為 4 個(gè)模塊中的 8 個(gè)獨(dú)立 MOSFET 單元設(shè)計(jì) 8 套完全隔離的驅(qū)動(dòng)系統(tǒng)。
3.1 柵極驅(qū)動(dòng)需求定義
不對(duì)稱(chēng)驅(qū)動(dòng)電壓: 必須嚴(yán)格遵循數(shù)據(jù)手冊(cè)的推薦值:$V_{GS(on)} = +18text{ V}$ / $V_{GS(off)} = -4text{ V}$ 。
-4 V 負(fù)壓的重要性: SiC MOSFET 的 $V_{GS(th)}$ 僅為 2.7 V 3。在橋式電路中,當(dāng)一個(gè) MOSFET (如下管) 快速開(kāi)通時(shí),其橋臂中點(diǎn) (AC Pin 1) 的電壓會(huì)急劇下降 (例如 800 V / 40 ns,即 $dV/dt > 20text{ V/ns}$)。這個(gè) $dV/dt$ 會(huì)通過(guò)關(guān)斷狀態(tài)的上管的 Miller 電容 $C_{rss}$ 注入電流 ($I_M = C_{rss} times dV/dt$) 8。該電流流經(jīng)柵極關(guān)斷電阻 $R_{G,off}$,在柵極上產(chǎn)生一個(gè)正向電壓尖峰。如果 $V_{GS}$ 尖峰超過(guò) 2.7 V,上管將發(fā)生寄生導(dǎo)通,導(dǎo)致橋臂直通短路。采用 -4 V 負(fù)偏壓提供了 $2.7text{V} - (-4text{V}) = 6.7text{V}$ 的噪聲裕度,這是確保關(guān)斷穩(wěn)定性的第一道防線。
高驅(qū)動(dòng)峰值電流:
柵極總電荷 $Q_G = 880text{ nC}$ (在 800V/240A 下) 。
總柵極電壓擺幅 $Delta V_{GS} = 18text{V} - (-4text{V}) = 22text{V}$。
總柵極電阻 $R_{G,total} = R_{G,internal} + R_{G,external}$。內(nèi)部柵阻 $R_{G,int} = 2.93 Omega$ 。
數(shù)據(jù)手冊(cè)的開(kāi)關(guān)測(cè)試使用了 $R_{G(on)}=2.0 Omega$ 和 $R_{G(off)}=0.5 Omega$ 。
開(kāi)通峰值電流 $I_{peak(on)} approx Delta V_{GS} / (R_{G,int} + R_{G(on)}) = 22text{V} / (2.93Omega + 2.0Omega) approx 4.46text{ A}$。
關(guān)斷峰值電流 $I_{peak(off)} approx Delta V_{GS} / (R_{G,int} + R_{G(off)}) = 22text{V} / (2.93Omega + 0.5Omega) approx 6.4text{ A}$。
結(jié)論: 柵極驅(qū)動(dòng)器 IC 必須能夠提供至少 $pm$6.5 A 的峰值電流能力。
3.2 隔離柵極電源設(shè)計(jì)
這是驅(qū)動(dòng)系統(tǒng)中最關(guān)鍵的組件之一。每個(gè)驅(qū)動(dòng)器都需要一個(gè)浮地的、能提供 +18V 和 -4V 的電源。
設(shè)計(jì)挑戰(zhàn):極低的隔離電容 ($C_{iso}$)
如 3.1 所述,高端 MOSFET 的源極(驅(qū)動(dòng)器的參考地)連接到 AC 節(jié)點(diǎn),該節(jié)點(diǎn)以 > 20 V/ns 的 $dV/dt$ 劇烈擺動(dòng)。標(biāo)準(zhǔn)的隔離 DC/DC 電源模塊的隔離電容 ($C_{iso}$) 可能高達(dá) 50-100 pF。
這將導(dǎo)致災(zāi)難性的共模電流注入:
$I_{cm} = C_{iso} times dV/dt = 50text{ pF} times (800text{ V} / 40text{ ns}) = 50 times 10^{-12} times 20 times 10^9 = 1.0text{ A}$
高達(dá) 1 A 的共模電流尖峰會(huì)瞬間干擾甚至摧毀 PWM 控制器,或?qū)е买?qū)動(dòng)器邏輯錯(cuò)誤 。
解決方案:專(zhuān)用低電容柵極驅(qū)動(dòng)電源
必須選用專(zhuān)為 SiC/IGBT 柵極驅(qū)動(dòng)設(shè)計(jì)的 DC/DC 轉(zhuǎn)換器。Murata MGJ 系列 (如 MGJ1, MGJ2) 是此類(lèi)應(yīng)用的理想選擇 。
特性: 它們被明確設(shè)計(jì)為具有超低的隔離電容(典型值 < 15 pF),以實(shí)現(xiàn)極高的 dV/dt 免疫力 。
電壓: 提供非對(duì)稱(chēng)輸出,如 +18V/-4V 或可配置輸出 ,完美匹配 BMF360R12KA3 的需求。
功率需求計(jì)算:
每個(gè) MOSFET 的柵極驅(qū)動(dòng)功率為:
$P_G = Q_G times Delta V_{GS} times f_{sw} = 880text{ nC} times 22text{ V} times 100text{ kHz} = 1.936text{ W}$ 8
因此,必須為每個(gè) MOSFET 配備一個(gè)額定功率至少為 2 W(例如 Murata MGJ2 系列 24)或 3 W(例如 MGJ3 系列 24)的隔離電源。
3.3 柵極驅(qū)動(dòng)器 IC 選型與實(shí)施
基于 3.1 中 >6.5 A 的電流需求和 >20 V/ns 的 CMTI(共模瞬態(tài)抗擾度)需求,推薦選用 Texas Instruments UCC21750 。
選型理由:
高驅(qū)動(dòng)電流: $pm$10 A 的峰值拉灌電流能力 ,遠(yuǎn)超所需的 6.5 A,提供了充足的裕量,允許使用更小的 $R_G$ 以追求更快的開(kāi)關(guān)速度。
高 CMTI: 額定 150 V/ns 的 CMTI ,專(zhuān)為 SiC 橋式電路的嚴(yán)苛 $dV/dt$ 環(huán)境設(shè)計(jì)。
高集成度: 集成了 5.7 kVrms 隔離 無(wú)需外部光耦;更重要的是,它集成了主動(dòng) Miller 鉗位和 DESAT 保護(hù)功能 。
電壓兼容: 33 V 的最大輸出驅(qū)動(dòng)電壓 ,完美兼容 $18text{V} - (-4text{V}) = 22text{V}$ 的擺幅。
3.4 關(guān)鍵保護(hù)功能:主動(dòng) Miller 鉗位
-4 V 負(fù)壓是第一道防線,主動(dòng) Miller 鉗位 (Active Miller Clamp) 是第二道,也是更堅(jiān)固的防線 。
問(wèn)題: 在極高的 $dV/dt$ 下,即使有 -4 V 偏壓, $I_M times R_{G,off}$ 產(chǎn)生的電壓尖峰仍有超過(guò) 6.7 V 裕度的風(fēng)險(xiǎn)。
方案: 在 MOSFET 關(guān)斷后,當(dāng) $V_{GS}$ 下降到某一安全閾值(例如 2V)以下時(shí),驅(qū)動(dòng)器 IC 會(huì)激活一個(gè)獨(dú)立的、低阻抗的開(kāi)關(guān),將 MOSFET 的柵極(Gate)直接短路到源極(Source,即 -4V 電源軌)。
實(shí)施: UCC21750 的 CLAMP 引腳 26 提供了此功能。它在 $V_{GS}$ 低于 2V 后激活一個(gè) 4A 的內(nèi)部鉗位開(kāi)關(guān) 。這相當(dāng)于在 $dV/dt$ 瞬態(tài)期間,將 $R_{G,off}$ 旁路掉,提供了一個(gè)亞歐姆級(jí)的超低阻抗路徑,將 Miller 電流安全地泄放到 -4V 電源軌,從而徹底杜絕寄生導(dǎo)通 。
表 2:柵極驅(qū)動(dòng)子系統(tǒng)關(guān)鍵組件清單 (BOM) (每 MOSFET 單元)
| 組件 | 推薦型號(hào)/規(guī)格 | 關(guān)鍵參數(shù) | 數(shù)量 | 來(lái)源/備注 |
|---|---|---|---|---|
| 柵極驅(qū)動(dòng)器 IC | Texas Instruments UCC21750DW | $pm$10A, 150V/ns CMTI, 5.7kV 隔離 | 1 | |
| 隔離 DC/DC 電源 | Murata MGJ2D121804MPC | 12V 輸入, +18V/-4V @ 2W 輸出 | 1 | |
| 開(kāi)通柵極電阻 | (待 DPT 調(diào)諧) | 2.0 $Omega$ (起點(diǎn)) | 1 | |
| 關(guān)斷柵極電阻 | (待 DPT 調(diào)諧) | 0.5 $Omega$ (起點(diǎn)) | 1 | |
| 驅(qū)動(dòng)電源旁路電容 | 陶瓷電容 | 1 $mu$F, 100 nF (靠近 IC VDD/VEE) | 2-3 | |
| 直流母線電壓采樣 | (若使用) | 用于 UCC21750 的 VSS 采樣 | - |
4. SiC 模塊的魯棒保護(hù)電路設(shè)計(jì)
SiC MOSFET 的物理特性使其短路保護(hù)設(shè)計(jì)與傳統(tǒng) Si-IGBT 截然不同,且更具挑戰(zhàn)性 。
4.1 SiC 短路特性的挑戰(zhàn)
極短的短路耐受時(shí)間 (SCWT): Si-IGBT 的 SCWT 通常為 5-10 $mu$s。而 SiC MOSFET 由于芯片面積小、熱容低,其 SCWT 極短,通常要求保護(hù)電路在 < 2 $mu$s 內(nèi)響應(yīng) ,理想情況下應(yīng)在 1 $mu$s 內(nèi) 。
非飽和特性: IGBT 在短路時(shí)會(huì)進(jìn)入飽和區(qū),從而主動(dòng)限制短路電流。SiC MOSFET 則不同,它在短路時(shí)進(jìn)入線性區(qū)(或稱(chēng)歐姆區(qū)),其短路電流受 $V_{GS}$ 和極高的跨導(dǎo)控制,電流值非常大,不會(huì)自限制 。
高關(guān)斷過(guò)壓: 關(guān)斷一個(gè)巨大的短路電流(可能 > 1000 A 37)會(huì)在功率回路的寄生電感 $L_{sigma}$ 上產(chǎn)生致命的電壓尖峰 ($V_{os} = L_{sigma} times di/dt$) 。
因此,保護(hù)電路必須同時(shí)滿足:極快響應(yīng) (< 2 $mu$s) 和 智能關(guān)斷(軟關(guān)斷)。
4.2 退飽和 (DESAT) 保護(hù)電路設(shè)計(jì)
DESAT 保護(hù)是通過(guò)監(jiān)測(cè) MOSFET 導(dǎo)通時(shí)的 $V_{DS(on)}$ 來(lái)工作的。正常工作時(shí) $V_{DS(on)}$ 很低;發(fā)生短路時(shí),$V_{DS}$ 會(huì)迅速攀升。DESAT 電路檢測(cè)到 $V_{DS}$ 超過(guò)設(shè)定的閾值即觸發(fā)保護(hù) 。
使用 UCC21750 進(jìn)行 DESAT 設(shè)計(jì):
驅(qū)動(dòng)器 IC: UCC21750 具有一個(gè) DESAT 引腳,內(nèi)部集成了比較器和 200 ns 的快速響應(yīng)時(shí)間 。
DESAT 閾值 ($V_{DESAT}$): UCC21750 的 DESAT 閾值電壓典型值為 5 V 。
設(shè)計(jì)解讀 (九):DESAT 窗口的精密計(jì)算
我們必須確保正常運(yùn)行的 $V_{DS}$ 不會(huì)觸發(fā)保護(hù),而短路時(shí)的 $V_{DS}$ 一定能觸發(fā)保護(hù)。
電路結(jié)構(gòu): DESAT 引腳通過(guò)一個(gè)高壓阻斷二極管 ($D_{HV}$) 和一個(gè)(可選的)限流電阻連接到 MOSFET 的 Drain 端 (Pin 1/3)。
引腳電壓: DESAT 引腳上的電壓 $V_{PIN} = V_{DS(on)} + V_{F,DHV}$ (其中 $V_{F,DHV}$ 是高壓二極管的正向壓降)。
正常運(yùn)行 (最壞情況):
$V_{DS(on),max}$ (在 $T_{vj}=175^{circ}text{C}, I_D=360text{A}$) = $I_D times R_{DS(on)} = 360text{ A} times 6.4text{ m}Omega approx 2.3text{ V}$ (基于 3 數(shù)據(jù))。
假設(shè) $D_{HV}$ (例如 1200V SiC 肖特基二極管) 的 $V_F approx 1.5text{ V}$。
$V_{PIN, normal} = 2.3text{ V} + 1.5text{ V} = 3.8text{ V}$。
保護(hù)閾值:
UCC21750 的 $V_{DESAT}$ 閾值為 5 V 。
結(jié)論: 正常運(yùn)行的最高 $V_{PIN}$ (3.8 V) 遠(yuǎn)低于保護(hù)閾值 (5 V)。兩者之間有 $5text{V} - 3.8text{V} = 1.2text{V}$ 的安全裕度。這證明了該 DESAT 方案的可行性和魯棒性。任何導(dǎo)致 $V_{DS}$ 超過(guò) $5text{V} - 1.5text{V} = 3.5text{V}$ 的過(guò)流事件都將被檢測(cè)為短路。
3. 空白電容 ($C_{BLK}$) 計(jì)算:
目的: DESAT 保護(hù)必須在 MOSFET 剛開(kāi)通的瞬態(tài)(此時(shí) $V_{DS}$ 尚未降至 $V_{DS(on)}$)被“屏蔽”,以防止誤觸發(fā)。這個(gè)屏蔽時(shí)間即空白時(shí)間 $t_{BLK}$ 38。
原理: $t_{BLK}$ 是通過(guò) UCC21750 內(nèi)部的一個(gè)恒流源 ($I_{CHG}$,典型值 500 $mu$A) 對(duì)外部的 $C_{BLK}$ 充電至 $V_{DESAT}$ (5V) 所需的時(shí)間 34。$t_{BLK} = C_{BLK} times V_{DESAT} / I_{CHG}$。
時(shí)間選擇: $t_{BLK}$ 必須大于 $V_{DS}$ 的下降時(shí)間。從數(shù)據(jù)手冊(cè)看 3,開(kāi)通延遲 $t_{d(on)}$ 和上升時(shí)間 $t_r$ 總共約 100 ns。$V_{DS}$ 的下降時(shí)間在同一量級(jí)。選擇一個(gè) $t_{BLK}$ 在 300 ns 到 500 ns 之間是安全的。
電容計(jì)算 (以 $t_{BLK} = 400text{ ns}$ 為例):
$C_{BLK} = (t_{BLK} times I_{CHG}) / V_{DESAT} = (400 times 10^{-9}text{ s} times 500 times 10^{-6}text{ A}) / 5text{ V}$
$C_{BLK} = 40 times 10^{-12}text{ F} = 40text{ pF}$。
選型: 在實(shí)際電路中應(yīng)選用 39 pF 或 47 pF 的 NPO/C0G 電容,并預(yù)留焊盤(pán)以便在 DPT 階段(第 8 節(jié))進(jìn)行精細(xì)調(diào)諧。
4. 高壓二極管 ($D_{HV}$):
必須是 > 1200 V 的快速恢復(fù)二極管。
關(guān)鍵參數(shù): 必須具有低寄生電容,以防止 $dV/dt$ 瞬態(tài)時(shí)對(duì) $C_{BLK}$ 產(chǎn)生容性充電,導(dǎo)致誤觸發(fā) 。SiC 肖特基二極管是理想選擇。
4.3 故障時(shí)的軟關(guān)斷 (STO)
問(wèn)題: 如 4.1 所述,在 < 2 $mu$s 內(nèi)檢測(cè)到短路后,如果立即用 $pm$10 A 的驅(qū)動(dòng)器 27 進(jìn)行“硬關(guān)斷”,極高的 $di/dt$ 會(huì)在 $L_{sigma}$ 上產(chǎn)生毀滅性的過(guò)壓。
解決方案: 軟關(guān)斷 (Soft Turn-Off, STO)。當(dāng)檢測(cè)到 DESAT 故障時(shí),驅(qū)動(dòng)器 IC 不會(huì)立即用最大電流將柵極拉到 -4V,而是使用一個(gè)受控的小電流(例如幾百 mA)緩慢地拉低柵極電壓 38。這會(huì)拉長(zhǎng) $di/dt$ 的時(shí)間,從而將 $L times di/dt$ 過(guò)壓鉗位在安全范圍內(nèi)。
實(shí)施: UCC21750 內(nèi)部集成了 400 mA 的 STO 電流源 26。當(dāng) DESAT 故障被觸發(fā)時(shí),該功能自動(dòng)激活,以受控的方式關(guān)斷 SiC MOSFET,在保護(hù)器件免受短路熱失效的同時(shí),也保護(hù)它免受關(guān)斷過(guò)壓的二次損傷。
4.4 其他保護(hù)方案評(píng)估
分流電阻 (Shunt Resistor): 在功率回路中串聯(lián)一個(gè)低值采樣電阻 。
優(yōu)點(diǎn): 精度高,響應(yīng)快。
缺點(diǎn): 在 360 A 的額定電流下,即使是 1 m$Omega$ 的電阻,也會(huì)產(chǎn)生 $P_{loss} = I^2R = (360text{A})^2 times 0.001Omega = 129.6text{ W}$ 的巨大損耗,這在效率敏感的 SST 中是不可接受的。
SenseFET / 電流鏡:
優(yōu)點(diǎn): 快速、低損耗 。
缺點(diǎn): BMF360R12KA3 模塊沒(méi)有提供 SenseFET/Kelvin 電流采樣端子。此方案不適用。
結(jié)論: 針對(duì) BMF360R12KA3 標(biāo)準(zhǔn) 62mm 模塊,基于 UCC21750 實(shí)現(xiàn)的、經(jīng)過(guò)精密計(jì)算的 DESAT 保護(hù)輔以 STO 功能,是兼顧了響應(yīng)速度、可靠性和成本效益的最優(yōu)保護(hù)方案 。
5. 功率損耗分析與 ZVS 優(yōu)化
如第 1 節(jié)所證,DAB 拓?fù)鋵?shí)現(xiàn) ZVS 是本設(shè)計(jì)得以成立的前提。本節(jié)將對(duì) ZVS 運(yùn)行下的各項(xiàng)損耗進(jìn)行建模,并分析實(shí)現(xiàn) ZVS 的核心條件。
5.1 導(dǎo)通損耗 ($P_{cond}$) 建模
DAB 拓?fù)渲械碾娏鞑ㄐ谓咏菪位蛉切危?RMS 值 $I_{RMS}$ 取決于負(fù)載、電壓增益和移相角 $phi$。
1. MOSFET 溝道導(dǎo)通損耗:
$P_{cond,MOSFET} = I_{RMS,MOSFET}^2 times R_{DS(on)}(T_{j,op})$
關(guān)鍵參數(shù): 必須使用高溫下的 $R_{DS(on)}$。基于表 1,在 $T_{j,op} approx 150-175^{circ}text{C}$ 時(shí),應(yīng)使用 $R_{DS(on)} approx 6.4text{ m}Omega$ 3 進(jìn)行計(jì)算。這將是總損耗中的最大頭。
2. 死區(qū)時(shí)間損耗 (體二極管導(dǎo)通):
在死區(qū)時(shí)間 (Dead-time) 內(nèi),為實(shí)現(xiàn) ZVS,電流必須反向流過(guò) MOSFET,此時(shí)它會(huì)先流經(jīng)體二極管(或并聯(lián)的 SBD,但此模塊未明確包含 SBD)。
設(shè)計(jì)解讀 (十):體二極管的懲罰性損耗
查閱數(shù)據(jù)手冊(cè) 3,在 $T_{vj}=175^{circ}text{C}, I_{SD}=360text{A}$ 時(shí),體二極管的正向壓降 $V_{SD}$ (芯片值) 高達(dá) 4.47 V。
作為對(duì)比,在相同條件下 MOSFET 溝道的壓降為 $V_{DS(on)} = 360text{ A} times 6.4text{ m}Omega = 2.3text{ V}$。
結(jié)論: 體二極管的導(dǎo)通損耗($P = V_{SD} times I$)幾乎是 MOSFET 溝道損耗的兩倍。
設(shè)計(jì)對(duì)策:
a. 死區(qū)時(shí)間 ($t_{dead}$) 必須設(shè)置得盡可能短,僅需滿足 ZVS 過(guò)渡即可。
b. 必須實(shí)現(xiàn)同步整流 (Synchronous Rectification, SR) 43。即,在死區(qū)時(shí)間結(jié)束、ZVS 過(guò)渡完成后,必須立即打開(kāi) MOSFET 溝道(例如 $V_{GS} = +18text{V}$),將電流從高損耗的體二極管 (4.47V) 切換到低損耗的溝道 (2.3V)。這要求控制系統(tǒng)具有極高的時(shí)序精度。


5.2 開(kāi)關(guān)損耗 ($P_{sw}$) 建模
1. 開(kāi)通損耗 ($P_{sw,on}$):
在理想的 ZVS 運(yùn)行下,MOSFET 在 $V_{DS} approx 0text{V}$ 時(shí)導(dǎo)通。
因此,開(kāi)通損耗 $P_{sw,on} = E_{on} times f_{sw} approx 0$ 。
這為我們節(jié)省了在 100 kHz 下的 1340 W 損耗(見(jiàn) 1.3)。
2. 關(guān)斷損耗 ($P_{sw,off}$):
在標(biāo)準(zhǔn)的 SPS 控制 DAB 中,關(guān)斷通常是硬關(guān)斷(即在滿電流下關(guān)斷),ZVS 并不消除關(guān)斷損耗 。
$P_{sw,off} = E_{off}(I_D, T_j) times f_{sw}$
使用表 1 中的數(shù)據(jù) (175°C, 360A):
$P_{sw,off} approx E_{off,typ} times f_{sw} = 4.6text{ mJ} times 100text{ kHz} = 460text{ W}$。
這個(gè) 460 W 的損耗是不可避免的(除非采用更復(fù)雜的諧振或 ZCS 技術(shù)),它與導(dǎo)通損耗共同構(gòu)成了主要的功率損耗源。
注意:$E_{off}$ 與關(guān)斷電流 $I_D$ 近似成線性關(guān)系 3,因此在輕載時(shí) $P_{sw,off}$ 會(huì)相應(yīng)降低。同時(shí),它也受柵極電阻 $R_{G,off}$ 影響 。
5.3 ZVS (零電壓開(kāi)關(guān)) 的實(shí)現(xiàn)條件
ZVS 的實(shí)現(xiàn)是本設(shè)計(jì)的核心 。
原理: 在死區(qū)時(shí)間 $t_{dead}$ 內(nèi),DAB 的串聯(lián)電感(即高頻變壓器的漏感 $L_k$)中存儲(chǔ)的能量,必須足以對(duì)一個(gè)橋臂上的兩個(gè) MOSFET 的輸出電容 $C_{oss}$ 進(jìn)行充放電 46。例如,當(dāng) M1 (上管) 關(guān)斷,M2 (下管) 即將開(kāi)通時(shí),電感電流 $I_{sw}$ 必須將 M1 的 $C_{oss}$ 從 0V 充電到 $V_{bus}$,同時(shí)將 M2 的 $C_{oss}$ 從 $V_{bus}$ 放電到 0V。
ZVS 能量平衡條件:
電感中存儲(chǔ)的能量 $E_{Lk}$ 必須大于橋臂上總的電容儲(chǔ)能 $E_{Coss,total}$。
$E_{Lk} > E_{Coss,total}$
$frac{1}{2} L_k I_{sw}^2 > E_{oss,M1}(V_{bus}) + E_{oss,M2}(V_{bus})$
BMF360R12KA3 的 ZVS 計(jì)算 (假設(shè) $V_{bus} = 800text{V}$):
根據(jù)表 1,單顆 MOSFET 在 800V 時(shí)的 $E_{oss} = 343 mutext{J}$ 。
一個(gè)橋臂(兩顆 MOSFET)所需的總能量為:
$E_{Coss,total} = 2 times 343 mutext{J} = 686 mutext{J}$。
ZVS 條件: $frac{1}{2} L_k I_{sw}^2 > 686 mutext{J}$。
$I_{sw}$ 是在開(kāi)關(guān)瞬間(即 M1 關(guān)斷時(shí))的電感電流值。
設(shè)計(jì)解讀 (十一):DAB 的核心設(shè)計(jì)權(quán)衡
這個(gè)能量平衡方程是整個(gè) DAB 設(shè)計(jì)的核心,它緊密地聯(lián)系了三個(gè)完全不同的工程領(lǐng)域:
器件物理 ($E_{oss}$): 343 $mu$J,這是由 BMF360R12KA3 決定的固定值。
磁性元件設(shè)計(jì) ($L_k$): $L_k$ 是高頻變壓器的漏感。
控制系統(tǒng) ($I_{sw}$): $I_{sw}$ 由 SPS 控制的移相角 $phi$ 和負(fù)載決定 。
權(quán)衡點(diǎn) (輕載 ZVS):
在重載時(shí),$I_{sw}$ 很大,ZVS 很容易實(shí)現(xiàn)。
在輕載時(shí),有功電流很小,$I_{sw}$ 接近于零。為了在輕載下依然滿足 $E_{Lk} > 686 mutext{J}$,DAB 必須維持一定的“循環(huán)電流”(或稱(chēng)無(wú)功電流)。
為了在輕載下產(chǎn)生足夠的 $I_{sw}$,漏感 $L_k$ 不能太大。但如果 $L_k$ 太小,又會(huì)導(dǎo)致重載時(shí)電流紋波過(guò)大,增加導(dǎo)通損耗。
結(jié)論: 由于 BMF360R12KA3 的 $E_{oss}$ 相對(duì)較高 (343 $mu$J),為了保證在較寬負(fù)載范圍內(nèi)實(shí)現(xiàn) ZVS,系統(tǒng)將被迫在輕載下運(yùn)行較大的循環(huán)電流。這會(huì)導(dǎo)致輕載效率偏低。這是為了換取在重載下消除 1340 W 開(kāi)通損耗所必須付出的代價(jià)。
5.4 柵極驅(qū)動(dòng)損耗 ($P_G$)
如 3.2 中計(jì)算,每顆 MOSFET 的驅(qū)動(dòng)損耗為 1.936 W。
整個(gè) DAB 系統(tǒng)(8 顆 MOSFET)的總柵極驅(qū)動(dòng)損耗為:
$P_{G,total} = 8 times 1.936text{ W} approx 15.5text{ W}$
這部分損耗由控制側(cè)電源提供,必須計(jì)入總效率。
表 3:DAB 功率單元估算損耗預(yù)算 (每模塊,100 kHz ZVS 運(yùn)行)
(注意: 此表為示例,實(shí)際 $I_{RMS}$ 和 $I_{AVG,diode}$ 需基于詳細(xì)的 DAB 穩(wěn)態(tài)分析)
| 損耗源 (每模塊 = 2x MOSFET) | 符號(hào) | 計(jì)算公式 / 依據(jù) | 估算損耗 (W) | 備注 |
|---|---|---|---|---|
| MOSFET 1 (高端) | ||||
| 溝道導(dǎo)通損耗 | $P_{cond,M1}$ | $I_{RMS,M1}^2 times R_{DS(on)}(150^{circ}text{C})$ | (待 $I_{RMS}$ 計(jì)算) | 主要損耗源 |
| 關(guān)斷損耗 | $P_{sw,off,M1}$ | $E_{off}(I_{sw}, 150^{circ}text{C}) times f_{sw}$ | (待 $I_{sw}$ 計(jì)算) | 第二大損耗源 |
| 死區(qū)/二極管損耗 | $P_{dead,M1}$ | $I_{SD,M1} times V_{SD}(150^{circ}text{C}) times text{Duty}$ | (待 $I_{SD}$ 計(jì)算) | 高 $V_{SD}$ 懲罰 |
| 開(kāi)通損耗 | $P_{sw,on,M1}$ | (ZVS 實(shí)現(xiàn)) | $approx 0$ | 設(shè)計(jì)目標(biāo) |
| MOSFET 2 (低端) | ||||
| 溝道導(dǎo)通損耗 | $P_{cond,M2}$ | $I_{RMS,M2}^2 times R_{DS(on)}(150^{circ}text{C})$ | (待 $I_{RMS}$ 計(jì)算) | 主要損耗源 |
| 關(guān)斷損耗 | $P_{sw,off,M2}$ | $E_{off}(I_{sw}, 150^{circ}text{C}) times f_{sw}$ | (待 $I_{sw}$ 計(jì)算) | 第二大損耗源 |
| 死區(qū)/二極管損耗 | $P_{dead,M2}$ | $I_{SD,M2} times V_{SD}(150^{circ}text{C}) times text{Duty}$ | (待 $I_{SD}$ 計(jì)算) | 高 $V_{SD}$ 懲罰 |
| 開(kāi)通損耗 | $P_{sw,on,M2}$ | (ZVS 實(shí)現(xiàn)) | $approx 0$ | 設(shè)計(jì)目標(biāo) |
| 模塊總計(jì) | $P_{D,Total_pr_Modul}$ | $Sigma P_{M1} + Sigma P_{M2}$ | (例如: 700 W) | 用于熱設(shè)計(jì) |
6. 熱管理與散熱系統(tǒng)設(shè)計(jì)
基于第 5 節(jié)的損耗模型,SST 功率單元在 ZVS 運(yùn)行時(shí)仍會(huì)產(chǎn)生數(shù)千瓦的總熱量(主要是導(dǎo)通損耗 $P_{cond}$ 和關(guān)斷損耗 $P_{sw,off}$)。熱管理系統(tǒng)的目標(biāo)是確保在任何工況下,MOSFET 的結(jié)溫 $T_j$ 都低于安全裕量 。
6.1 熱模型(熱阻鏈)
熱量從 MOSFET 芯片(結(jié))流向環(huán)境空氣的路徑可以用一個(gè)熱阻串聯(lián)模型來(lái)描述 51:
$T_j = T_{amb} + P_{D,total} times (R_{th(j-c)} + R_{th(c-s)} + R_{th(s-a)})$
其中:
$T_j$: MOSFET 結(jié)溫 (Junction)。
$T_{amb}$: 環(huán)境溫度 (Ambient)。
$P_{D,total}$: 總耗散功率 (由 4 個(gè)模塊共同產(chǎn)生)。
$R_{th(j-c)}$: 結(jié)到殼 (Junction-to-Case) 熱阻。
$R_{th(c-s)}$: 殼到散熱器 (Case-to-Sink) 熱阻,即導(dǎo)熱界面材料 (TIM) 的熱阻。
$R_{th(s-a)}$: 散熱器到環(huán)境 (Sink-to-Ambient) 熱阻。
設(shè)計(jì)目標(biāo): 計(jì)算所需的 $R_{th(s-a)}$,以將 $T_j$ 維持在目標(biāo)溫度以下。
設(shè)計(jì)輸入?yún)?shù):
$T_{j,target}$: 150°C。(我們選擇 150°C 作為設(shè)計(jì)目標(biāo),在 175°C 的最大值 3 基礎(chǔ)上保留 25°C 的安全裕量,以應(yīng)對(duì)“初步”數(shù)據(jù)表 3 的不確定性)。
$T_{amb}$: 40°C。(典型的工業(yè)級(jí)環(huán)境溫度)。
$R_{th(j-c)}$: 0.11 K/W (每 MOSFET) 3。
$P_{D,MOSFET}$: 假設(shè)基于表 3 的詳細(xì)損耗模型,計(jì)算得出在最壞工況下,每顆 MOSFET 的平均損耗為 350 W (這是一個(gè)基于 360A 額定值的合理估算,實(shí)際值需在 DPT 后修正)。
6.2 導(dǎo)熱界面材料 (TIM) 熱阻 ($R_{th(c-s)}$)
$R_{th(c-s)}$ 是模塊銅基板 3 和散熱器之間的導(dǎo)熱界面材料(如導(dǎo)熱硅脂或相變材料)的熱阻 。
$R_{th(c-s)} = text{厚度} / (text{導(dǎo)熱系數(shù)} times text{面積})$ 。
BMF360R12KA3 的 62mm 封裝 3 具有約 $61.4text{ mm} times 106.4text{ mm}$ 的大基板面積(約 6533 $text{mm}^2$)。
設(shè)計(jì)解讀 (十二):大面積的優(yōu)勢(shì): 這個(gè)大接觸面積極大地降低了 $R_{th(c-s)}$。
估算: 假設(shè)使用高性能導(dǎo)熱硅脂 ($k = 5text{ W/mK}$, $t = 0.1text{ mm}$),$R_{th(c-s)}$ 將遠(yuǎn)低于 0.03 K/W。
設(shè)計(jì)取值: 我們保守地為每個(gè)模塊取 $R_{th(c-s)} = 0.02 text{ K/W}$ (注意:這是針對(duì)整個(gè)模塊,而非單顆 MOSFET)。
6.3 散熱器熱阻 ($R_{th(s-a)}$) 需求計(jì)算
計(jì)算分為兩步:
步驟 1:計(jì)算允許的最高散熱器溫度 ($T_s$)
我們必須確保最熱的 MOSFET 不超過(guò) $T_{j,target}$。
$P_{D,MOSFET} = 350text{ W}$ (假設(shè))。
$R_{th(j-c)} = 0.11 text{ K/W}$ 3。
模塊包含 2 顆 MOSFET,其熱阻是并聯(lián)到基板的。為簡(jiǎn)化并偏保守,我們使用單顆 MOSFET 的熱路徑。
最高殼溫 ($T_c$):
$T_c = T_{j,target} - P_{D,MOSFET} times R_{th(j-c)} = 150^{circ}text{C} - 350text{ W} times 0.11text{ K/W}$
$T_c = 150^{circ}text{C} - 38.5^{circ}text{C} = 111.5^{circ}text{C}$。
最高散熱器表面溫度 ($T_s$) (在模塊下方):
$T_s = T_c - P_{D,MOSFET} times R_{th(c-s), per_MOSFET}$
(假設(shè) $R_{th(c-s), per_Modul} = 0.02text{ K/W}$, 則 $R_{th(c-s), per_MOSFET} approx 0.04text{ K/W}$)
$T_s = 111.5^{circ}text{C} - 350text{ W} times 0.04text{ K/W} = 111.5^{circ}text{C} - 14^{circ}text{C} = 97.5^{circ}text{C}$。
(更簡(jiǎn)單的估算:$T_s = 111.5^{circ}text{C} - (2 times 350text{W}) times 0.02text{K/W} = 97.5^{circ}text{C}$)
我們?cè)O(shè)定散熱器(冷板)的最高表面溫度必須低于 97.5°C。
步驟 2:計(jì)算所需的散熱器熱阻 ($R_{th(s-a)}$)
DAB 單元的總熱耗散 $P_{D,total}$:
$P_{D,total} = 8text{ 個(gè) MOSFET} times 350text{ W/MOSFET} = 2800text{ W}$。
$R_{th(s-a)}$ 是散熱器將這 2800 W 熱量排到 40°C 環(huán)境空氣的能力。
$R_{th(s-a), required} = (T_s - T_{amb}) / P_{D,total}$
$R_{th(s-a), required} = (97.5^{circ}text{C} - 40^{circ}text{C}) / 2800text{ W}$
$R_{th(s-a), required} = 57.5text{ K} / 2800text{ W} = mathbf{0.0205 text{ K/W}}$。
6.4 冷卻技術(shù)結(jié)論
設(shè)計(jì)解讀 (十三):強(qiáng)制液冷
計(jì)算得出的所需熱阻 $R_{th(s-a)} = 0.0205text{ K/W}$ 是一個(gè)極低的值 。
一個(gè)高性能、帶強(qiáng)迫風(fēng)冷的大型散熱器,其熱阻通常在 0.1 K/W 到 0.5 K/W 的量級(jí)。
0.0205 K/W 的熱阻完全無(wú)法通過(guò)風(fēng)冷實(shí)現(xiàn)。
結(jié)論: 本設(shè)計(jì)必須采用液冷系統(tǒng)。四個(gè) BMF360R12KA3 模塊必須安裝在一個(gè)高性能的液冷冷板 (Cold Plate) 上 。整個(gè) SST 單元必須配備一個(gè)包含水泵、管路和外部散熱排(換熱器)的完整液冷循環(huán)系統(tǒng)。62mm 模塊的平整銅基板 3 正是為這種高強(qiáng)度的冷板安裝而設(shè)計(jì)的 5。
表 4:熱管理系統(tǒng)設(shè)計(jì)計(jì)算與規(guī)格
| 參數(shù) | 符號(hào) | 值 | 單位 | 備注 |
|---|---|---|---|---|
| 目標(biāo)結(jié)溫 | $T_{j,target}$ | 150 | °C | 留有 25K 裕量 |
| 環(huán)境溫度 | $T_{amb}$ | 40 | °C | 工業(yè)標(biāo)準(zhǔn) |
| 單 MOSFET 損耗 | $P_{D,MOSFET}$ | 350 | W | 假設(shè)的最壞情況估算 (來(lái)自表 3) |
| 結(jié)殼熱阻 | $R_{th(j-c)}$ | 0.11 | K/W | |
| 允許最高殼溫 | $T_{c,max}$ | 111.5 | °C | (計(jì)算值) |
| TIM 熱阻 (每模塊) | $R_{th(c-s)}$ | 0.02 | K/W | 估算值 (基于 62mm 封裝) |
| 允許最高冷板溫度 | $T_{s,max}$ | 97.5 | °C | (計(jì)算值) |
| DAB 單元總損耗 | $P_{D,total}$ | 2800 | W | (8x 350 W) |
| 所需散熱器熱阻 | $mathbf{R_{th(s-a), req}}$ | < 0.0205 | K/W | (計(jì)算值) |
| 結(jié)論 | - | 強(qiáng)制液冷 | - | 風(fēng)冷無(wú)法達(dá)到此熱阻 |
7. 物理布局與低電感集成
第 1 節(jié)證明了高 $f_{sw}$ 的必要性,第 2 節(jié)指出了 4 模塊布局的電感挑戰(zhàn)。SiC 的高速開(kāi)關(guān)特性 ($dV/dt > 20text{ V/ns}$, $di/dt > 1text{ kA/}mutext{s}$) 使得物理布局成為決定設(shè)計(jì)成敗的關(guān)鍵因素,其重要性不亞于電路拓?fù)浔旧?。設(shè)計(jì)的核心目標(biāo)是最小化功率回路和柵極回路的寄生電感 ($L_{sigma}$)。
BMF360R12KA3 模塊本身已優(yōu)化為“低雜散電感設(shè)計(jì)” ,行業(yè)內(nèi)類(lèi)似的 62mm 封裝內(nèi)部電感約為 10-15 nH 。設(shè)計(jì)的挑戰(zhàn)在于最小化模塊外部的電感。
7.1 功率回路:疊層母排 (Laminated Busbar) 設(shè)計(jì)
挑戰(zhàn): 在 $di/dt$ 極高的 DC 鏈路換流回路(即 DC 鏈路電容庫(kù) $rightarrow$ M1 上管 $rightarrow$ 變壓器 $rightarrow$ M2 下管 $rightarrow$ DC 鏈路電容庫(kù))中,任何寄生電感 $L_{sigma}$ 都會(huì)產(chǎn)生電壓過(guò)沖 $V_{os} = L_{sigma} times di/dt$ 16。如果 $L_{sigma} = 20text{ nH}$ (一個(gè)非常低的 PCB 布局值),$di/dt = 2text{ kA/}mutext{s}$,則 $V_{os} = 20text{ nH} times 2000text{ A/}mutext{s} = 40text{ V}$。在 800V 總線下,這很容易導(dǎo)致過(guò)壓。而第 2 節(jié)的 4 模塊布局,其 $L_{sigma}$ 遠(yuǎn)不止 20 nH。
解決方案: 必須使用疊層母排 (Laminated Busbar) 來(lái)構(gòu)建 DC 鏈路 。
設(shè)計(jì)原理:
使用兩片平行的、大面積的銅板(或多層 PCB 61)作為 DC+ 和 DC- 總線。
兩層銅板之間僅用一層薄的、高絕緣強(qiáng)度的電介質(zhì)(如 Kapton 或 Mylar)隔開(kāi) 。
DC 鏈路的薄膜電容器庫(kù)(必須是低 ESR/ESL 的薄膜電容,而非電解電容)直接安裝在母排上,以最小化電容到母排的電感。
四個(gè)功率模塊(M1-M4)直接安裝在母排上(或通過(guò)低電感連接器),使得從電容到模塊 DC+ (Pin 3) 和 DC- (Pin 2) 的距離最短。
物理原理: DC+ 和 DC- 層中的電流方向相反,它們產(chǎn)生的磁場(chǎng)相互抵消,從而將 DC 鏈路電感降至極低水平(< 10 nH),有效抑制 $V_{DS}$ 過(guò)沖 。
AC 側(cè)布局:
連接模塊 AC (Pin 1) 到高頻變壓器的 AC 側(cè)總線排也應(yīng)采用類(lèi)似的低電感設(shè)計(jì)(例如使用平行板或 PCB 走線)以優(yōu)化 ZVS 性能。
7.2 柵極回路:Kelvin 源極連接的必要性
挑戰(zhàn): 柵極回路電感 ($L_{G,loop}$) 決定了開(kāi)關(guān)速度。但更隱蔽的威脅來(lái)自功率回路和柵極回路之間的共源電感 ($L_s$)。
設(shè)計(jì)解讀 (十四):Kelvin 源極連接的強(qiáng)制性
問(wèn)題: 在 BMF360R12KA3 模塊內(nèi)部,從 SiC 芯片的源極到外部的 DC- (Pin 2) 和 S1/S2 (Pin 5/7) 端子存在一定的鍵合線電感,即 $L_s$。
主功率電流(360 A)流經(jīng) $L_s$ 并通過(guò) DC- (Pin 2) 返回。
如果柵極驅(qū)動(dòng)器 IC (UCC21750) 的“地”(VEE, -4V) 也連接到這個(gè) DC- (Pin 2) 端子,那么在功率電流 $I_D$ 快速變化時(shí),$L_s$ 上會(huì)產(chǎn)生一個(gè)電壓 $V_{Ls} = L_s times di/dt$ 。
這個(gè) $V_{Ls}$ 電壓會(huì)串聯(lián)在柵極驅(qū)動(dòng)回路中,有效地從施加的 $V_{GS}$ 中減去自身,即 $V_{GS,actual} = V_{GS,driver} - V_{Ls}$。這會(huì)減慢開(kāi)通速度、增加 $E_{on}$,并在關(guān)斷時(shí)產(chǎn)生負(fù)反饋振蕩。
解決方案: BMF360R12KA3 提供了專(zhuān)用的開(kāi)爾文源極 (Kelvin-Source) 端子:S1 (Pin 5) 和 S2 (Pin 7) 。
強(qiáng)制布局規(guī)則:
功率回路: 360 A 的主電流必須且只能通過(guò) DC- (Pin 2) 返回。
信號(hào)回路: 柵極驅(qū)動(dòng)器 IC (UCC21750) 的 VEE 引腳(即 -4V 驅(qū)動(dòng)電源的返回軌)必須且只能連接到 S1 (Pin 5) 或 S2 (Pin 7) 端子 。
效果: 這樣,柵極驅(qū)動(dòng)回路(UCC21750 OUT $rightarrow$ Pin 4/6 $rightarrow$ 芯片柵 $rightarrow$ 芯片源 $rightarrow$ Pin 5/7 $rightarrow$ UCC21750 VEE)與功率回路(Pin 1 $rightarrow$ 芯片漏 $rightarrow$ 芯片源 $rightarrow$ Pin 2)完全解耦。$L_s times di/dt$ 噪聲被隔離在功率回路中,柵極回路獲得了干凈、穩(wěn)定的驅(qū)動(dòng)參考地,從而實(shí)現(xiàn)最快、最可靠的開(kāi)關(guān)。
7.3 驅(qū)動(dòng)器 PCB 的物理實(shí)現(xiàn)
解決方案: 為每個(gè) BMF360R12KA3 模塊設(shè)計(jì)一個(gè)專(zhuān)用的“驅(qū)動(dòng)板” PCB 。
該 PCB 直接安裝(或通過(guò)短引腳)在 BMF360R12KA3 模塊的控制端子 (Pin 4-7) 之上。
UCC21750 IC、Murata MGJ 電源模塊、柵極電阻和旁路電容全部集成在這個(gè) PCB 上。
優(yōu)勢(shì):
實(shí)現(xiàn)了第 7.2 節(jié)的 Kelvin 源極連接。
將柵極驅(qū)動(dòng)回路的面積(即 $L_{G,loop}$)最小化到極限,確保驅(qū)動(dòng)信號(hào)的完整性。
將高壓模塊與低壓 PWM 控制器(通過(guò)光纖或數(shù)字隔離器連接到驅(qū)動(dòng)板)物理隔離。
深圳市傾佳電子有限公司(簡(jiǎn)稱(chēng)“傾佳電子”)是聚焦新能源與電力電子變革的核心推動(dòng)者:
傾佳電子成立于2018年,總部位于深圳福田區(qū),定位于功率半導(dǎo)體與新能源汽車(chē)連接器的專(zhuān)業(yè)分銷(xiāo)商,業(yè)務(wù)聚焦三大方向:
新能源:覆蓋光伏、儲(chǔ)能、充電基礎(chǔ)設(shè)施;
交通電動(dòng)化:服務(wù)新能源汽車(chē)三電系統(tǒng)(電控、電池、電機(jī))及高壓平臺(tái)升級(jí);
數(shù)字化轉(zhuǎn)型:支持AI算力電源、數(shù)據(jù)中心等新型電力電子應(yīng)用。
公司以“推動(dòng)國(guó)產(chǎn)SiC替代進(jìn)口、加速能源低碳轉(zhuǎn)型”為使命,響應(yīng)國(guó)家“雙碳”政策(碳達(dá)峰、碳中和),致力于降低電力電子系統(tǒng)能耗。
需求SiC碳化硅MOSFET單管及功率模塊,配套驅(qū)動(dòng)板及驅(qū)動(dòng)IC,請(qǐng)?zhí)砑觾A佳電子楊茜微芯(壹叁貳 陸陸陸陸 叁叁壹叁)
8. 總結(jié):設(shè)計(jì)建議與強(qiáng)制驗(yàn)證計(jì)劃


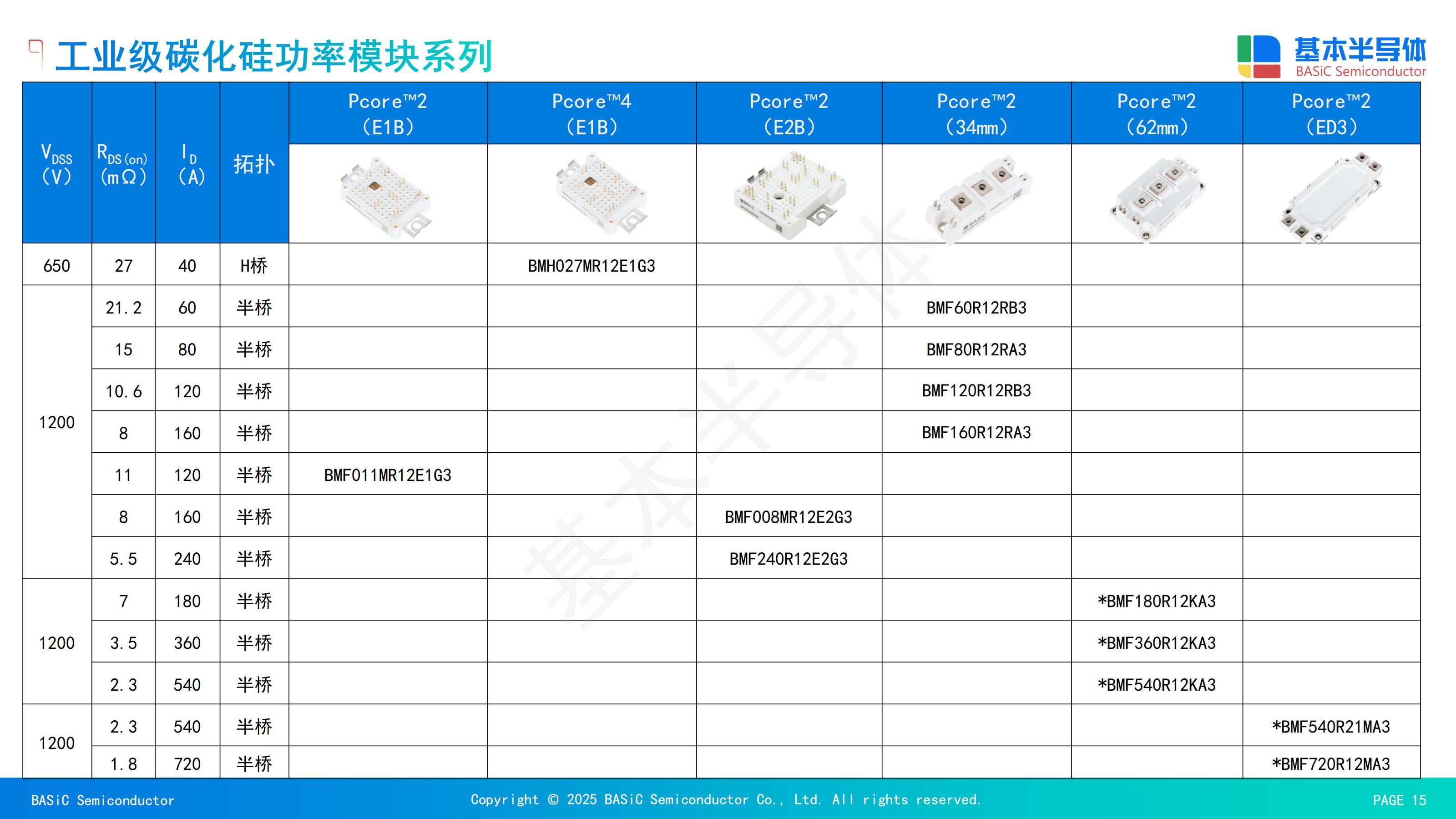


本報(bào)告基于 BMF360R12KA3 初步數(shù)據(jù)手冊(cè) 3 制定了一個(gè)高功率 SST 功率單元的完整設(shè)計(jì)方案。該設(shè)計(jì)在技術(shù)上具有高度挑戰(zhàn)性,其成功依賴(lài)于對(duì) SiC 特性的深刻理解和多項(xiàng)關(guān)鍵工程技術(shù)的協(xié)同實(shí)施。
8.1 核心設(shè)計(jì)決策匯總
拓?fù)? 4 模塊雙有源橋 (DAB)。采用四個(gè) BMF360R12KA3 半橋模塊(兩個(gè)用于原邊 H 橋,兩個(gè)用于副邊 H 橋)。
運(yùn)行模式: 強(qiáng)制 ZVS(零電壓開(kāi)關(guān))運(yùn)行。100 kHz 的硬開(kāi)關(guān) (1340 W $P_{sw}$) 在物理上不可行($P_D < 1143$ W)。
柵極驅(qū)動(dòng): 采用 $pm$10 A, 150 V/ns CMTI 的驅(qū)動(dòng)器(如 UCC21750)27,配合 +18V / -4V 3 的低電容隔離電源(如 Murata MGJ 2W/3W 系列)。
關(guān)鍵驅(qū)動(dòng)技術(shù): 必須同時(shí)實(shí)施 -4 V 負(fù)壓偏置和主動(dòng) Miller 鉗位(由 UCC21750 提供)26 以防止 $dV/dt$ 導(dǎo)致的寄生導(dǎo)通。
保護(hù): 采用基于驅(qū)動(dòng)器的 DESAT 保護(hù) 。經(jīng)計(jì)算,5 V 閾值 41 與 175°C 下 3.8 V 的 $V_{PIN,normal}$ 之間存在 1.2 V 的安全裕度。必須配合使用 STO(軟關(guān)斷)功能 以防止短路關(guān)斷時(shí)的過(guò)壓。
損耗: 主要損耗源為 ZVS 運(yùn)行下的高溫導(dǎo)通損耗(6.4 $text{m}Omega$ @ 175°C)3 和關(guān)斷損耗(4.6 mJ @ 175°C)。
熱管理: 總損耗高達(dá) 2800 W(估算值),所需散熱器熱阻 $R_{th(s-a)} < 0.0205text{ K/W}$。強(qiáng)制采用高性能液冷冷板 。
物理布局: DC 鏈路必須采用疊層母排 。柵極驅(qū)動(dòng)器必須采用直接安裝的 PCB,并且強(qiáng)制使用 Kelvin 源極 (Pin 5/7) 3 作為驅(qū)動(dòng)器參考地。
審核編輯 黃宇
-
SST
+關(guān)注
關(guān)注
0文章
142瀏覽量
36199 -
功率單元
+關(guān)注
關(guān)注
1文章
8瀏覽量
1477 -
固態(tài)變壓器
+關(guān)注
關(guān)注
2文章
134瀏覽量
3585
發(fā)布評(píng)論請(qǐng)先 登錄
250kW固態(tài)變壓器(SST)子單元設(shè)計(jì)方案-ED3封裝SiC模塊

SiC模塊構(gòu)建固態(tài)變壓器(SST)的 AC-DC 級(jí)方案及優(yōu)勢(shì)
62mm半橋SiC模塊設(shè)計(jì)固態(tài)變壓器 (SST) DAB的工程落地

固態(tài)變壓器(SST)關(guān)鍵技術(shù)架構(gòu)與國(guó)產(chǎn)化供應(yīng)鏈深度研究報(bào)告

BMF240R12E2G3作為SST固態(tài)變壓器LLC高頻DC/DC變換首選功率模塊的深度研究報(bào)告

傾佳電子固態(tài)變壓器(SST)技術(shù)路線演進(jìn)與未來(lái)十年應(yīng)用增長(zhǎng)深度分析

BMF240R12E2G3 碳化硅功率模塊在儲(chǔ)能PCS、固態(tài)變壓器SST及高頻UPS中的深度應(yīng)用與工程指南

傾佳電子SiC模塊BMF540R12KA3替代富士電機(jī) IGBT模塊 2MBI800XNE120 的綜合技術(shù)與應(yīng)用分析

傾佳電子基于BMF160R12RA3 的 50kW SiC 碳化硅固態(tài)變壓器(SST)級(jí)聯(lián)模塊(PEBB)設(shè)計(jì)報(bào)告
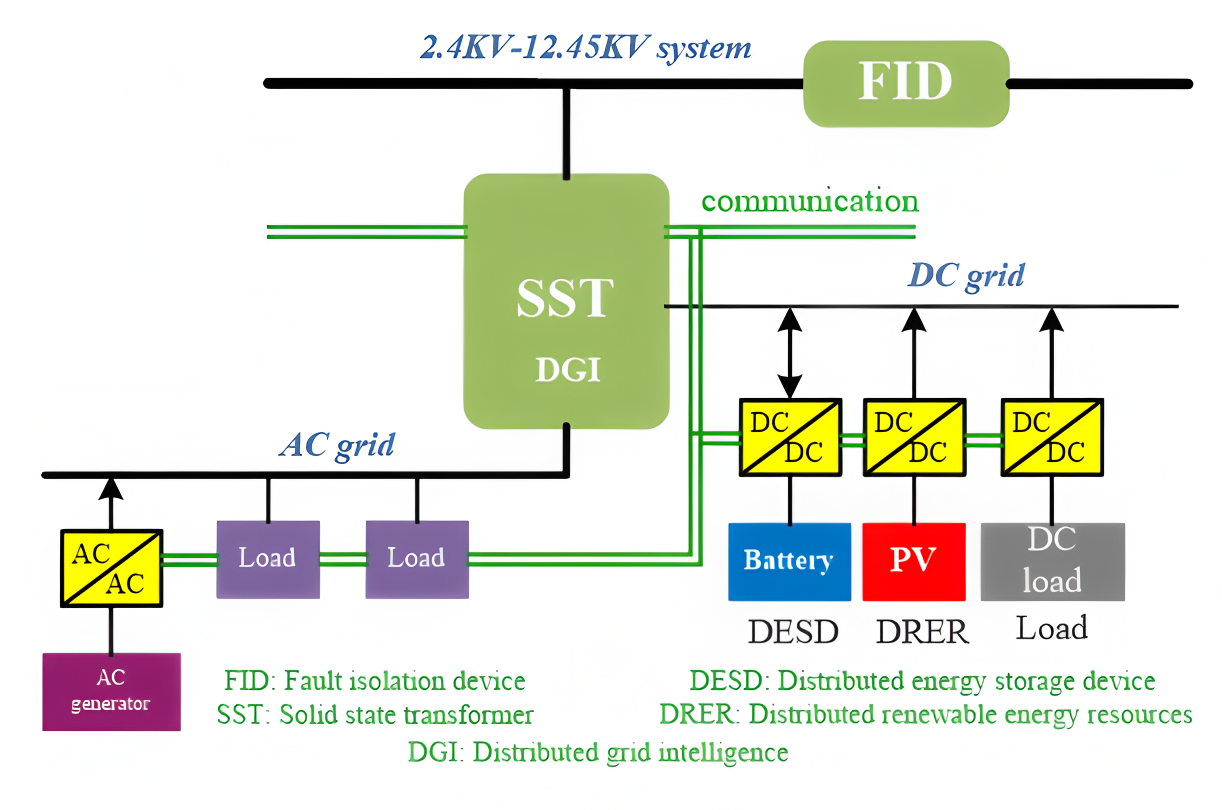
傾佳電子基于SiC模塊的120kW級(jí)聯(lián)SST固態(tài)變壓器功率模塊設(shè)計(jì)與拓?fù)?b class='flag-5'>分析

傾佳電子:BMF540R12KA3碳化硅SiC模塊全面取代英飛凌FF800R12KE7 IGBT模塊的深度分析報(bào)告

傾佳電子SST固態(tài)變壓器革命:一項(xiàng)市場(chǎng)、拓?fù)渑c碳化硅技術(shù)的綜合分析報(bào)告

傾佳電子固態(tài)變壓器SST在數(shù)據(jù)中心的應(yīng)用及SiC MOSFET功率模塊的關(guān)鍵作用
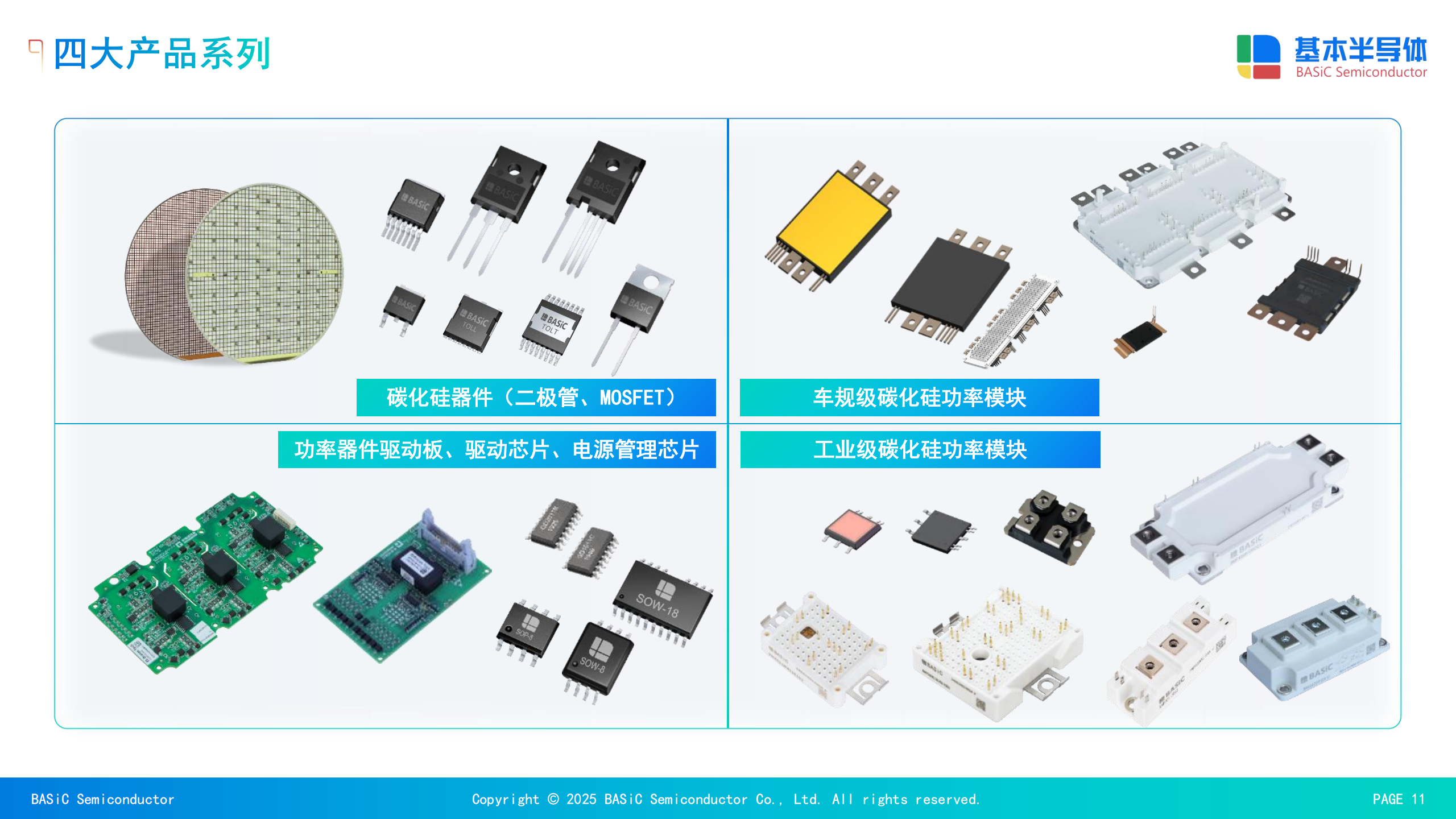
傾佳電子力薦:BASiC 62mm封裝BMF540R12KA3 SiC MOSFET模塊 —— 重新定義高功率密度與效率的邊




 傾佳電子基于 BMF360R12KA3 的固態(tài)變壓器 (SST) 功率單元設(shè)計(jì)方案與關(guān)鍵技術(shù)分析
傾佳電子基于 BMF360R12KA3 的固態(tài)變壓器 (SST) 功率單元設(shè)計(jì)方案與關(guān)鍵技術(shù)分析





評(píng)論