Altair解決方案概述
仿真、HPC和數據分析平臺
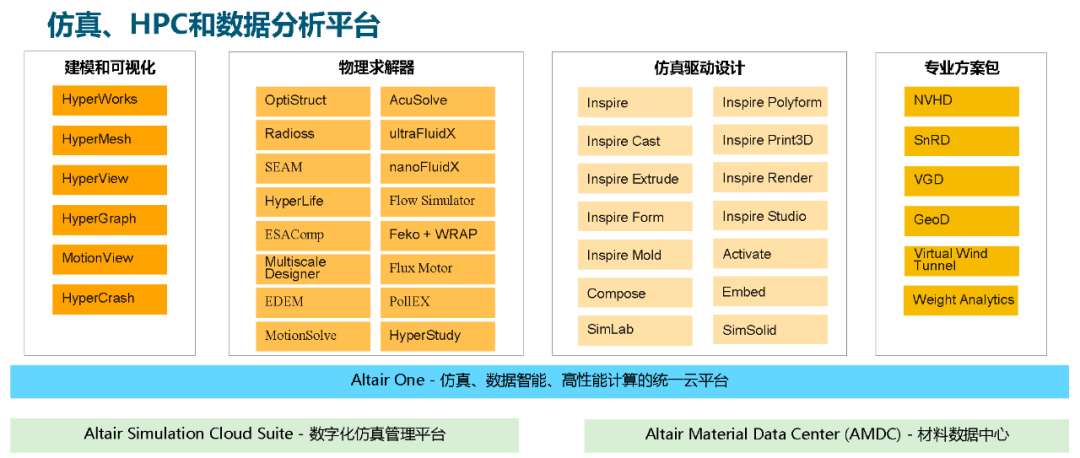
建模和可視化 | 物理求解器 | |
| HyperWorks | OptiStruct | AcuSolve |
| HyperMesh | Radioss | ultraFluidX |
| HyperView | SEAM | nanoFluidX |
| HyperGraph | HyperLife | Flow Simulator |
| MotionView | ESAComp | Feko + WRAP |
| HyperCrash | Multiscale Designer | Flux Motor |
| EDEM | PollEX | |
| MotionSolve | HyperStudy | |
仿真驅動設計 | 專業方案包 | |
| Inspire | Inspire Polyform | NVHD |
| Inspire Cast | Inspire Print3D | SnRD |
| Inspire Extrude | Inspire Render | VGD |
| Inspire Form | Inspire Studio | GeoD |
| Inspire Mold | Activate | Virtual Wind Tunnel |
| Compose | Embed | Weight Analytics |
| SimLab | SimSolid | |
HyperWorks結構前后處理解決方案
——結構前后處理一站式解決方案
通用前處理:HyperMesh
復雜幾何前處理:SimLab
網格批處理:BatchMesher
云圖后處理:HyperView
圖表后處理:HyperGraph

HyperWorks仿真平臺求解器
——最廣泛的優化求解器組合
系統仿真
制造仿真
電磁
結構分析
碰撞、安全、沖擊和爆炸
熱分析
流體力學
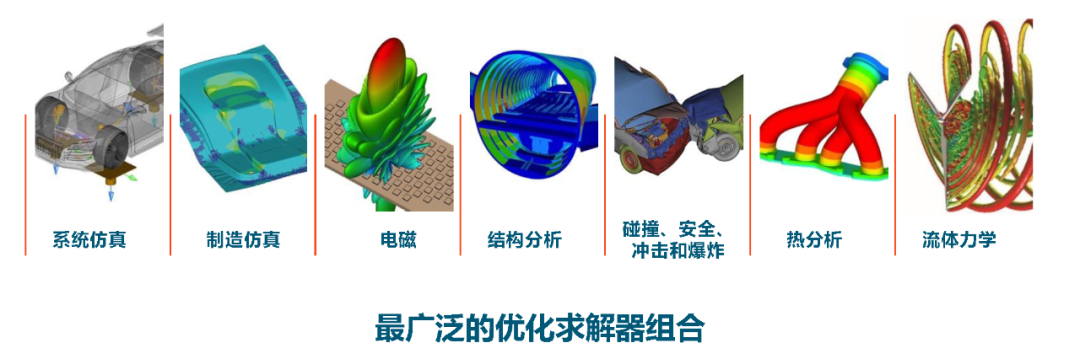
芯片及PCBA行業仿真場景
芯片封裝及PCBA前處理建模
靜強度分析
熱結構耦合分析
動力學分析
- 模態、頻響和振動
- 跌落沖擊
SimSolid無網格分析
電子產品散熱分析
Pollex
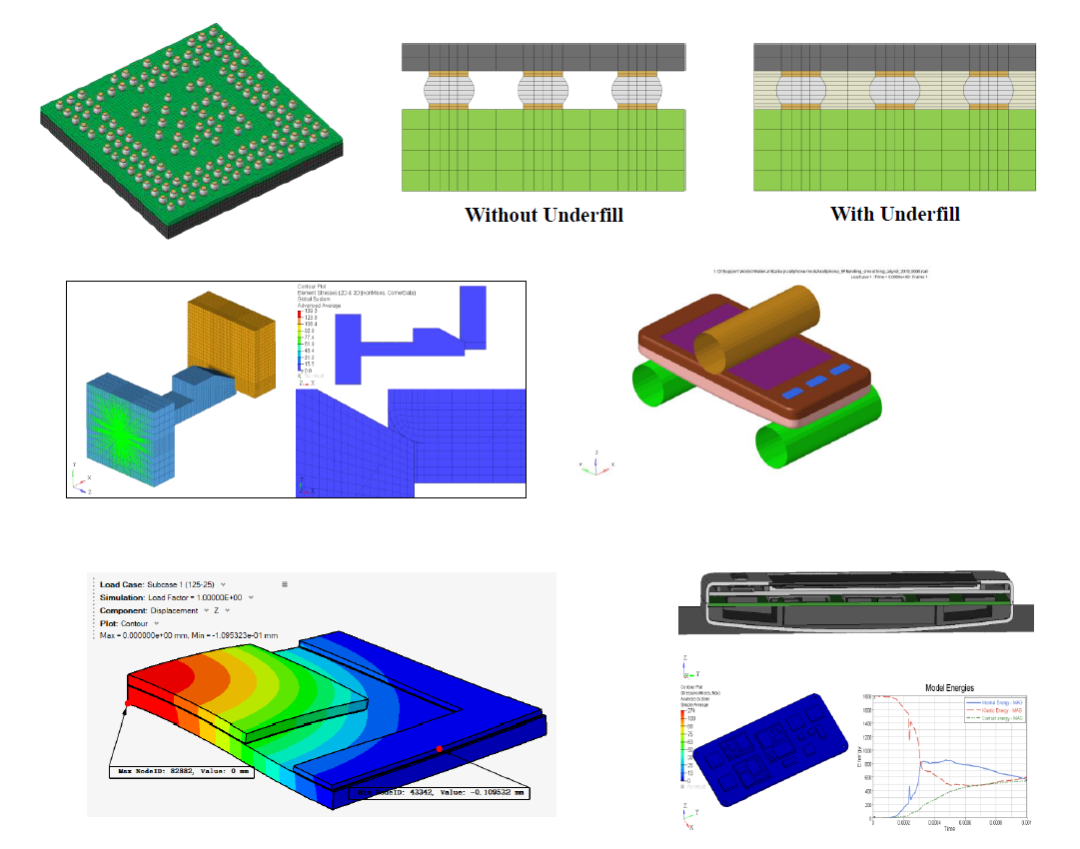
芯片封裝及PCBA前處理建模
HyperMesh 高質量,高效率,開放的有限元前處理平臺
30多年致力于CAE前處理,擅長復雜網格建模,擁有5000+商業用戶
在汽車、航空航天、重工、軌道交通、電子等行業事實上的標準有限元前處理平臺
與全球通用的CAD,CAE軟件無縫集成
開放架構,為客戶實現流程定制,極大地提高仿真工作的效率


過渡到全新用戶界面
所有的模型,腳本,流程仍然可用 – 同樣的 HM 文件,同樣的底層數據庫

用戶界面
——多窗口顯示與操作
支持多窗口顯示
- 每頁最多16個HyperMesh窗口
- 支持多窗口同步旋轉、移動
- 支持窗口間的復制與粘貼


高效實體網格劃分
四面體
六面體
Mesh Control 網格控制
邊界層網格
薄實體六面體網格自動劃分
實體網格質量自動優化

優化集成于HyperMesh
設計探索DesignExplorer
完全圖形交互式的DOE、優化作業創建流程
設計變量靈敏度直接顯示于模型
運行結果云圖可視化
基于機器學習的位移云圖自動預測

極速查找模型關鍵位置!
僅在HyperWorks新界面中支持熱點(Hotspot)搜索功能
搜索:應用過濾標準得到想要的熱點
查看:用細節可選的方式顯示熱點
保存:在一個頁面可以保存多個查詢到的熱點
比較:在多個模型上應用相同的檢索條件
存儲:共享熱點檢索結果和設置

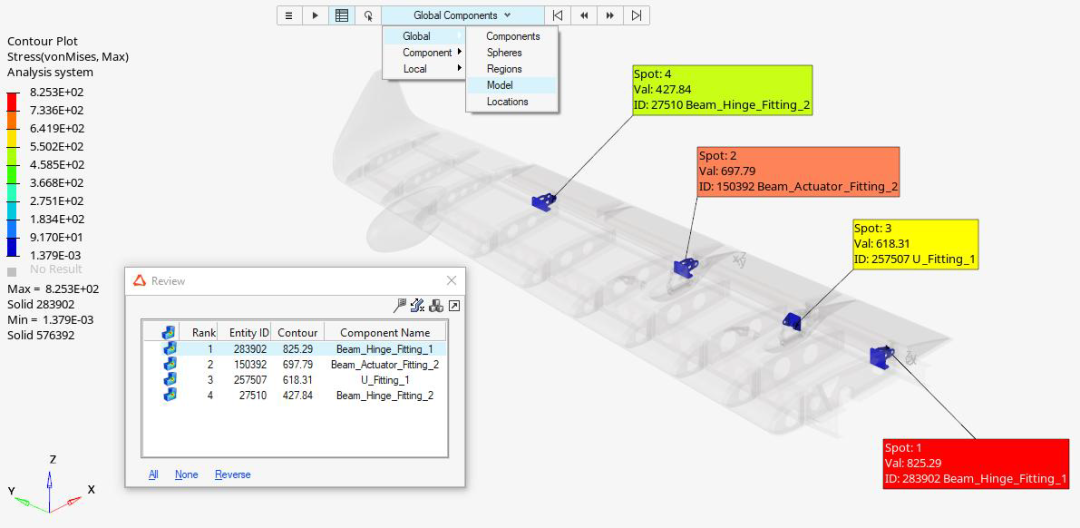
HyperWorks Report 報告自動生成

高度靈活、開放的二次開發平臺
依托HyperMesh,HyperView的前后處理功能,實現:
集成化與系統化
與 PDM系統集成的自動建模系統
CAE數據與報告管理系統
流程自動化
跌落模型創建與設置流程
從幾何導入到裝配完成的快速建模流程
結構分析,NVH,優化流程等
工具自動化
螺栓標準化建模工具
荷載工況創建工具
密封條創建工具
電子產品分析流程自動化
三星電子封裝流程自動化:
有限元建模 ( BGA/BOC/MCP/LeadFrame/POP)
載荷工況 (Warpage/SJR/Drop/Tip breaking)
作業提交 (將作業自動提交到計算集群上)
后處理 (自動化的分析報告生成)
數據的管理:
流程驅動的數據管理
能夠處理所有類型的仿真數據與實驗數據
使用流程自動化效果:
極大縮短項目時間并減少錯誤
標準化的CAE流程
實現重要數據的可重用性
提升整個CAE流程的可靠性
實現有效的合作機制

芯片封裝六面體網格劃分流程

芯片封裝Bump自動陣列
——封裝級別、bump 應力分析
將近17000個bump模型陣列
為減少總網格數,結合簡化模型與詳細模型
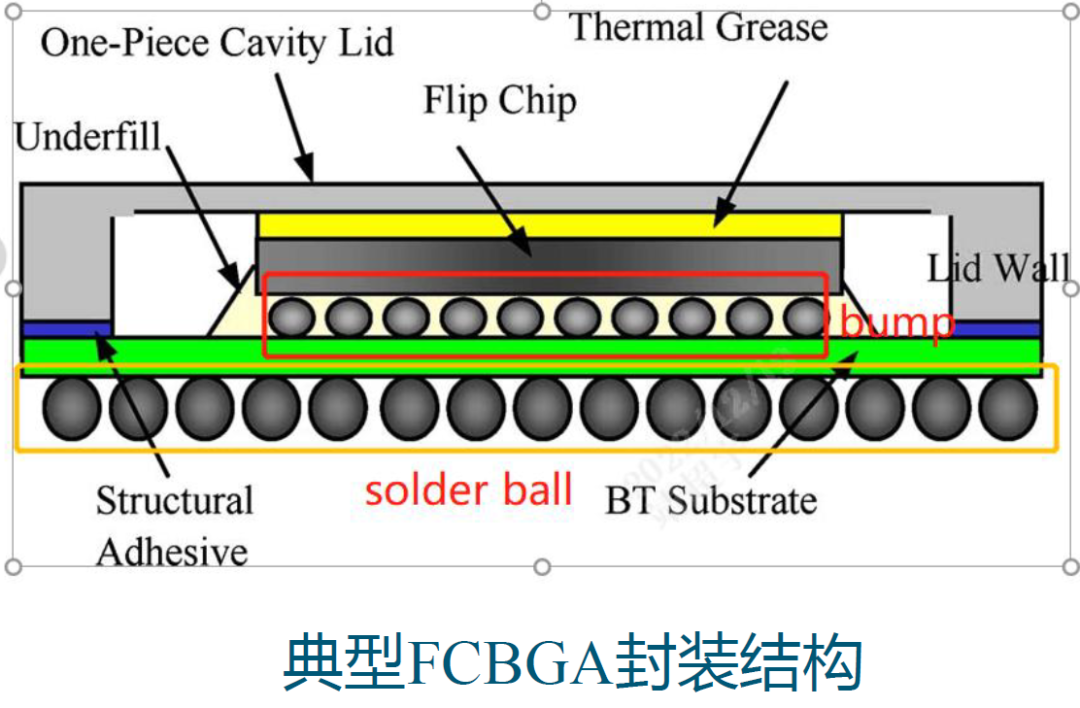

建模需考慮效率問題
允許用戶輸入位置信息,調用不同模型

芯片封裝Bump自動陣列
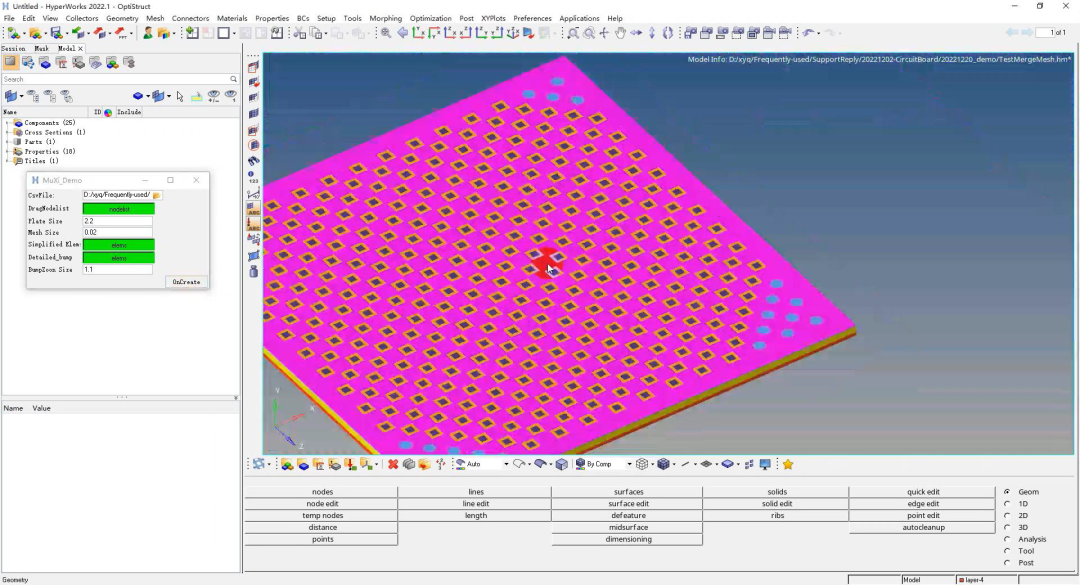
流程化的電子產品可靠性仿真平臺
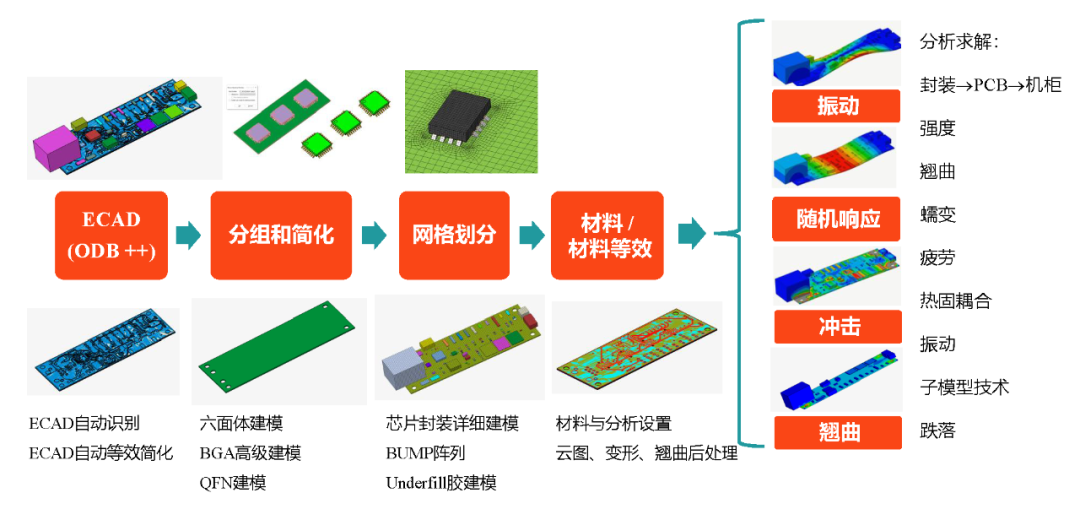
直接讀取ECAD源文件
直接讀取PCB的ECAD源文件,自動生成分層幾何
支持對PCBA幾何模型快速簡化
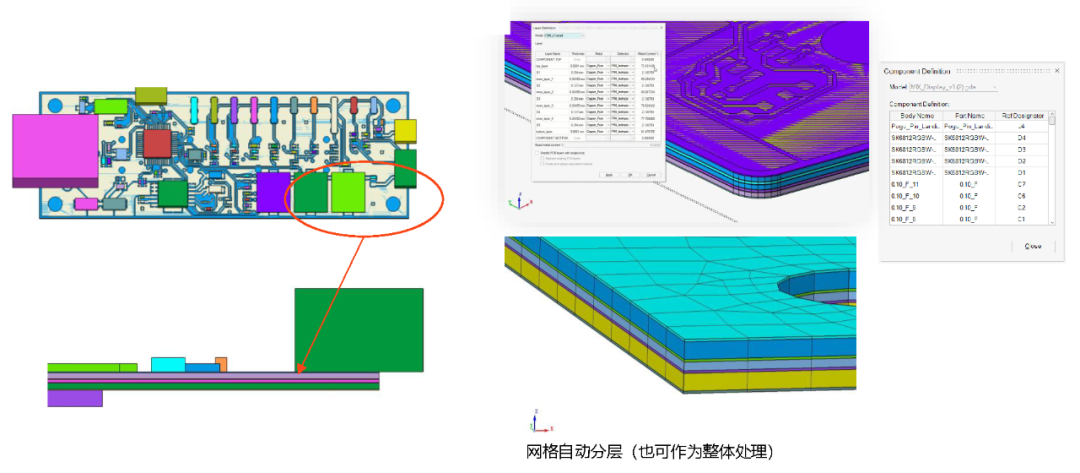
PCB板快速建模及材料等效
支持直接導入ECAD文件,并自動生成實體/殼/線幾何
可快速簡化PCB板并生成六面體網格,可自動貼合
根據銅線分布生成等效的隨溫度變化的正交各向異性材料參數,可捕捉Z向材料性能變化
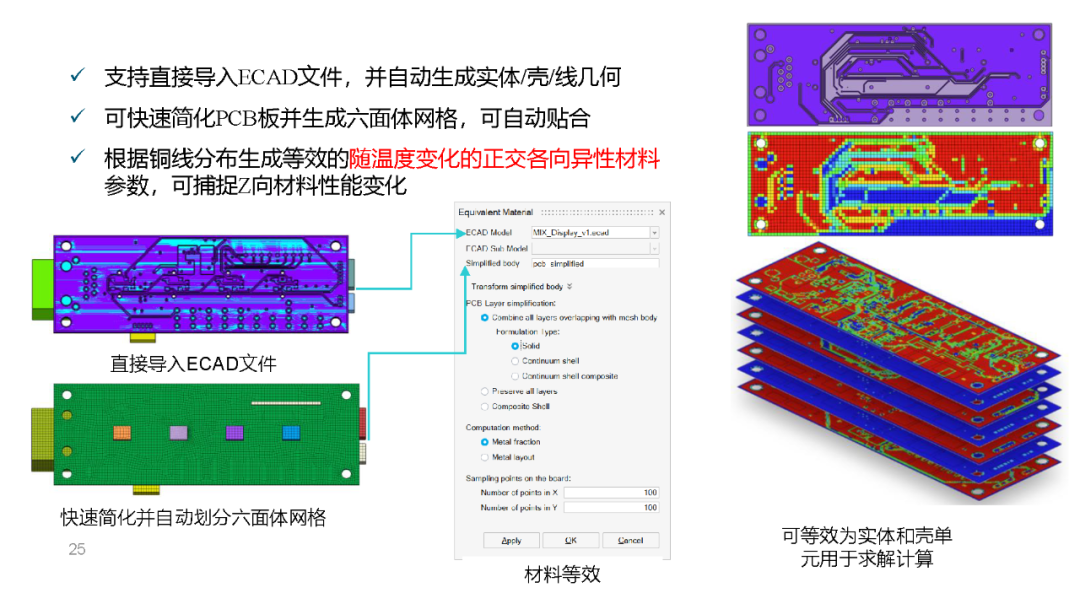
基于特征識別的高效網格劃分
選擇相同面
識別螺栓/回轉體/管路等
識別重復零件
選擇相同零件
根據尺寸識別零件

焊球快速建模與簡化
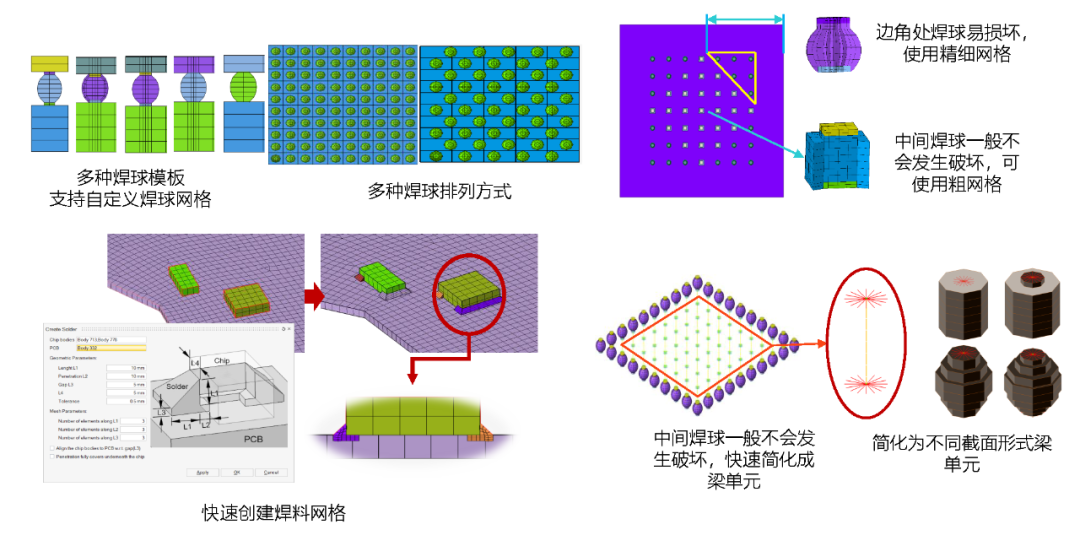
BGA網格簡化

包含Bumps的詳細BGA建模
先進的BGA封裝內部具有大量的bumps(凸點),并且需要劃分六面體網格,所以整體BGA網格劃分往往需要數天。采用SimLab+HyperMesh的方式,可以將整個網格劃分過程用時降至2個小時。

PCBA的網格劃分
為PCB板快速建立六面體網格。
支持將PCB從中間切分為兩半,然后通過Tie連接。這兩半網格將分別與PCB板上下方的零件共節點。
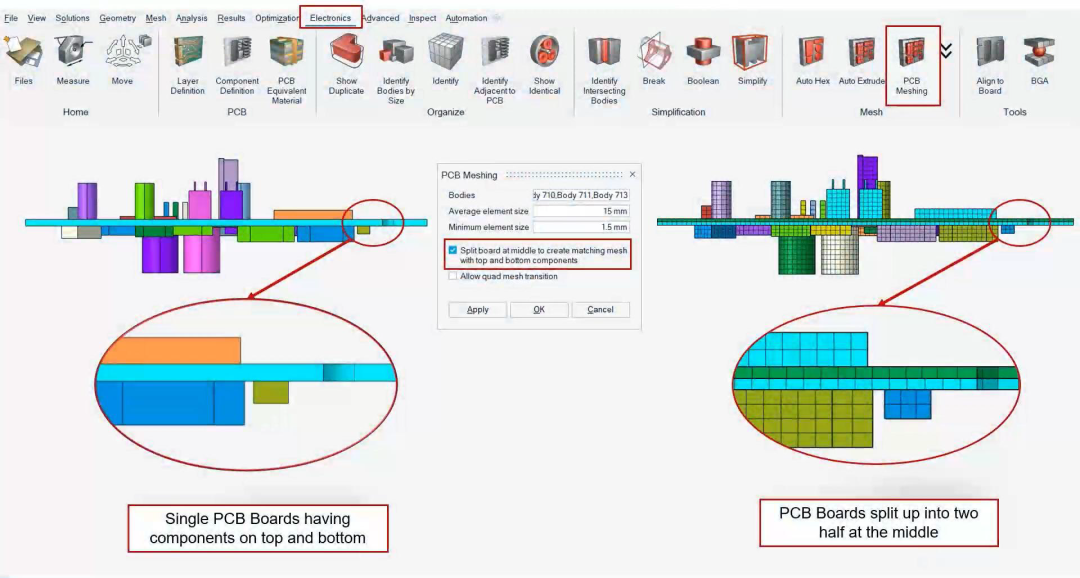
Chip Underfill Weld
——Underfill膠建模
添加一個工具用以在die和基板之間創建共節點的有角度underfill. 這個工具需要underfill的寬度和高度作為輸入。
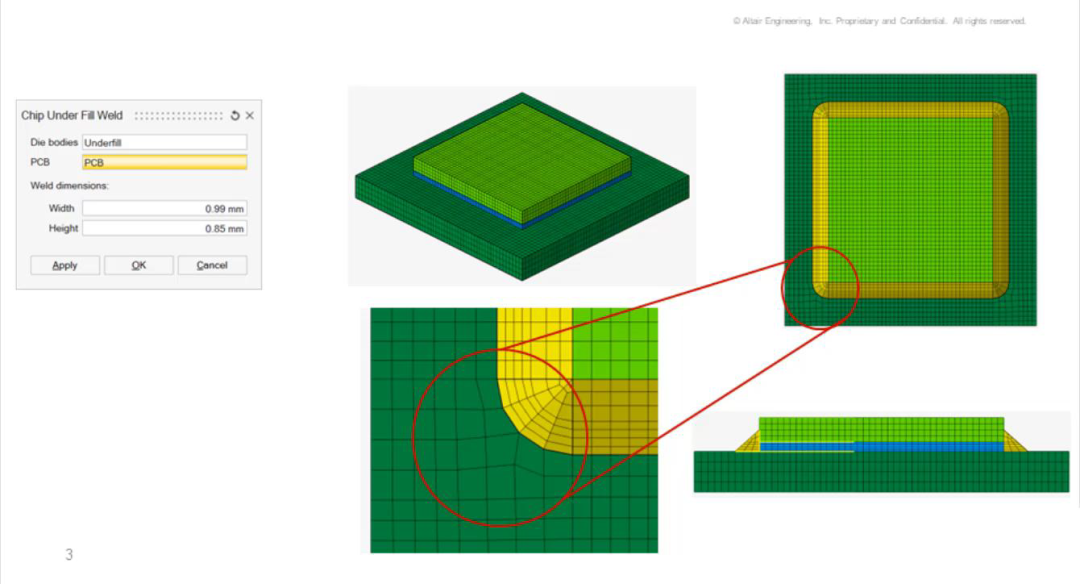
3D Chiplet參數化建模
——3D堆疊chiplet建模
3D-IC技術是指多芯片集成電路的一系列封裝技術,其中多個半導體芯片(稱為“chiplets”)彼此靠近放置(2.5D-IC)或堆疊在一起(3D-IC).
這些小芯片使用帶有通硅孔(tsv)的硅中間層互連,tsv穿透硅中間層并實現所有層之間的連接.
該技術允許在邏輯、存儲器、傳感器、微機電系統(MEMs)等領域的芯片進行異構集成,并以緊湊的外形因素實現更高的性能、更低的功耗和更小的尺寸規格.
這個工具有助于根據給定的參數創建芯片堆疊模型進行布局分析
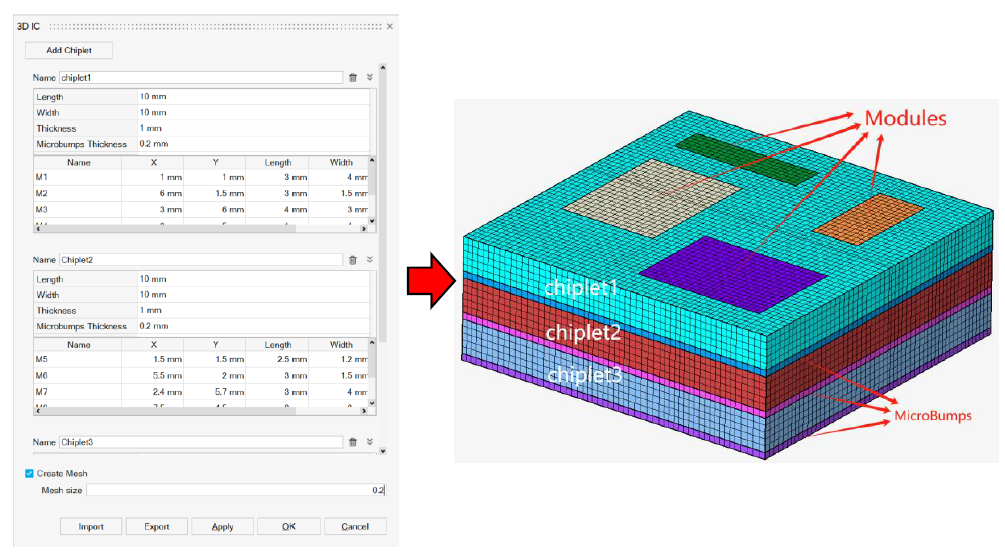
靜強度分析
OptiStruct的結構分析能力
線性/非線性靜力學
瞬態分析
模態分析
頻響分析(模態法,直接法)
隨機振動
穩態/瞬態傳熱分析
翹曲分析(支持熱固強耦合)
焊球疲勞(蠕變材料)
跌落仿真
電-熱-固耦合分析

靜強度:靜力學
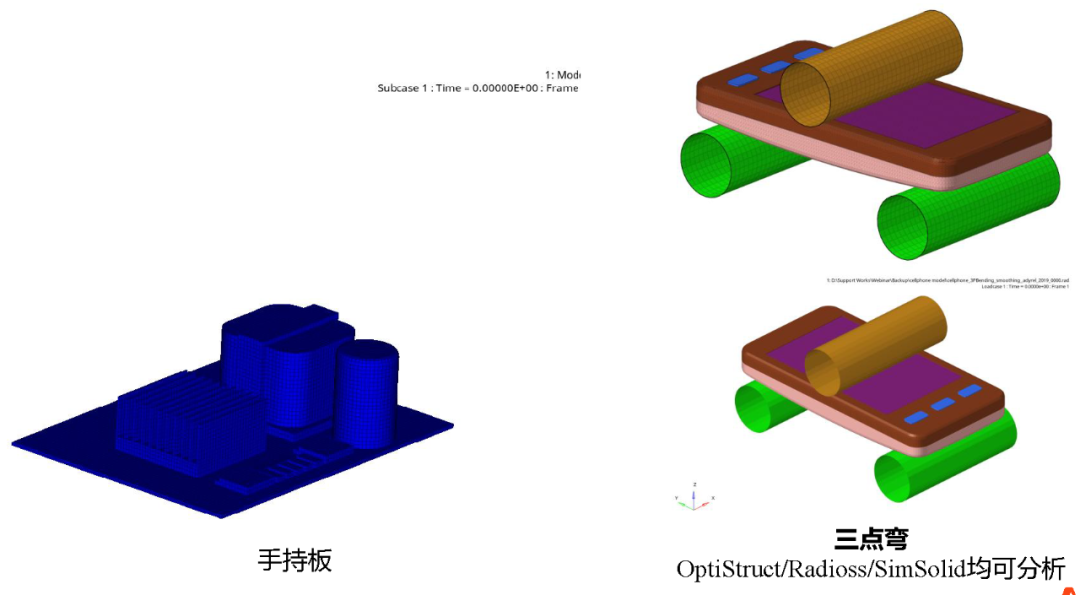
結構剛強度分析
卡扣插拔
散熱器安裝
雷達風載變形
非線性彈性橡膠密封仿真
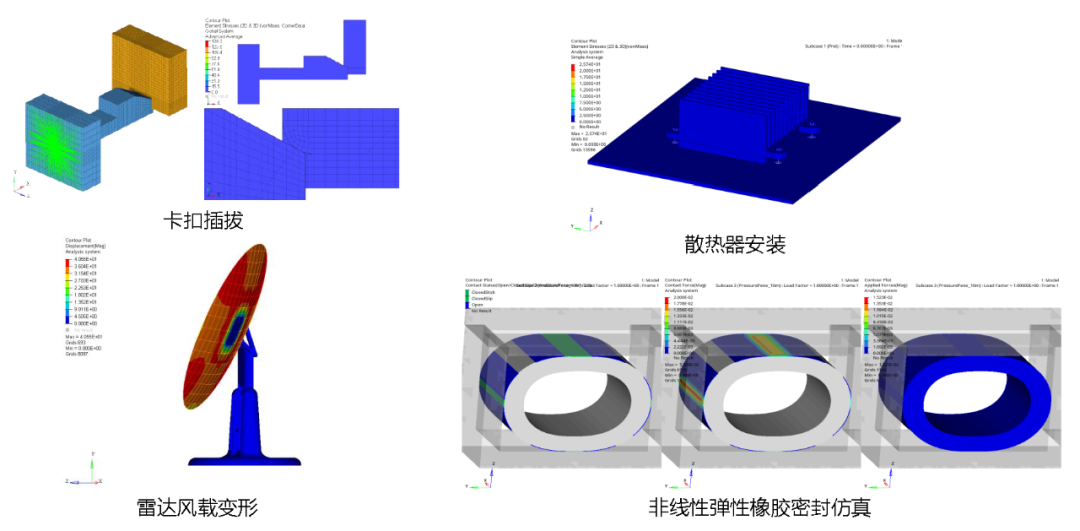
靜強度-粘膠開裂/脫離
膠粘及材料
無損傷類型 MCOHE
有損傷類型MCOHED

支持具有膠粘特性的接觸對

電子基本的加強筋優化設計
基于OptiStruct 拓撲優化對電子器件的基板加強筋分布進行設計。在不增加材料質量的前提下,以提高基板剛度,降低基板變形為目標,來對基板的加強筋的分布進行拓撲優化。
參照基板上電子元器件的布置情況和拓撲優化的結果,重新排布加強筋在基板上的位置,得到優化后基板的改進設計。對比基板原始設計和改進設計在相同工況下的有限元模型的剛度計算結果,證明應用拓撲優化的方法來改進此基板加強筋的分布是合理和可行的。
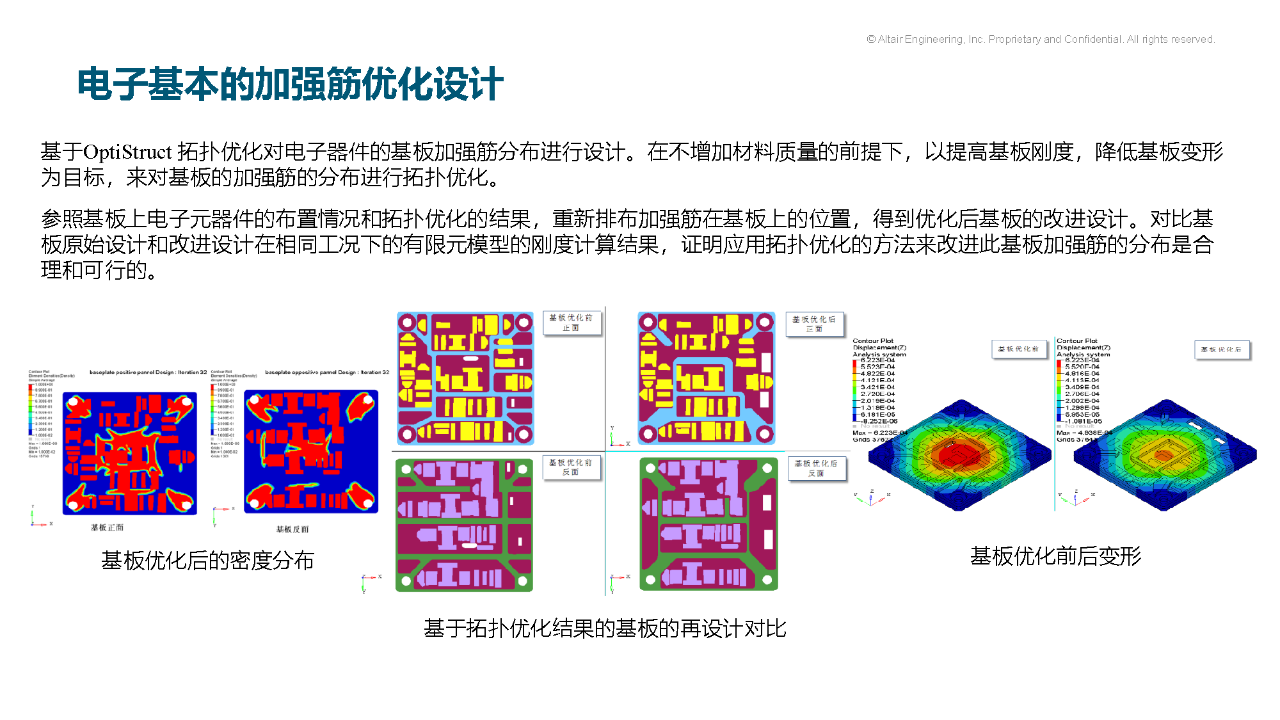
熱結構耦合分析
PCB回流翹曲
SimLab直接導入ECAD源文件,自動生成包含銅層線路的詳細PCB幾何。在SimLab中自動創建PCB的詳細網格,自動賦予FR-4和銅箔材料屬性。加載溫度載荷后計算PCB翹曲,創建對角線節點路徑并提取翹曲度。
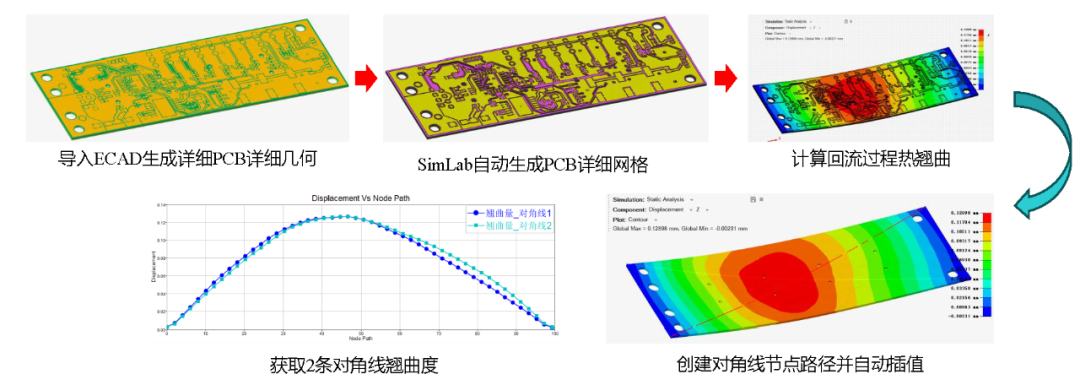
封裝結構熱可靠性:芯片封裝翹曲
OS進行熱-結構耦合應力分析
芯片封裝各部分的CTE差異導致的翹曲
溫度場數據可來自熱分析計算結果直接映射
溫度場點陣數據可作為結構應力分析的輸入
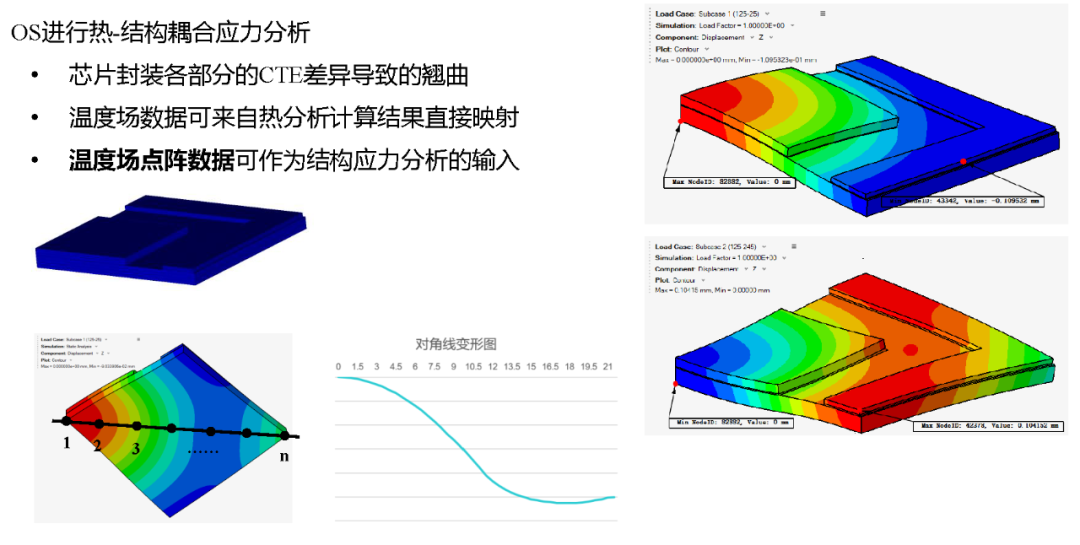
封裝結構熱可靠性:焊球疲勞
焊球疲勞求解方案,自動創建蠕變工況及疲勞工況參數
支持多種蠕變材料本構: Anand,Darveaux,Hyperbolic Sine Hardening等
支持如下三種焊球專用疲勞算法:Syed-Creep energy density,Syed-Creep strain,Darv-Creep energy density
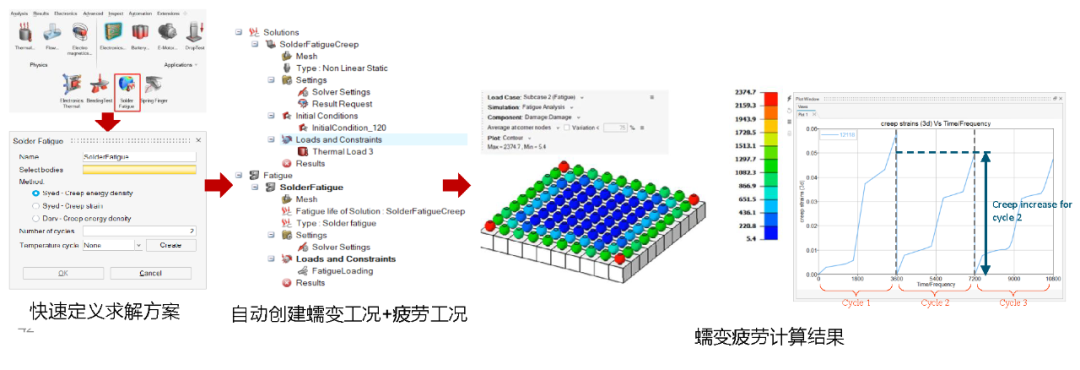
芯片封裝結構熱可靠性:子模型技術
兩步完成子模型定義,快速計算子模型上詳細變形、應力、應變以及疲勞壽命
定義子模型材料參數
定義全局模型與子模型交界面,自動將全局模型位移映射到與子模型的交界面

SimLab電-熱-結構耦合分析
在SimLab中可以方便地創建電-熱-結構耦合分析,計算電流產熱造成的結構變形和應力。
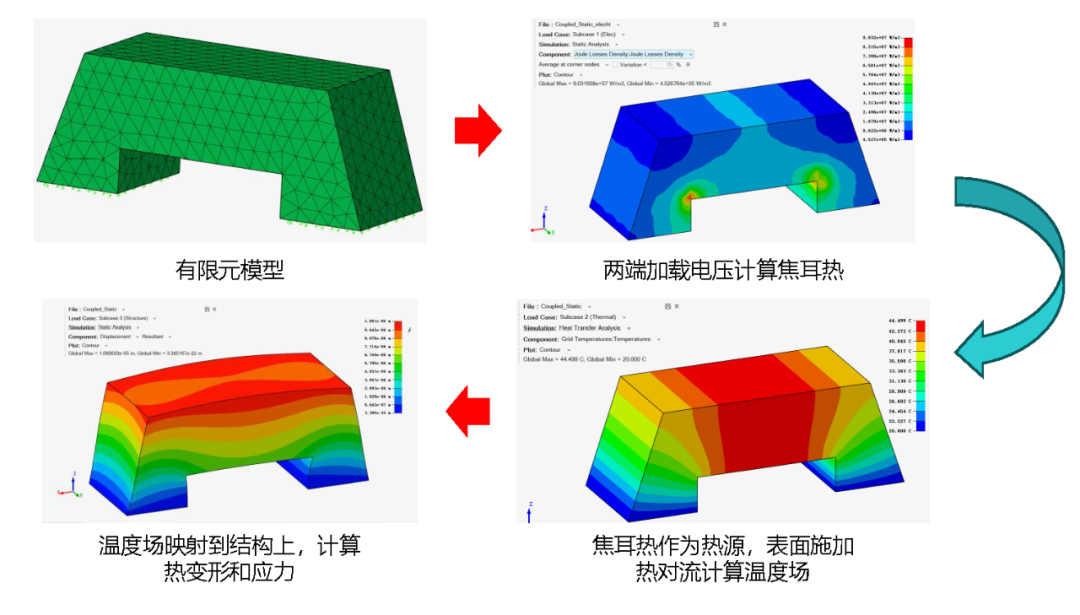
動力學分析
結構沖擊響應:電子設備沖擊
電子設備在運輸、攜帶、使用過程中可能承受各種負載和沖擊。因此,在產品設計過程中,需要考慮易碎組件,如主板等如何布置以更好的保護其在因各種沖擊下不產生損壞。
通常,對于其抗沖擊性能,往往需要在實驗臺開展周期較長、成本昂貴的三角、階躍或半正弦等脈沖沖擊下的機械抗沖擊測試。
通過仿真分析易損電子元件的沖擊響應,可以大大的縮短研發周期,節約研發成本


結構沖擊響應:基于響應譜的抗沖擊仿真

結構沖擊響應:基于瞬態分析的抗沖擊仿真

結構動力學可靠性:模態分析
OptiStruct支持Lanczos方法、AMSES模態加速法,可以快速有效的分析結構模態,避免結構共振。
OptiStruct還提供預應力條件下的模態分析,只需順序依次設置,即可完成求解。
- 考慮電子產品在工作溫度下由熱引起的熱應力預載荷
- 考慮電子產品在離心力等預載荷作用下的模態
- 螺栓預緊、過盈配合等裝配過程中產生的預應力模態


結構動力學可靠性:頻響
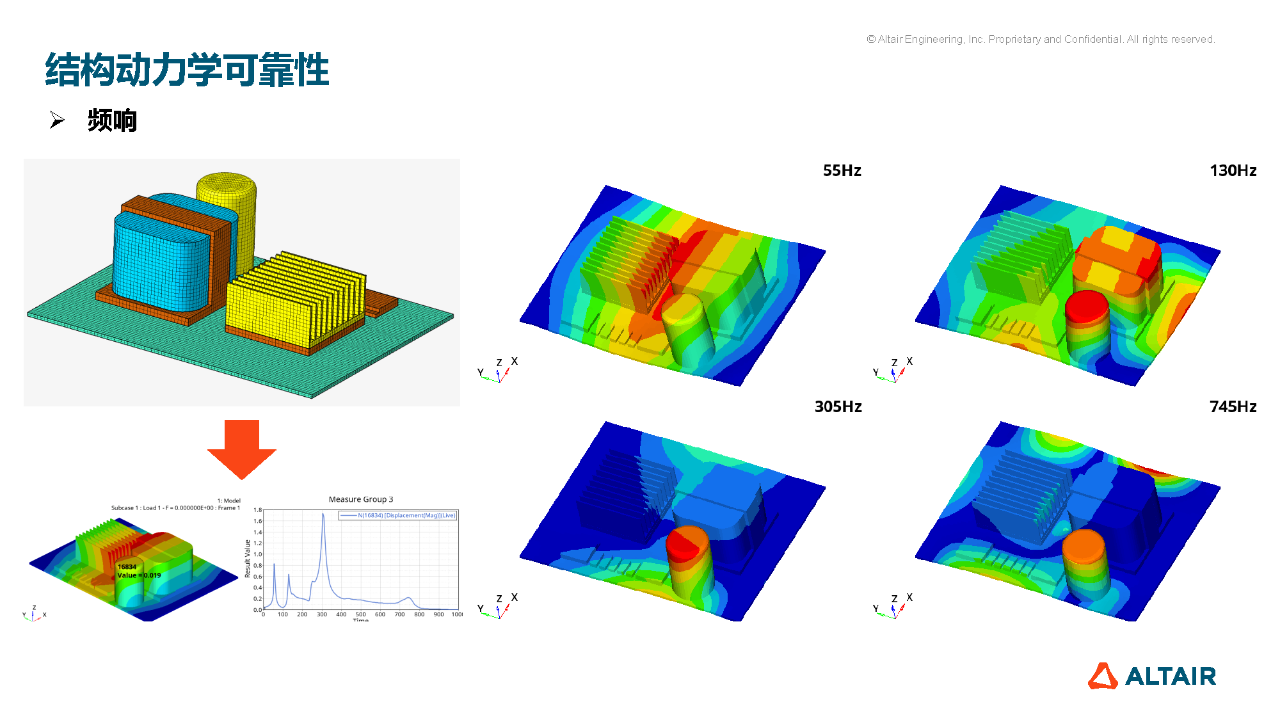
結構動力學可靠性:隨機振動

疲勞分析:疲勞
OptiStruct的疲勞分析用戶只需直接在一個模型中定義靜力分析和疲勞分析工況,支持S/N高周應力疲勞和E/N低周應變疲勞分析功能,
單軸疲勞支持高周和低周疲勞
多軸疲勞支持低周疲勞
基于Dang Van方法的無線壽命疲勞
焊縫、焊點疲勞
基于隨機響應下疲勞
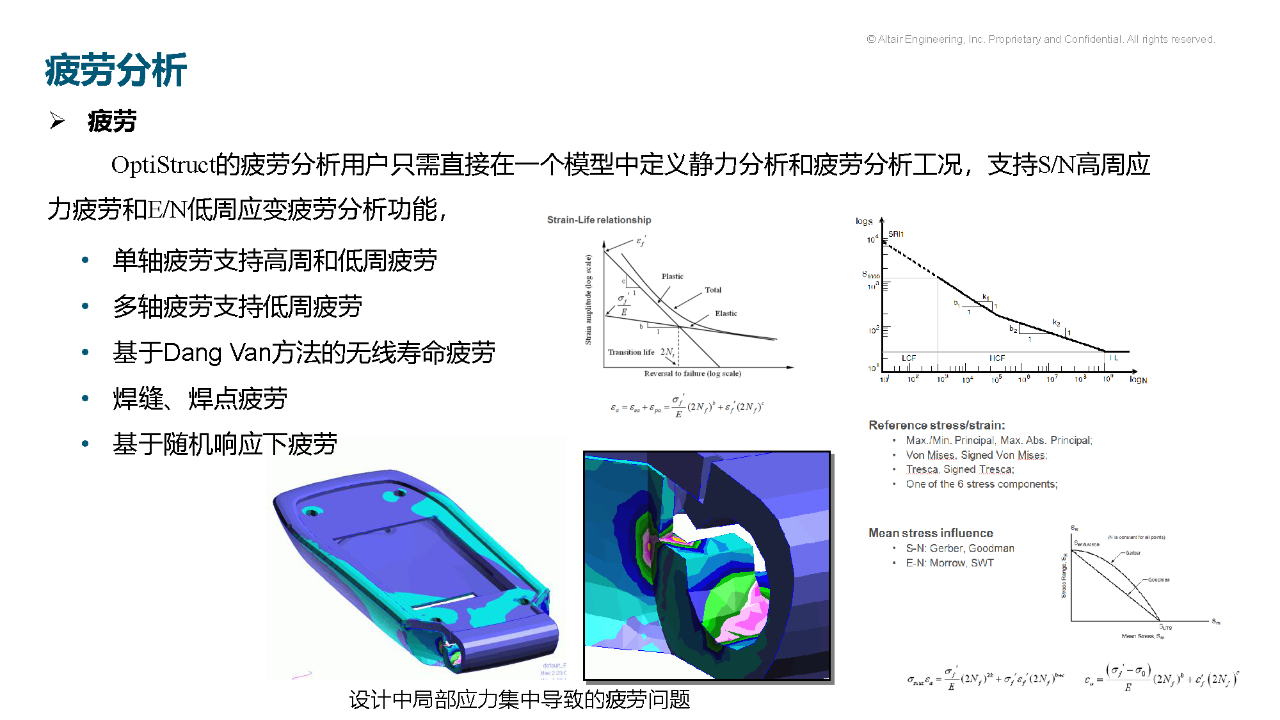
Radioss顯式動力學分析:顯示動力學案例
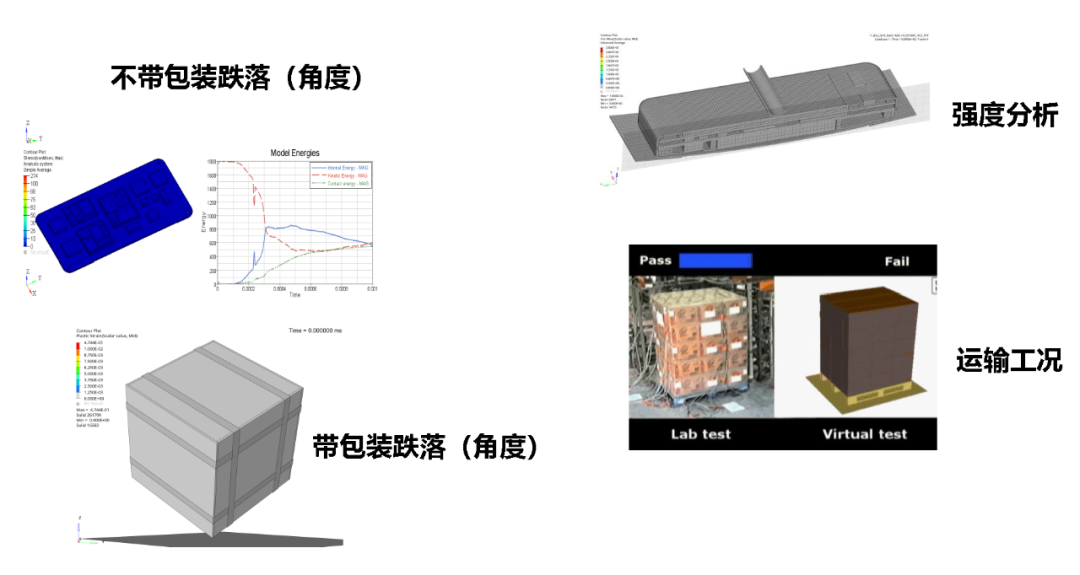
跌落分析:PCB板跌落分析
查看綁定接觸力/ANIM/VECT/CONT2
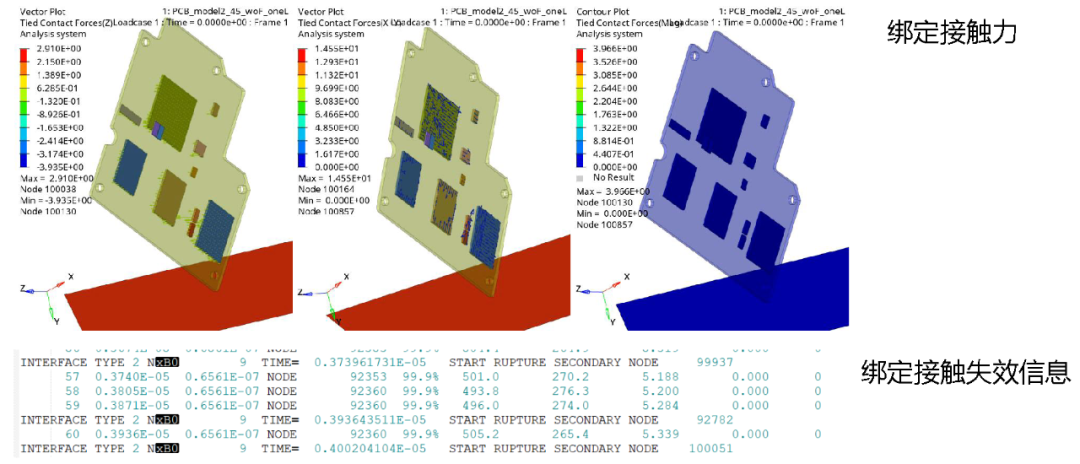
跌落分析:PCB板帶預緊跌落分析
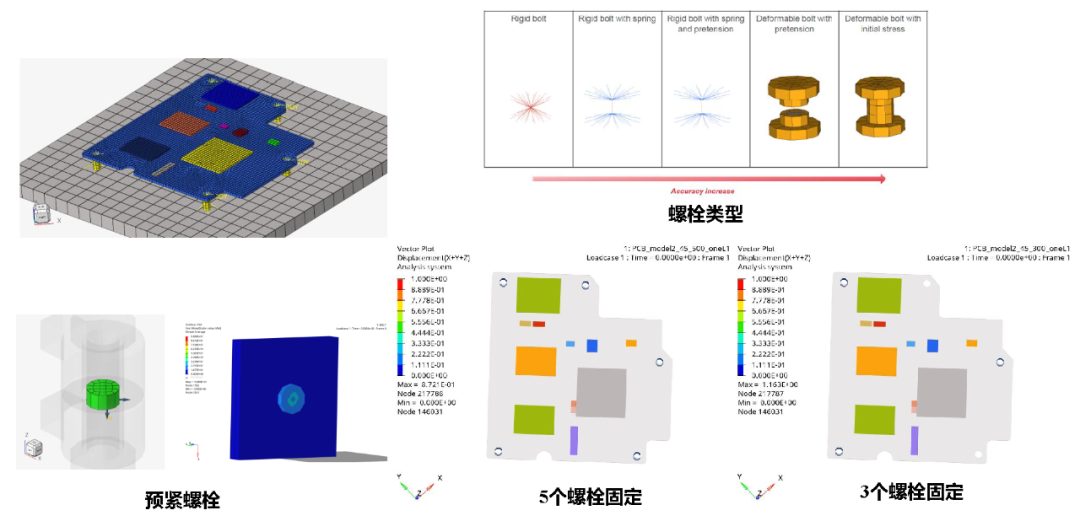
SIMSOLID無網格法快速分析
有限元技術的革新?SimSolid無網格分析方法
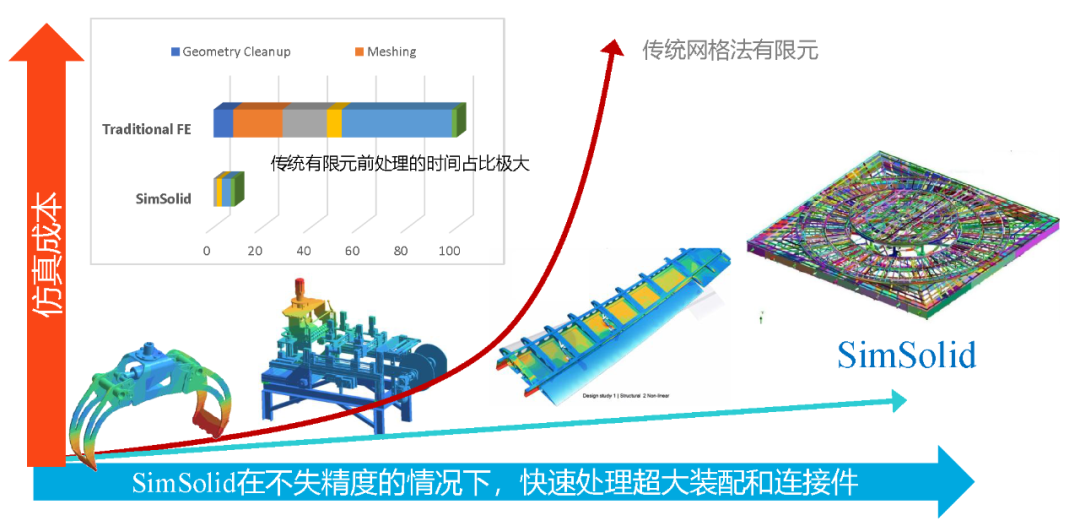
SimSolid的分析功能
靜強度分析
模態分析
熱分析
瞬態/頻響/隨機振動分析
螺栓預緊分析
大變形/接觸/彈塑性
熱固耦合分析
疲勞分析

靜強度分析:靜力學+模態分析
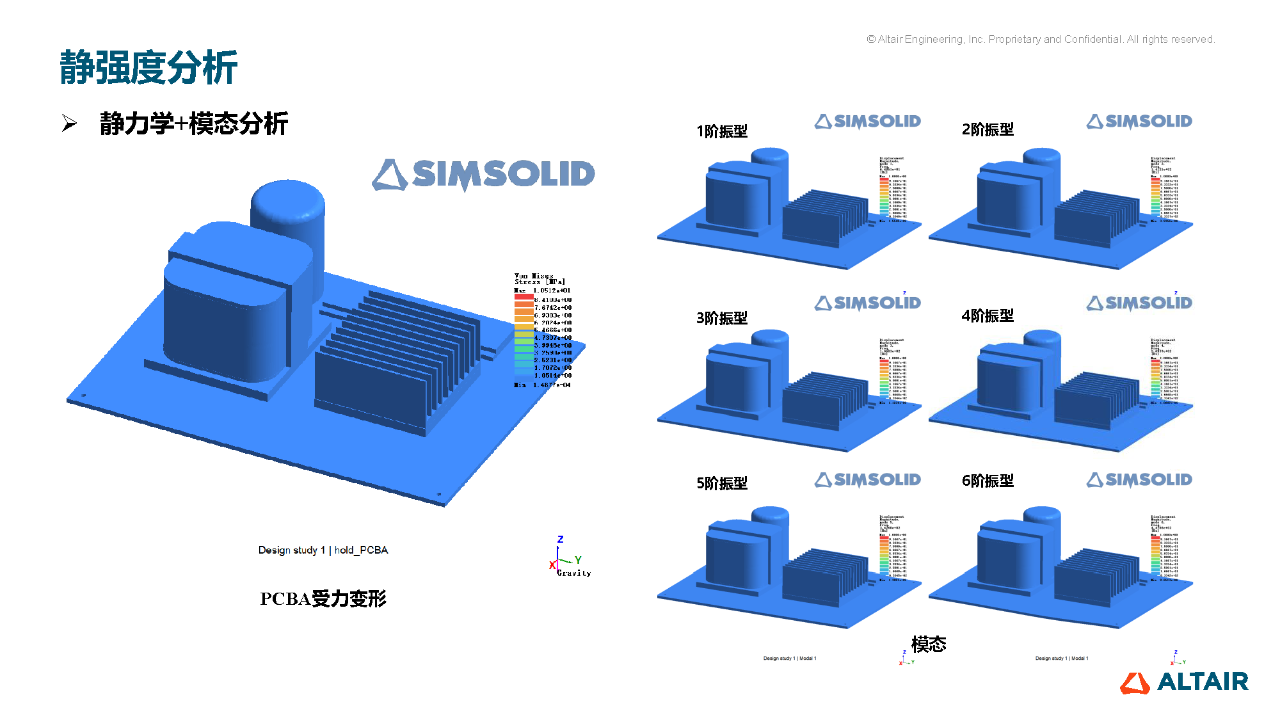
熱固耦合-深南電路:MCM-BGA 封裝體運行溫度及熱應力分析與優化設計
項目背景:MCM-BGA封裝體共包含9個芯片,每個芯片表面的熱功率為50W/cm^2,通過封裝體表面和散熱外殼冷卻通道散熱。優化封裝基體厚度和散熱基體厚度,確保芯片工作溫度和避免熱應力導致的開裂。
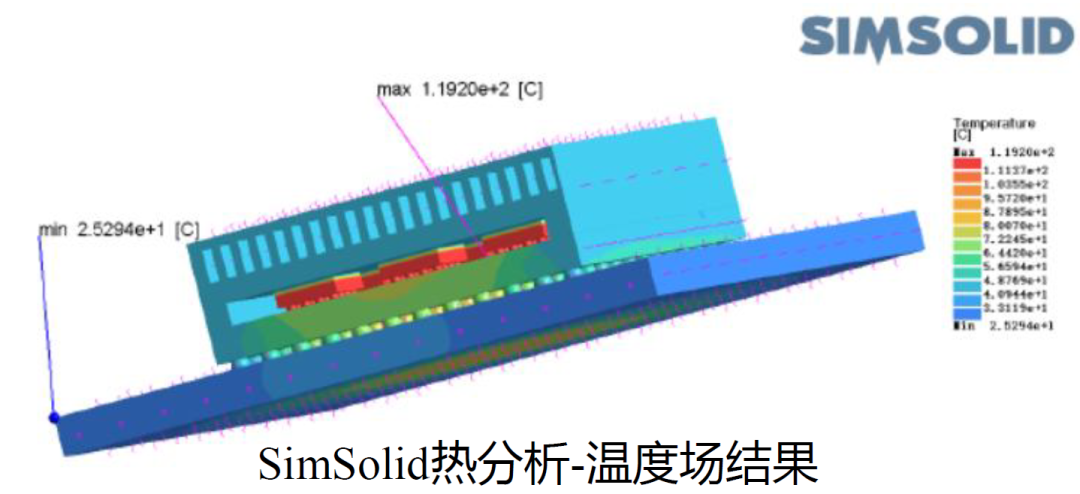
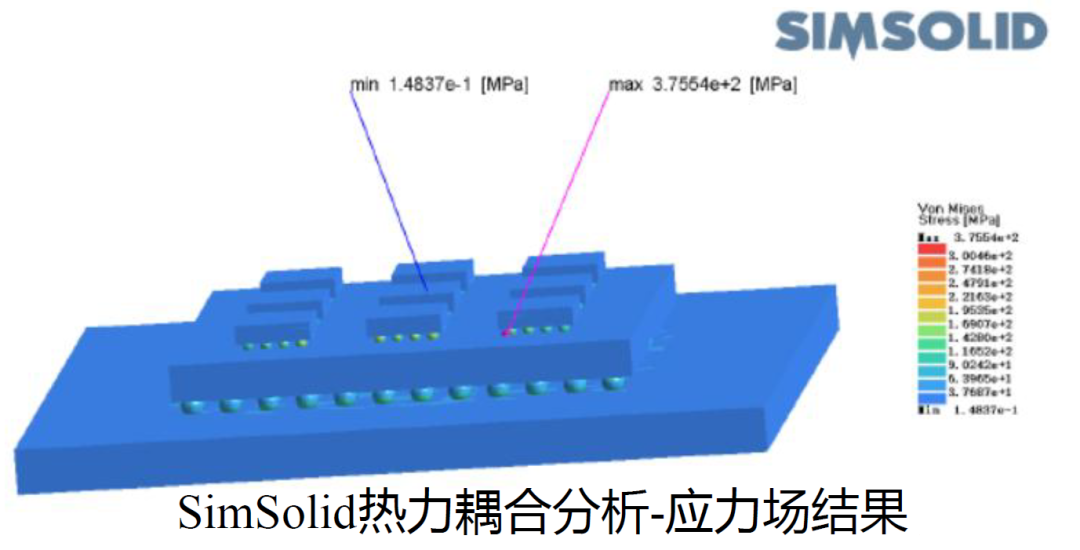
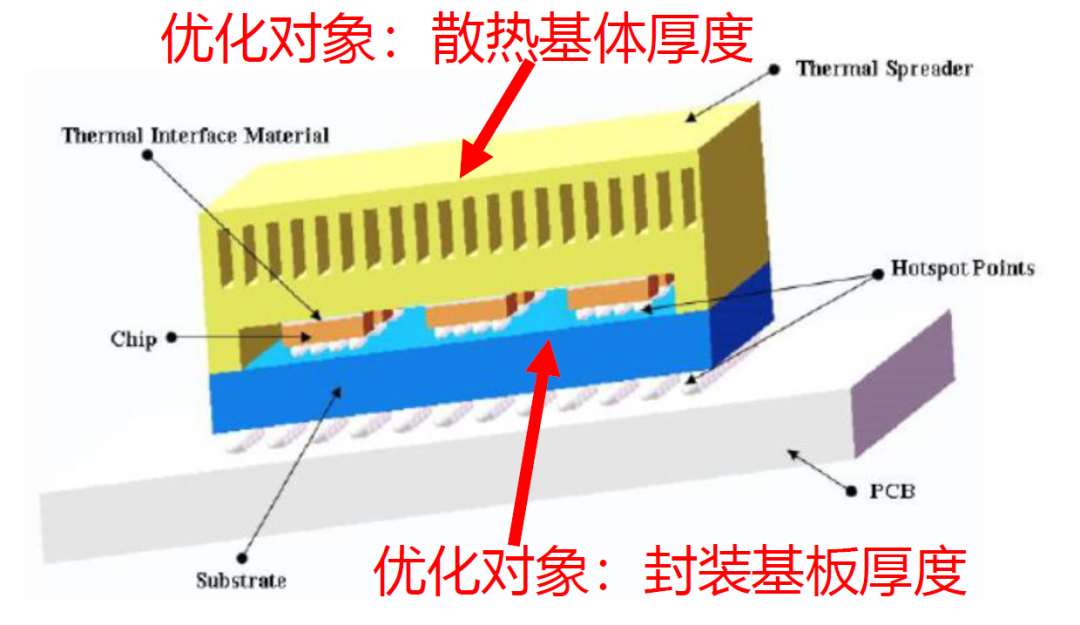
動力學仿真:頻響+隨機振動
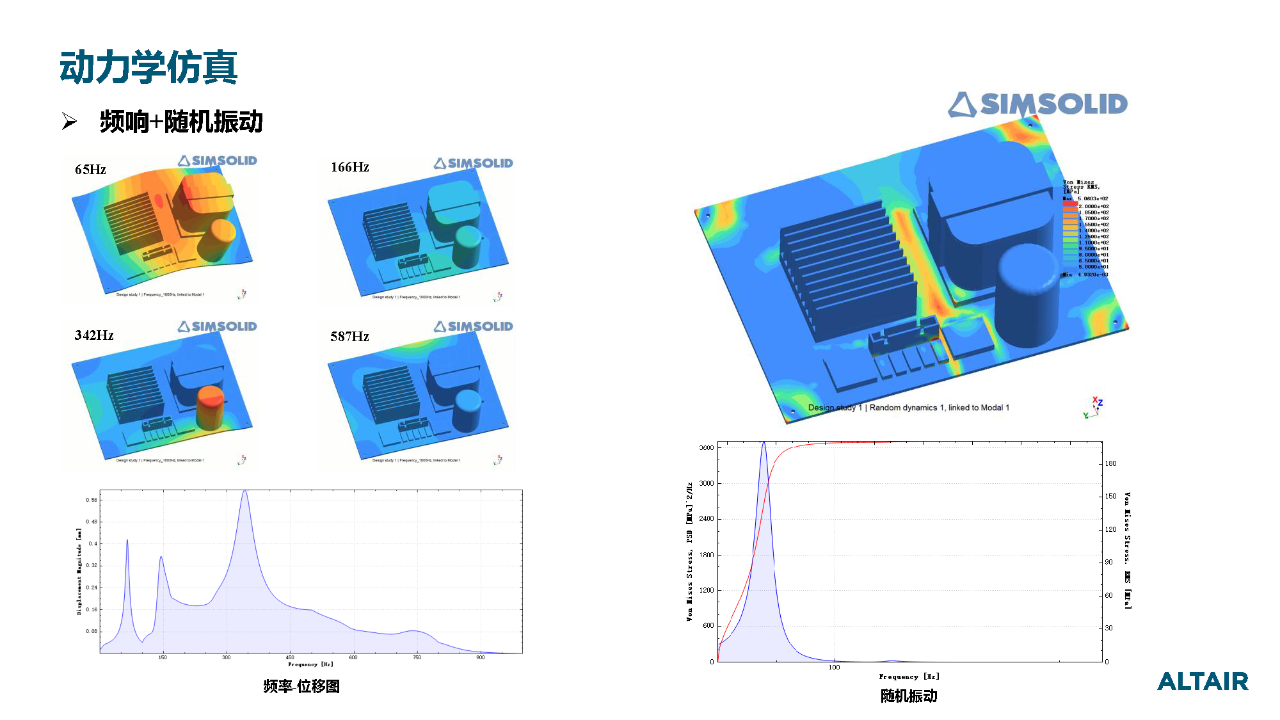
電子產品散熱分析
SimLab+ElectrFlo功能介紹
——流程簡單, 復雜模型, 結果準確
多物理場
電氣、熱、流
湍流& 瞬態
常見電子元件Smart Objects
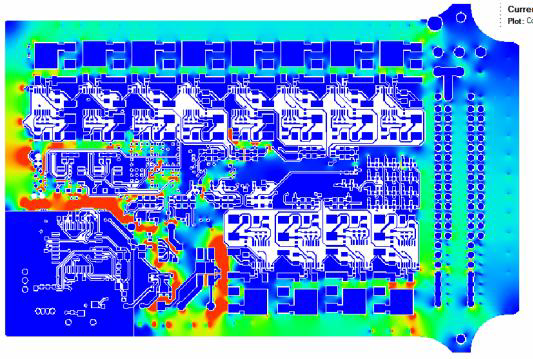
工作流程
基于CAD的前處理建模
容易處理復雜MCAD & ECAD模型
Dynamic setup
自動報告

用戶體驗
操作方便,容易上手
快速建模
快速設計變更
DOE
與Altair其它工具關聯
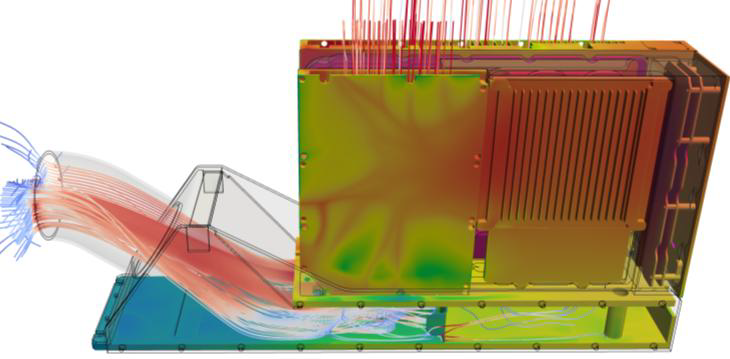
案例 1: 板級熱分析
PCB 含2層銅層 (0.03mm)
Non-CFD


包括銅層
案例 2: PCB元件散熱
板級模型,包含:
1 塊PCB
數十顆IC元件
模型設定:
PCB模型包含銅線
自然對流

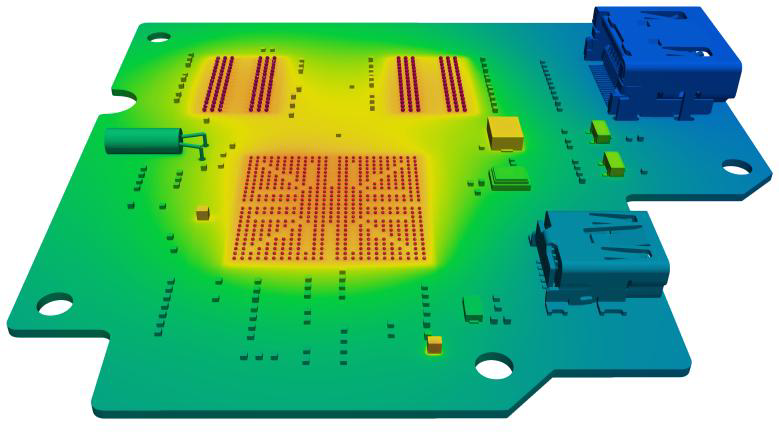
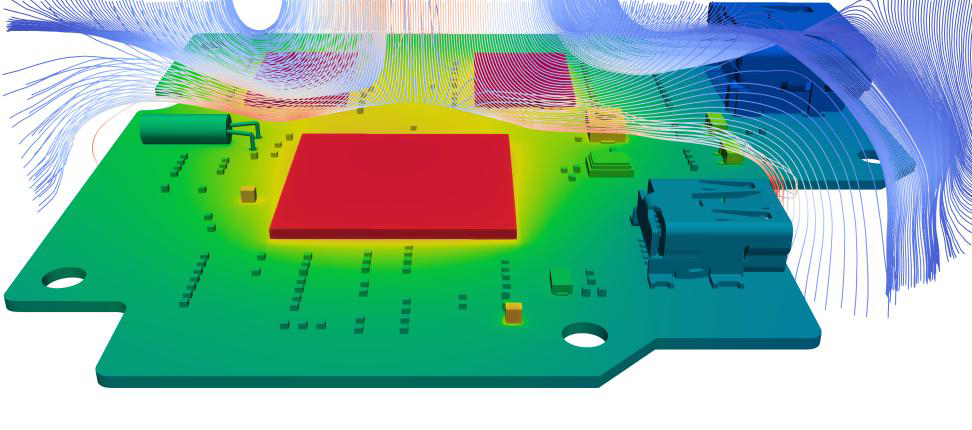
POLLEX
PollEx:簡介
Altair PollEx是一款涵蓋PCB設計審查、驗證、分析和制造的PCB級EDA軟件套件,可顯著縮短開發周期,同時為原理圖工程師、PCB設計師、CAE分析師和制造工程師提供通用應用程序便于溝通
PCB繪制和ECAD互通
PCB驗證(DFE, DFM, DFA)
PCB仿真(SI / PI / Thermal)
統一部件編輯器
原理圖 / CAM
制造
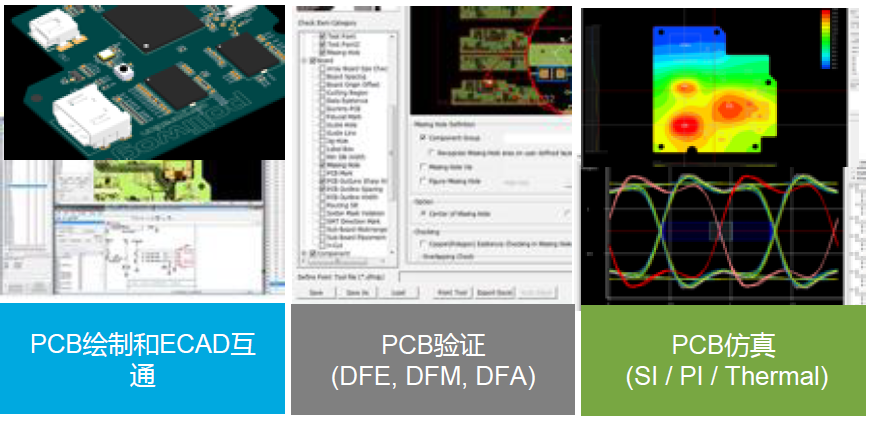

PollEx:PollExPCB驗證
通過將后期設計引入早期設計階段,DFx是顯著減少PCB設計迭代和成本的關鍵
檢測可能在制造(DFM)、裝配(DFA)或引起電氣故障(DFE)期間發生的設計故障。
可定制的基于規則的檢查,快速檢查數千個標準
驗證中包含仿真數據(使用PollEx DFE+時)

PollEx:PollExPCB仿真
快速,準確和簡單的PCB SI分析儀
網絡拓撲分析儀可以創建/修改信號的拓撲結構并對其進行分析。

PollEx:PollEx PCB仿真
基于有限元法的考慮傳導、對流和輻射的板級熱分析
專門用于在早期設計階段進行快速準確的熱分析具有自動網格劃分和內置材料庫的有限元分析
分析與決策
熱輪廓和結溫可以考慮散熱器,熱通孔和楔形鎖嗎是否可以在PCB上應用單個元件的工作功率和局部邊界條件
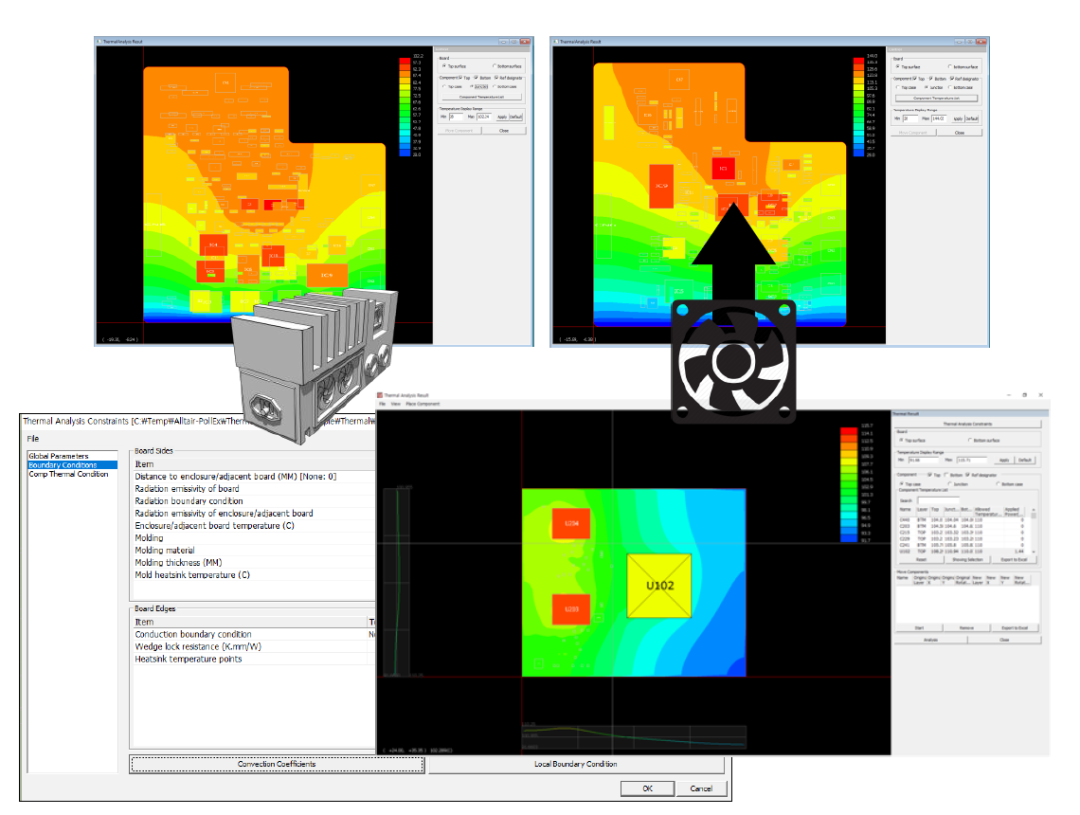
-
芯片封裝
+關注
關注
13文章
606瀏覽量
32129 -
PCBA
+關注
關注
25文章
1884瀏覽量
55890 -
Altair
+關注
關注
0文章
32瀏覽量
10212
發布評論請先 登錄
建立完善的硬件設計全流程解決方案

建議收藏:芯片設計全流程概述

PCBA 加工環節大盤點,報價全流程及周期深度剖析
PCBA加工變形問題頻發?這些解決方案趕緊收藏!
PCBA代工避坑指南:常見問題+解決方案全解析
PCBA打樣全流程避坑指南:為電子產品研發保駕護航

Profinet轉CC-Link IE總線協議轉換網關建議點贊收藏

EtherNet/IP從站轉CC-Link IEFB從站協議轉換網關,建議點贊收藏

別錯過!Altair 電池包仿真解決方案,干貨滿滿!

EtherNet/IP從站轉CC-Link從站協議網關配置方法詳細解讀,建議點贊收藏






 ALTAIR芯片封裝及PCBA全流程解決方案,建議點贊收藏!
ALTAIR芯片封裝及PCBA全流程解決方案,建議點贊收藏!











評論