在芯片設計完成后,樣品功能性測試、可靠性測試以及失效分析除錯等環節開展之前,樣品備制前處理是不可或缺的關鍵步驟。其中,芯片切片方式用于斷面/橫截面觀察,對于確認芯片內部的金屬接線、各層結構、錫球接合結構、封裝打線等潛在缺陷,具有至關重要的作用。
傳統機械研磨:大面積觀察的可靠選擇
傳統機械研磨的最大優勢在于能夠實現大面積的觀察范圍,可覆蓋小于 15cm 的區域,跨越整顆晶粒甚至封裝品。這使得其在需要全面性檢視堆疊結構或進行尺寸量測時,成為理想的選擇。其操作流程包括機械切割、冷埋、研磨、拋光四個步驟,通過這些步驟將樣品拋光至所需觀察的位置。
然而,傳統研磨存在兩項明顯弱點:一是機械應力容易導致結構損壞,如變形、刮痕等;二是操作過程高度依賴操作人員的經驗,經驗不足可能導致誤傷目標觀測區,進而影響后續分析結果。
離子束 (CP):精準切削與微蝕刻的優勢
Cross-section Polisher(簡稱 CP)相較于傳統機械研磨,利用離子束切削作為最后的 ending cut,能夠顯著降低人為損傷,避免傳統研磨機械應力造成的結構損壞。
除了切片功能外,CP 還可針對樣品進行表面微蝕刻,有效解決研磨后金屬延展或變形問題。金鑒實驗室在進行試驗時,嚴格遵循相關標準操作,確保每一個測試環節都精準無誤地符合標準要求。
當需要觀察金屬堆棧型結構、界面合金共化物(Intermetallic compound,簡稱 IMC)時,CP 是非常合適的分析手法。具體操作是先通過研磨將樣品停在目標區前,再利用氬離子 Ar+ 進行切削至目標觀測區,這樣不僅可縮短分析時間,后續搭配掃描式電子顯微鏡(Scanning Electron Microscope,簡稱 SEM)拍攝,還能呈現絕佳的材料對比效果。
Plasma FIB:局部分析的精準利器
在 3D-IC 半導體工藝技術中,若不想通過研磨將樣品整個破壞,可選擇「電漿聚焦離子束顯微鏡(Plasma FIB,簡稱 PFIB)」分析手法。PFIB 結合電漿離子蝕刻加工與 SEM 觀察功能,適用于 50-500 um 距離范圍內的截面分析與去層觀察,還可針對特定區域邊切邊觀察,避免盲目切削誤傷目標區,確保異常或特定觀察結構的完整性。
Dual Beam FIB:納米尺度的精細分析
結合鎵離子束與 SEM 的雙束聚焦離子顯微鏡(Dual Beam FIB,簡稱 DB-FIB),能夠針對樣品中的微細結構進行納米尺度的定位及觀察,適用于 50um 以下結構或異常的分析。為了方便大家對材料進行深入的失效分析及研究,金鑒實驗室具備Dual Beam FIB-SEM業務,包括透射電鏡(TEM)樣品制備,材料微觀截面截取與觀察、樣品微觀刻蝕與沉積以及材料三維成像及分析等。
此外,DB-FIB 還可進行 EDX 以及電子背向散射(Electron Backscatter Diffraction,簡稱 EBSD)分析,獲取目標區成分及晶體相關信息。當異常區域或結構過小,SEM 無法提供足夠信息時,DB-FIB 還可執行穿透式電子顯微鏡(Transmission Electron Microscope,簡稱 TEM)的試片備制,后續借助 TEM 進行更高分辨率的分析。
在芯片樣品備制前處理過程中,根據不同的觀察需求和樣品特點,合理選擇傳統機械研磨、離子束 (CP)、Plasma FIB 或 Dual Beam FIB 等分析手法,能夠有效提高分析效率和準確性,為后續的芯片測試與失效分析提供有力支持。
-
芯片
+關注
關注
463文章
54256瀏覽量
468233 -
測試
+關注
關注
9文章
6313瀏覽量
131574 -
離子束
+關注
關注
0文章
114瀏覽量
8137
發布評論請先 登錄
如何找到專業做FIB技術的?
失效分析:離子束剖面研磨
集成電路背面研磨(Backside Polishing)
芯片失效分析含義,失效分析方法
氬離子拋光離子研磨CP制樣 氬離子拋光制備EBSD樣品效果分享




 芯片樣品備制前處理技術分析(CP研磨、FIB分析)
芯片樣品備制前處理技術分析(CP研磨、FIB分析)

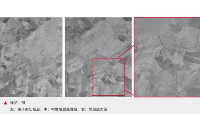

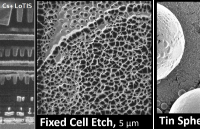
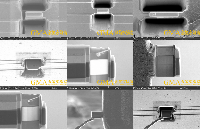
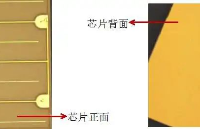



評論