???本文主要介紹如何測量晶圓表面金屬離子的濃度。?
金屬離子濃度為什么要嚴格控制?????
金屬離子在電場作用下容易發生遷移。如Li?,Na?、K?等可遷移到柵氧化層,導致閾值電壓下降。
常用的檢測晶圓表面金屬離子的儀器?
全反射 X 射線熒光光譜儀,英文簡稱TXRF。
X射線熒光是什么?
當X射線照射樣品時,樣品原子吸收X射線的能量,使原子的內層電子被激發到更高能級,原有位置形成空穴。而外層電子會躍遷至內層空穴,在躍遷過程中,多余的能量以特定波長的X射線形式釋放。通過檢測這些X射線,可以確定元素的種類和含量。
什么叫全反射?
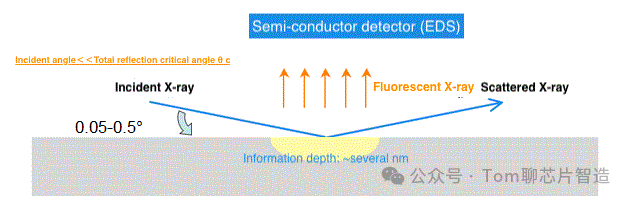
如上圖,TXRF的X 射線會以極低的入射角照射樣品表面,X 射線的穿透深度僅有幾個nm,即全部反射,大大減少了背景信號干擾,因此可檢測低至 ppb級別的痕量金屬污染。? TXRF的優勢? 1、靈敏度高 2、非破壞性 3、快速檢測,一般只要幾分鐘 4,全晶圓分析 5、可以分析多種襯底,例如 Si、SiC、GaAs、InP、藍寶石、玻璃等
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
晶圓
+關注
關注
53文章
5410瀏覽量
132298 -
X射線
+關注
關注
4文章
223瀏覽量
52864 -
金屬離子
+關注
關注
0文章
7瀏覽量
7116
原文標題:如何測量晶圓表面金屬離子的濃度?
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
熱點推薦
如何檢測晶圓清洗后的質量
檢測晶圓清洗后的質量需結合多種技術手段,以下是關鍵檢測方法及實施要點:一、表面潔凈度檢測顆粒殘留分析使用光學顯微鏡或激光粒子計數器檢測≥0.3μm的顆粒數量,要求每片晶圓≤50顆。共聚
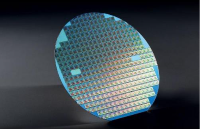
清洗晶圓去除金屬薄膜用什么
清洗晶圓以去除金屬薄膜需要根據金屬類型、薄膜厚度和工藝要求選擇合適的方法與化學品組合。以下是詳細的技術方案及實施要點:一、化學濕法蝕刻(主流方案)酸性溶液體系稀鹽酸(HCl)或硫酸(H



晶圓清洗后表面外延顆粒要求
晶圓清洗后表面外延顆粒的要求是半導體制造中的關鍵質量控制指標,直接影響后續工藝(如外延生長、光刻、金屬化等)的良率和器件性能。以下是不同維度的具體要求和技術要點:一、顆粒污染的核心要求

晶圓蝕刻擴散工藝流程
晶圓蝕刻與擴散是半導體制造中兩個關鍵工藝步驟,分別用于圖形化蝕刻和雜質摻雜。以下是兩者的工藝流程、原理及技術要點的詳細介紹:一、晶圓蝕刻工藝流程1.蝕刻的目的圖形化轉移:將光刻膠圖案轉

MICRO OLED 金屬陽極像素制作工藝對晶圓 TTV 厚度的影響機制及測量優化
與良品率,因此深入探究二者關系并優化測量方法意義重大。 影響機制 工藝應力引發變形 在金屬陽極像素制作時,諸如光刻、蝕刻、金屬沉積等步驟會引入工藝應力。光刻中,光刻膠的涂覆與曝光過程會因光刻膠固化收縮產生應力。蝕刻階段,蝕刻氣體

wafer晶圓厚度(THK)翹曲度(Warp)彎曲度(Bow)等數據測量的設備
和成本控制的核心參數。通過WD4000晶圓幾何形貌測量系統在線檢測,可減少其對芯片性能的影響。
WD4000晶圓幾何量測系統適用于裸
發表于 05-28 16:12
晶圓表面清洗靜電力產生原因
表面與清洗設備(如夾具、刷子、兆聲波噴嘴)或化學液膜接觸時,因材料電子親和力差異(如半導體硅與金屬夾具的功函數不同),發生電荷轉移。例如,晶圓表面
提供半導體工藝可靠性測試-WLR晶圓可靠性測試
(low-k)材料在應力下的擊穿風險。
晶圓級可靠性測試系統Sagi. Single site system
WLR的測量儀器主要是搭配的B1500A參數分析儀,WLR測試包括熱載流子注入
發表于 05-07 20:34



 如何測量晶圓表面金屬離子的濃度
如何測量晶圓表面金屬離子的濃度







評論