來源:芯德科技
芯德科技:先進封裝引領(lǐng)
光通信芯片未來
半導(dǎo)體行業(yè)蓬勃發(fā)展,芯德科技似璀璨之星閃耀,公司于2020年9月在南京城起步,專注中高端封裝測試,秉持強大技術(shù)實力與創(chuàng)新精神,一路奮進。至2024年9月,成功實現(xiàn) 5nm 芯片 FOCT-R (FANOUT Connected Tech - RDL)封裝結(jié)構(gòu)出貨,此為業(yè)內(nèi)罕見壯舉。這彰顯深厚技術(shù)底蘊,助其立足行業(yè)前沿,具備國際競爭之力,引領(lǐng)行業(yè)前行。
2.5D晶圓級再布線轉(zhuǎn)接板封裝
實現(xiàn)重大突破
該芯片屬于光通信領(lǐng)域,是通過光信號進行數(shù)據(jù)傳輸?shù)母呒尚酒K捎弥薪閷犹娲澹⒃诰A上實施 SMT 貼裝,實現(xiàn)了先進封裝技術(shù)的重大突破,其核心創(chuàng)新點主要呈現(xiàn)在以下幾個方面:
1.超高層數(shù)再布線轉(zhuǎn)接板制備
成功達成 7P7M(七層Polyimide層,七層metal層)的 interposer(中介層)設(shè)計與制造工藝,且擁有 5μm/5μm的超窄線寬線間距 RDL(重布線層),此復(fù)雜層結(jié)構(gòu)顯著提升了電氣性能與熱管理性能,更助力封裝在微小尺寸下集成更多功能。
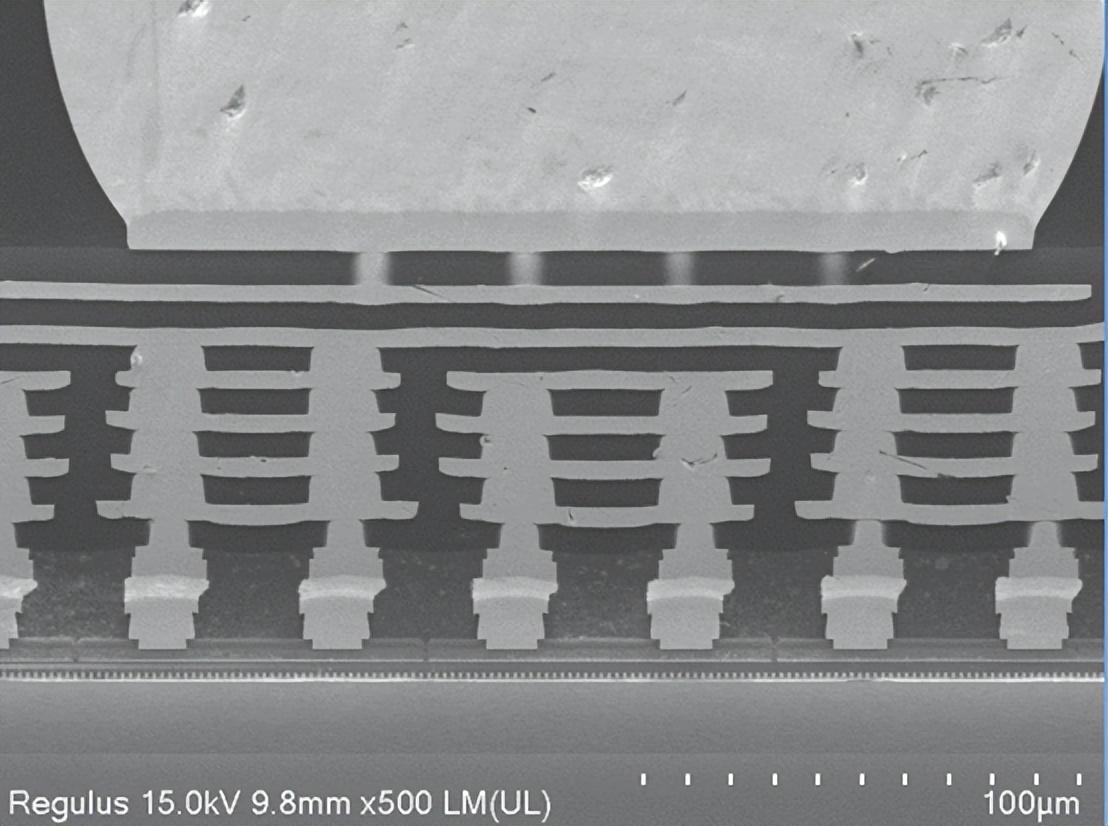
有機再布線轉(zhuǎn)接板切片圖
2.超窄間距的微凸塊加工
實現(xiàn)了微凸塊加工的重大突破,成功創(chuàng)制出凸點尺寸僅 18 μm且凸點間距為 36 μm的頂級芯片封裝。這一技術(shù)突破意味著芯德科技現(xiàn)在能夠生產(chǎn)出具有極高集成度和精細結(jié)構(gòu)的芯片封裝產(chǎn)品,這對于滿足當(dāng)前及未來市場對高性能、小型化電子產(chǎn)品的需求至關(guān)重要。
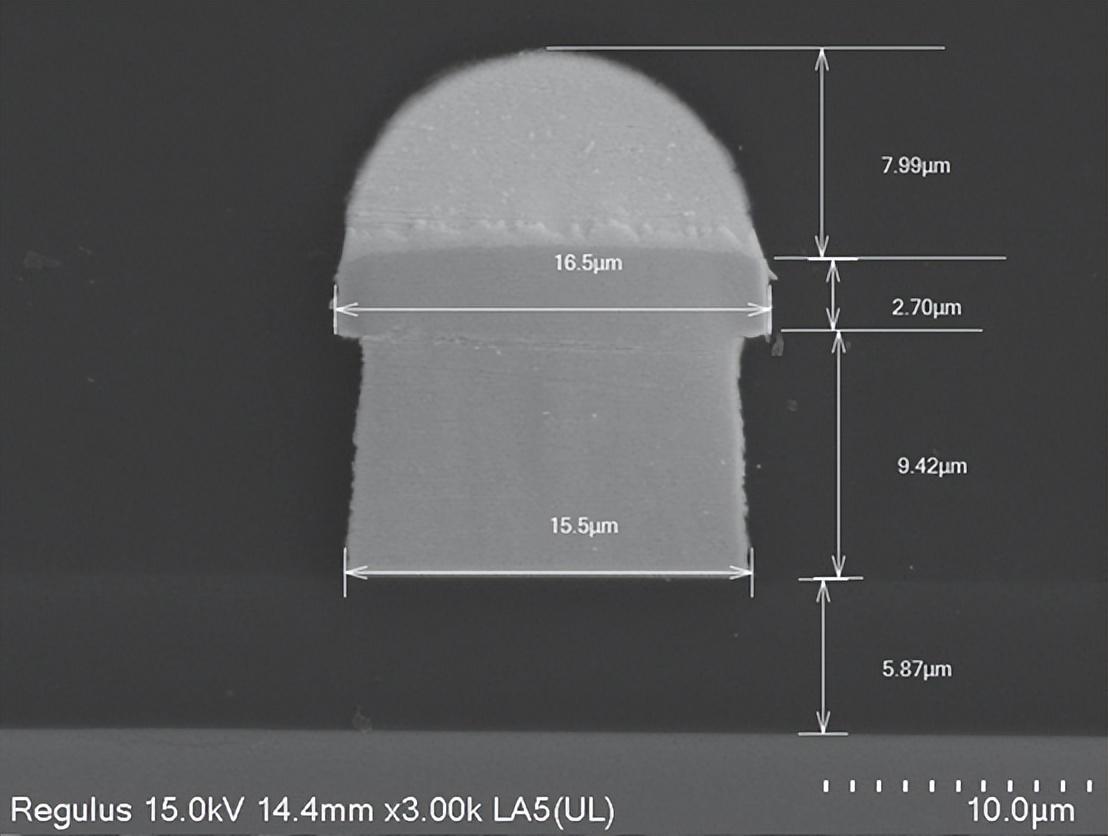
JSSI Micro Bump 切片圖
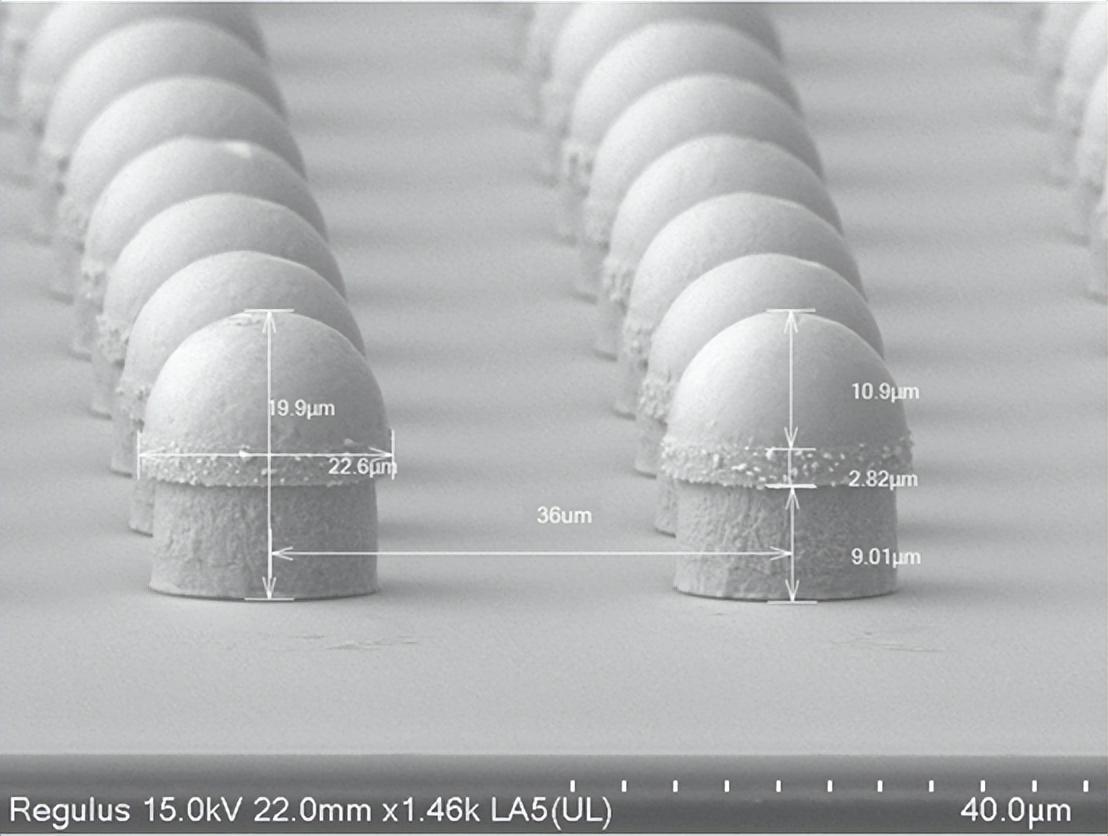
JSSI 36um Bump Pitch
3.超高數(shù)量晶圓貼裝突破
成功實現(xiàn)晶圓級表面貼裝(SMT)技術(shù)的重大跨越。其達成了在單片晶圓上貼裝超 40000 個元器件的驚人成果。這一成果極大地豐富了芯片功能集成的維度,讓芯片如同一個多功能的微型智能中樞。而且,在電性能方面,芯片更是實現(xiàn)了飛躍式提升,從電流傳輸?shù)姆€(wěn)定性到信號處理的高效性,都達到了新的高度,為半導(dǎo)體行業(yè)發(fā)展注入強大動力。
4.超高精度熱壓焊(TCB)
完成 TSMC 5nm 制程工藝芯片的倒裝,展現(xiàn)出超高精度,可精確至±3μm。此精度能夠完美契合芯片堆疊的高端封裝需求,在封裝進程中,確保各層精準(zhǔn)對齊與可靠連接,宛如精密齒輪般嚴絲合縫,為整個封裝結(jié)構(gòu)賦予卓越性能與超凡可靠性,有力推動芯片封裝領(lǐng)域邁向新高度。
隨著此款產(chǎn)品開發(fā)完成,標(biāo)志著芯德科技在芯片封裝領(lǐng)域?qū)崿F(xiàn)重大飛躍,在有限空間內(nèi)巧妙融合88顆電容與邏輯芯片,有力提升光通信系統(tǒng)性能,大幅削減延遲并降低功耗。憑借 5μm×5μm 的細微線路,高速信號得以暢行無阻,延遲顯著降低的同時,數(shù)據(jù)吞吐量顯著增加。Expose die 結(jié)構(gòu)強化散熱效果、穩(wěn)定性得以提升。以7P7M中介層取代基板,有效控制成本,提升效益。此款產(chǎn)品芯德科技歷經(jīng)一年精心研發(fā),這一成果標(biāo)志著其在 2.5D、3D 晶圓級先進封裝領(lǐng)域再次取得重大突破,邁出堅實有力的一大步,充分彰顯出在高端封裝技術(shù)領(lǐng)域的卓越研發(fā)實力以及源源不斷的創(chuàng)新活力。
江蘇芯德半導(dǎo)體科技股份有限公司
江蘇芯德半導(dǎo)體科技股份有限公司成立于2020年9月,是一家成長于南京本地致力于中高端封裝測試的集成電路企業(yè)。目前可為客戶提供Bumping、WLCSP、Flip Chip PKG、QFN、BGA、SIP、SIP-LGA、2.5D的封裝產(chǎn)品設(shè)計和服務(wù)。
公司秉持和睦大家庭式的文化,堅持以人為本、科技創(chuàng)新、集體奮斗和職業(yè)化管理的企業(yè)核心價值觀,并以全心全意滿足客戶的需求為我們最大的追求,依靠持續(xù)創(chuàng)新和鍥而不舍的艱苦奮斗的精神發(fā)展先進的封測核心技術(shù),使芯德科技成為世界一流的封測企業(yè),服務(wù)并推動全球半導(dǎo)體產(chǎn)業(yè)的發(fā)展。
2023年3月,芯德科技先進封裝技術(shù)研究院推出CAPiC平臺,重點發(fā)展以Chiplet異質(zhì)集成為核心的封裝技術(shù),是先進封裝技術(shù)發(fā)展的又一突破,有望推動異質(zhì)整合成為未來芯片設(shè)計的主流。有關(guān)更多信息,請訪問我們的官方網(wǎng)站
-
半導(dǎo)體
+關(guān)注
關(guān)注
339文章
30737瀏覽量
264141 -
光通信
+關(guān)注
關(guān)注
20文章
1003瀏覽量
35387 -
先進封裝
+關(guān)注
關(guān)注
2文章
533瀏覽量
1027
發(fā)布評論請先 登錄
突破10Gbps帶寬!車載光通信新品正登場,“光纖上車”成新趨勢

易天光通信的產(chǎn)品優(yōu)勢與場景深耕

智賦新質(zhì),光耀未來|度亙核芯斬獲光通信兩大行業(yè)獎項!

芯波微電子榮獲2025年度ICC訊石光通信行業(yè)英雄榜創(chuàng)新技術(shù)獎
惠倫晶體晶振產(chǎn)品推動光通信技術(shù)革新

關(guān)于無線光通信物理層安全性的技術(shù)方案

安捷倫86120C多波長計:光通信測試的精密計量平臺

重磅發(fā)布!空間及水下無線光通信行業(yè)全景報告,解鎖未來通信新賽道

EML芯片:光通信與人工智能融合的技術(shù)引擎
攜手共探無線光通信新未來!六博光電邀您相聚第六屆無線光通信理論與組網(wǎng)技術(shù)論壇

愛普生VG5032EDN壓控晶振在光通信設(shè)備中的應(yīng)用

見合八方邀您相約2025國際光通信與網(wǎng)絡(luò)會議
瑞盟科技--光通信與光電領(lǐng)域芯片應(yīng)用解決方案
高速光通信器件的現(xiàn)狀剖析
六博光電支持OpenVLC推出高性價比可見光通信模組




 芯德科技:先進封裝引領(lǐng)光通信芯片未來
芯德科技:先進封裝引領(lǐng)光通信芯片未來




評論