共讀好書
陳忠紅 任英杰 王亮 陳佳 周蓓 劉國兵 謝志敏
(浙江華正新材料股份有限公司)
摘要:
有機復合基板材料在電子封裝中主要起到半導體芯片支撐、散熱、保護、絕緣及與外電路互連的作用。隨著電子產品高速化、高性能化、小型化、低成本化以及先進封裝技術的不斷出現和高密度封裝基板的發展需求,對封裝基板材料提出了更高的性能要求,包括高彎曲模量、高玻璃化轉變溫度、高熱分解溫度、低的熱膨脹系數、高電絕緣性、高的導熱等性能。本文綜述了各種改性樹脂制備IC 封裝載板有機復合基板材料研究進展。
1 引言
電子產品發展日新月異,離不開芯片封裝技術的快速進步;封裝基板材料作為IC 載板的關鍵原材料一直都是技術開發的重要方向。IC 芯片集成度的發展仍基本遵循著名的Moore 定律[1-4],致使數字網絡時代電子設備向微型、輕質、超薄、高性能發展,為匹配這趨勢;小型、細引腳節距、立體化、高頻高速、大功率密度等成為電子封裝發展方向。電子封裝技術也從DIP、PGA、QFP 等初級水平向微系統疊層三維封裝、疊層MCM、BGA、模塊疊層三維封裝、芯片疊層三維封裝等方向推進。
基板材料在整個電子封裝領域有著極其重要的地位。基板主要起到為芯片及元器件提供機械支撐保護、散熱及絕緣等重要作用,其性能的好壞影響著IC 制造水平的高低[5]。高頻高速化是電子封裝技術的發展方向,其導致芯片及其封裝結構的整體尺寸越來越小,局部熱量積累的現象更加嚴重,這就給電子封裝用基板材料提出了更加苛刻的要求。為了保障電子元器件持續穩定地高效運行,電子封裝用基板材料應當具備以下幾點性能[6,7]:1
(1)高的機械強度:基板起到搭載支撐元器件的作用,其較高的機械性能是元器件能夠穩定持續工作的外部保障;如彎曲模量達28Gpa 以上。
(2)良好的加工性:基板需要加工成所需的各種形狀,特別是多層超薄HDI 加工,所以加工性能對于基板材料也極為關鍵;
(3)熱膨脹系數與連接材料相匹配:與基板連接的材料基本上指的是硅。兩者間若熱膨脹系數差別太大容易誘發界面結合失效;如CTE-XY<13ppm。
(4)高熱導率:基板材料承擔著散熱的角色,所以需要高的熱導率來加快熱量的擴散;
(5)易金屬化:印刷的電路圖案在基板上的附著力要足夠強,避免脫落;剝離強度需達0.7N/mm 以上。
(6)較低的介電常數及介電損耗:高介電常數容易導致信號延遲;
(7)高絕緣性:基板應能保證部分的電絕緣作用;
(8)吸濕率低,化學穩定性優良;
(9)價格低廉,利于大規模生產。
理想很豐滿現實很骨感,現實應用同時滿足以上要求難之又難。最早工程師因陶瓷基板具有化學穩定性高,機械強度高,導熱系數高,熱膨脹系數小選用其作為電子封裝基板材料。但其熱膨脹系數和Si 的差異較大、制作成本高且某些劇毒性、同時難加工難金屬化都限制了其發展。有機樹脂基板因為其易加工、成本低、輕質化等優異性能成為了陶瓷基板的代替選項,但其熱穩定差、導熱低、熱膨脹系數偏大也使其走得很長遠。有機復合基板材料很好的復合了無機材料的優點和有機材料的優點而成為封裝載板基板材料的熱門選擇。本文將從有機復合基板材料的樹脂改性、填料、玻纖布、應用等方面綜述有機復合基板材料的發展。
2 環氧樹脂復合封裝基板材料
環氧樹脂/玻璃玻纖布復合基板因其成本低、加工性優良、良好的尺寸穩定性和粘結性很早就在封裝載板基板材料中得到應用[8]。為了克服環氧樹脂耐熱性不足和熱膨脹系數偏高及導熱能力不足等問題環氧樹脂復合封裝基板通過復合環氧樹脂及功能性填料的優異性能使基板向多功能化方向發展。日本日立化成工業株式會開發了一種低熱膨脹系數高彈性模量的環氧樹脂封裝用基板材料[9]。它在樹脂配方中,采用了一種新型工藝技術,借助于種特有的界面處理形式,使填料與樹脂間可實現高比例分散,獲得以往制造技術難以達到的高填料比的設計目標。該基材具有以下優良特性:①在X,Y 方向的熱膨脹系數低于10-20ppm/℃(為傳統FR-4 板的60—80%);②具有高彈性模量(為傳統的FR-4 板的1.3-1.5 倍);③高表面硬度(為傳統FR-4 板的1.5-2.0 倍);④良好的表面平滑度,粗糙度只有2-3um;同時還具備優良的耐熱性,PCT 處理后能承受T288/5h 耐熱處理。該基材很好的復合了環氧與功能填料優異性能,實現了材料性能質的提升。除了使用高填料比方案,選用高剛性環氧樹脂高玻璃轉變固化劑也是制備封裝基板材料的方向;覆銅板資訊張*[10]譯了一種低翹曲度、吸濕耐熱性好的PCB 基材,該基材使用高剛性萘型環氧樹脂作為主體樹脂,用萘型酚醛固化,再使用環氧改性丙烯酸樹脂增韌復合功能化改性SiO2 填料改善熱膨脹系;最終制備出翹曲度為480um~485um; 熱膨脹系數CTE 為7.0~7.2ppm/℃,低吸濕的封裝基材材料。封裝基板材料除在樹脂上做文章也可在填料上進行探索;吳*[11]等人為解決環氧樹脂導熱低及介電常數高的問題,使用高溫燒結技術制備了不同孔隙率的Al2O3網狀多孔陶瓷,并將其加入環氧樹脂基體中,使復合材料導熱率達到了1.598 W/m·K;為降低環氧樹脂的介電常數又在環氧樹脂基體中引入中空玻璃微珠骨架填料使復合材料的介電常數降低到3.0,以上研究可在封裝基材有一定的應用前景。
環氧樹脂復合封裝基材未來開發方向將緊跟封裝技術變動而動,高模量、低翹起、低介電常數、高玻璃轉變溫度、低CTE、高表面光滑度等。
3 BT 樹脂及改性BT 樹脂復合封裝基板材料
雙馬來酰亞胺三嗪(BT)樹脂具高的耐熱性、較低熱膨脹系數、低吸水率、較低的介電常數及介質損耗等性能成為環氧復合材料外應用于封裝基板爭相追捧的材料。BT 樹脂復合封裝基板材料應用最成功的屬日本三菱瓦斯化學公司(MGC),其開發的BT 基板大量的應用于封裝基板。但由于其技術難模仿及獨立開發難度較大,需要一些路徑來實現BT樹脂在封裝基板材料中更廣泛的應用。改性BT 樹脂獲得一種“類BT”樹脂系列的樹脂組合物成為開發的熱門方向。
3.1 環氧改性BT 樹脂復合封裝基板材料
BT 樹脂雖然有著許多優異性能,但由于其自身結構易結晶及交聯密度較高也有導致其溶解性差及韌性差的問題。環氧樹脂對BT 樹脂相容性好、粘度低,可溶于低沸點溶劑,能降低固化溫度及時間,提高韌性、加工工藝性、耐濕熱性,還改善對玻璃纖維的浸潤性,提高了對銅箔的粘接強度,降低成本等。粟**[12]分別采用聯苯苯酚型環氧和鄰甲酚醛型環氧與增容改性樹脂(類BT 樹脂)制備了覆銅板材料,經改性較好的改善了預浸料相容性問題,同時制備覆銅板具有較低的CTE,同時Tg 達到了高Tg 封裝基板水平。李**[13]在增容改性氰酸酯/雙馬來酰亞胺的基礎上引入低粘度環氧組分,構成了增容改性的氰酸酯/雙馬來酰亞胺/環氧體系(三元樹脂體系)。發現制備的覆銅基板很好的保持了原有的耐熱性,同時介電性能下降較小。
3.2 增韌化合物改性BT 樹脂復合封裝基板材料
雙馬來酰亞胺三嗪(BT)樹脂使用雙馬來酰亞胺(BMI)和氰酸酯CE 共聚交聯而成,由于BT樹脂固化交聯密度極高,具有很高的玻璃化轉變溫度(Tg)。交聯密度高必定帶來材料偏脆的缺點,為了改善BT 樹脂脆性的缺陷,起初使用技術員們使用環氧改性增韌,但這會或多或少的導致BT 樹脂體系Tg 降低。后來技術員發現使用烯丙基化合物改性BT 樹脂不僅可以改善BT 樹脂的韌性,同時還不會降低BT 樹脂體系的Tg。王*[14]采用二烯丙基雙酚A(DBA )為改性劑制備了改性BT 樹脂解決了由于氰酸酯及雙馬來酰亞胺(BMI)強結晶性以及BMI 高熔點不溶于丙酮等因素造成覆銅板加工工藝上的難題,同時經改性的BT樹脂制備的覆銅板具有較好的韌性和耐熱性、介電性能等。孫*[15]使用間苯二甲酸二烯丙酯(DAIP)作為改性劑對雙馬來酰亞胺三嗪(BT)樹脂進行改性,制備了一系列DAIP 改性BT樹脂并用改性BT 樹脂制備玻璃纖維布層壓復合材料,發現DAIP 的引入改善了BT 樹脂的粘性,提供Tg、降低介電常數;制備的玻纖布復合材料具有很好的力學性能、介電性能、熱性能和耐濕熱性能等。為增韌陳*[16]合成了一種烯丙基苯并惡嗪,并用其改性BT 樹脂,經固化后復合材料韌性得明顯改善。
3.3 低介電樹脂改性BT 樹脂復合封裝基板材料
BT 樹脂有結構對稱等特點分子極性較小,因而其具有較低的介電常數和介質損耗;但在一些高端高頻高速信號傳輸的封裝載板應用中BT 樹脂的介電性能就顯得有一點力不從心。聚苯醚樹脂(PPO)及碳氫樹脂是分子極性極低,具有非常低的介電常數(Dk:2.45)和介質損耗(Df:0.0007);同時聚苯醚的苯醚鍵結構具兼顧剛性又兼顧韌性,是一種BT 樹脂較佳的改性劑。張**[17]研制出了雙烯封端棒狀酰亞胺,另用PPO 改性BT 樹脂制得低介電常數的BT/玻璃布覆銅板其介電常數可小到3.6( 1MHz),厚度方向膨脹系數為4.07 *10-5/℃。劉*[18]采用PPO 改性BT 樹脂體系制備了介電常數為2.76( 1MHz) 損耗正切為0.0025(IMHz) 的改性體系; 且PPO 是以分散相形式存在于體系中;改性后的BT 樹脂其DMA曲線表現出Tg 現象; 電鏡結果表明改性BT 樹脂與玻璃纖維之間具有較好的界面粘結能力。
4 其他有機樹脂復合封裝基板材料
封裝基板材料對各項性能的需求越來越豐富,開發者們也在利用各種技術途徑來滿足封裝基板材料。為滿足封裝基材的導熱性能的需求,趙**[19]將經過改性的的氮化硼微粒(BN-CTAB)填充雙馬來酰亞胺-三嗪樹脂制備了BT/BN-CTAB 導熱絕緣復合材料,引入氮化硼微粒不僅提升了材料的導熱性能而且還提升了材料的耐熱性。為避開BT 樹脂的復雜預聚工藝,馮**[20]合成了一種新型聚酰亞胺樹脂體并在封裝基板中試用,在耐熱性和CTE 等級上都與外國開發產品持平。嚴**[21]以4,4 一二苯甲烷雙馬來酰亞胺、二氨基二苯甲烷、環氧樹脂為主要原料合成性能優良的改性聚酰亞胺樹脂體系;以此樹脂為基體,以芳酰胺無紡布為增強材料制作覆銅板;該板材具有玻璃化溫度高、熱膨脹系數小、介電常數低等優異的綜合性能,可滿足制作封裝用印制線路板技術要求。為制備較低CTE 的封裝基板,張**[22]采用低膨脹系數的BT 樹脂搭配石英玻纖布制備覆銅板,利用石英玻纖布的低膨脹系數及低的介電性能制備出介電性能優異、膨脹系數低的封裝基板材料。為滿足載板的超細布線及高密走線,日本味之素公司開發了一種改性環氧ABF 膜搭配超薄封裝基板制備了超薄高密度HDI 板,能實現超薄銅其表面高密度布線,解決了信號線路布線不足的問題。國內華正新材也開發一款類似性能的CBF 膜,并在各載板加工廠評估試用,取得了很好的效果。
5 展望
封裝基板材料多種多樣但它們的開發路徑都是圍繞著封裝基板發展趨勢要求進行,單一的材料很難滿足IC 封裝載板用基板需求;充分融合各功能材料的性能優勢制備出多功能的復合封裝基板材料將長時間是材料開發人員工作的重點。封裝基板材料的開發離不開下游客戶的支持,上下游聯動方能跟上這個快速更新的電子信息時代
歡迎掃碼添加小編微信

掃碼加入知識星球,領取公眾號資料

原文標題:IC 封裝載板用有機復合基板材料研究進展
文章出處:【微信公眾號:半導體封裝工程師之家】歡迎添加關注!文章轉載請注明出處。
-
封裝
+關注
關注
128文章
9249瀏覽量
148633
發布評論請先 登錄
IPC-6921有機封裝基板國際標準即將落地

基板效應下OLED有機薄膜的折射率梯度:光譜橢偏法的精確表征與分析

ATA-2031高壓放大器賦能復合材料板超聲無損探傷研究

銅基板抗壓測試不過,如何科學選擇材料?
銅基板成本貴在哪?五個關鍵因素解析
從氧化鋁到氮化鋁:陶瓷基板材料的變革與挑戰
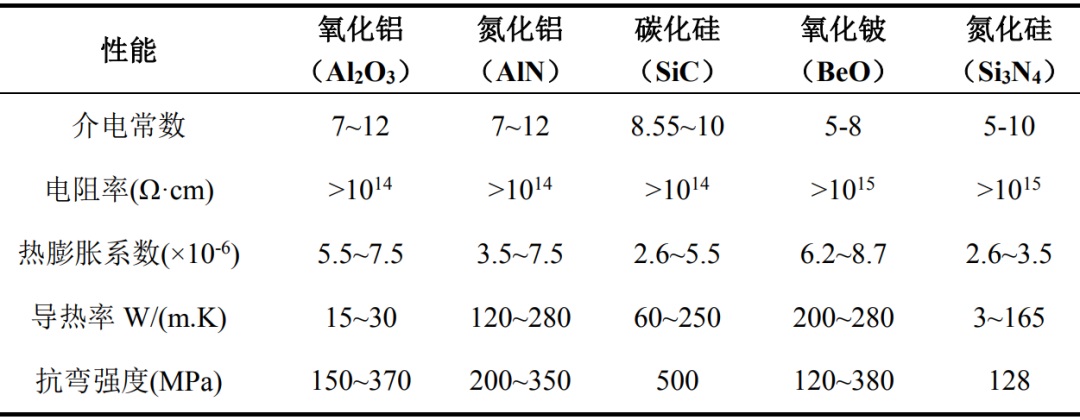
微雙重驅動的新型直線電機研究
扇出型封裝材料:技術突破與市場擴張的雙重奏
PEEK注塑電子封裝基板的創新應用方案
射頻系統先進封裝技術研究進展
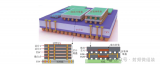
醫療PCB基板材質大揭秘:選錯材質可能致命!
如何解決PCB激光焊接時燒傷基板




 IC 封裝載板用有機復合基板材料研究進展
IC 封裝載板用有機復合基板材料研究進展






評論