共讀好書
劉文喆 陳道遠(yuǎn) 黃煒
(中國電子科技集團(tuán)公司)
摘要:
塑封器件具有體積小、成本低的優(yōu)點(diǎn),逐步替代氣密性封裝器件,廣泛地應(yīng)用于我國軍用產(chǎn)品中。軍用塑封SIP(System In Package)產(chǎn)品集成度高、結(jié)構(gòu)復(fù)雜、可靠性要求高等特點(diǎn),對塑封工藝帶來了挑戰(zhàn),目前國內(nèi)工業(yè)級塑封產(chǎn)品不能完全滿足軍用可靠性要求,工業(yè)級塑封產(chǎn)品常在嚴(yán)酷的環(huán)境應(yīng)力試驗(yàn)下表現(xiàn)出失效。本文針對工業(yè)級塑封 SIP 器件在可靠性試驗(yàn)過程中出現(xiàn)的失效現(xiàn)象進(jìn)行分析研究,通過超聲檢測、芯片切面分析等手段,結(jié)合產(chǎn)品應(yīng)力試驗(yàn)結(jié)果,分析導(dǎo)致塑封產(chǎn)品失效的關(guān)鍵原因,并針對失效機(jī)理提出優(yōu)化改進(jìn)方案。
引言
塑封器件具有體積小,重量輕,成本低,電性能指標(biāo)優(yōu)良等優(yōu)點(diǎn),在軍用電子元器件領(lǐng)域應(yīng)用日益廣泛[1] 。
塑封器件分層是其典型的故障模式,封裝材料熱膨脹系數(shù)的不同以及被粘接材料表面能低,是造成塑封電路分層的內(nèi)部原因。在塑封器件失效案例中因塑封分層導(dǎo)致的失效是比較隱蔽、不易被發(fā)現(xiàn)的,但其對塑封器件長期可靠性帶來了較大隱患,例如塑封器件分層后水汽進(jìn)入內(nèi)部,對芯片的鋁電極產(chǎn)生腐蝕,導(dǎo)致電極開路失效。
本文選取一款復(fù)雜結(jié)構(gòu)塑封 SIP(System In Pack-age)產(chǎn)品,其較常規(guī)塑封單片電路結(jié)構(gòu)更為復(fù)雜,內(nèi)部器件類型多樣、器件尺寸及高度不一致等因素對其塑封工藝帶來極大挑戰(zhàn)。本文采用多樣品多應(yīng)力條件試驗(yàn)驗(yàn)證的方式,分析影響塑封 SIP 繼承模塊封裝可靠性的關(guān)鍵環(huán)境因素,通過對環(huán)境進(jìn)行特殊的控制和工藝優(yōu)化可以解決塑封分層問題,為塑封器件的可靠應(yīng)用提供有效支撐。
1 產(chǎn)品簡介
該款塑封 SIP 集成模塊由 6 款芯片、3 款無源器件和有機(jī)基板組成,無源器件包括電阻、電容和磁珠,采用塑封工藝進(jìn)行封裝。其封裝結(jié)構(gòu)圖如圖 1 所示。

為達(dá)到軍用塑封產(chǎn)品可靠性指標(biāo),該款塑封 SIP 集成模塊產(chǎn)品需經(jīng)歷的可靠性環(huán)境試驗(yàn)包括溫度循環(huán)、預(yù)處理(烘焙、濕浸、回流焊、清洗、烘干等)、高溫貯存、強(qiáng)加速穩(wěn)態(tài)濕熱(H AST)。
2 失效原因分析
該產(chǎn)品經(jīng)歷烘焙(125 ℃,24 h)、濕浸(60 ℃,60 % RH ,40 h)、回流焊(3次)、溫度循環(huán)(-40 ℃/60 ℃,5 次)并常溫烘干后,分兩組分別進(jìn)行溫度循環(huán)(-55 ℃ /150 ℃,100 次)、強(qiáng)加速穩(wěn)態(tài)濕熱(H A ST)(130 ℃ /85 % RH ,96 h)試驗(yàn),試驗(yàn)后采用超聲檢測方法檢測塑封結(jié)構(gòu)變化情況。檢測結(jié)果顯示所有試驗(yàn)樣品均出現(xiàn)塑封分層現(xiàn)象,分層區(qū)域?yàn)?IC6 鍵合焊盤處,如圖 1、2 標(biāo)記處所示。
對故障件進(jìn)行 X 射線檢測,未發(fā)現(xiàn)明顯異常,形貌如圖 3 所示。因此,采用破壞性切片分析的手段,對超聲檢測不合格區(qū)域進(jìn)行定位,切片形貌可明顯觀察到基板上鍵合焊盤處與塑封料間存在分層,分層程度輕微,高度在 1 μm 以內(nèi),形貌如圖 4 所示。
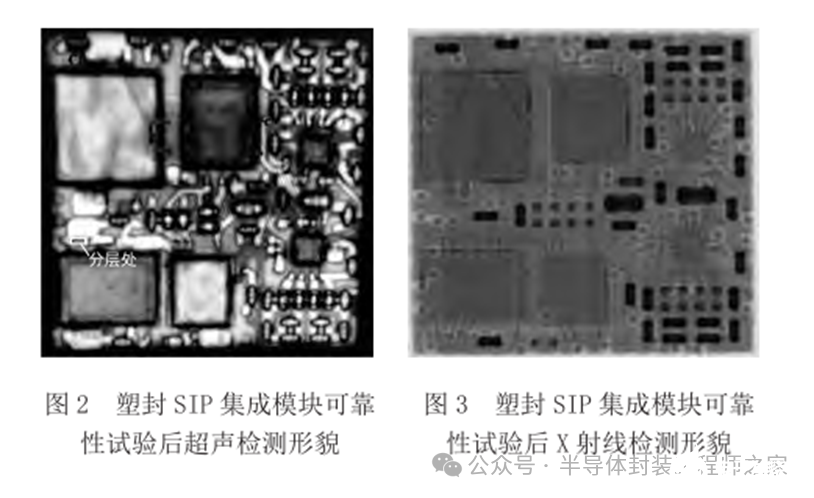

試驗(yàn)過程中產(chǎn)品經(jīng)歷一定的溫度、濕度影響,為評估影響塑封器件分層的關(guān)鍵因素,對該款塑封 SIP 集成模塊結(jié)構(gòu)設(shè)計(jì)、封裝工藝、經(jīng)歷應(yīng)力條件進(jìn)行分析排查。
2.1 結(jié)構(gòu)設(shè)計(jì)
該款塑封 SIP 集成模塊外形尺寸為 10 m m ×10 m m×1.8 m m ,選用QFN48塑封封裝實(shí)現(xiàn),采用6層有機(jī)基板,芯片與基板的互聯(lián)采用 25 μm 金絲球焊,實(shí)現(xiàn)內(nèi)部各個器件的連接和信號扇出。
分層處焊盤上 5 個鍵合點(diǎn)屬于同一電源網(wǎng)絡(luò),焊盤設(shè)計(jì)時按照區(qū)域方式設(shè)計(jì),區(qū)域?qū)挾葹?1.5 m m *0.2 m m ,如圖 1 標(biāo)記處所示,為該模塊中面積最大的焊盤。該區(qū)域焊盤塑封料與鍵合區(qū)域間的接觸面較大,焊盤接觸面材料為 Au 較為光滑,易形成空洞,與塑封料間附著力減小,引起接觸面塑封分層,且金屬與塑封料之間的界面面積越大,分層的可能性越大。
該款結(jié)構(gòu)設(shè)計(jì)焊盤面積偏大,與塑封料界面處存在一定分層的風(fēng)險(xiǎn)。
2.2 封裝工藝
該款塑封 SIP 集成模塊選用 SUM ITOM O G760L 塑封料進(jìn)行封裝,該塑封料為行業(yè)內(nèi)主流材料。基板選用M GC 材料基板,該基板材料成熟,為通用大批量基板材料。
在材料選型及封裝過程控制上不存在風(fēng)險(xiǎn)。
2.3 應(yīng)力條件分析
為判斷預(yù)處理中濕浸試驗(yàn)(濕度應(yīng)力)、回流焊試驗(yàn)(溫度應(yīng)力)、溫度循環(huán)(溫度應(yīng)力)、強(qiáng)加速穩(wěn)態(tài)濕熱(溫濕度應(yīng)力) [2] 分別對該款塑封 SIP 集成模塊超聲檢測分層的影響,選取合格樣品,分組進(jìn)行可靠性評估試驗(yàn),每分組 5 只樣品,試驗(yàn)條件及結(jié)果如表 1所示。
上述試驗(yàn)結(jié)果顯示,第2分組試驗(yàn)條件不進(jìn)行濕浸,烘焙后直接投入回流焊,隨后進(jìn)行超聲檢測,檢測結(jié)果顯示超聲無分層情況,表明分層主要受濕浸試驗(yàn)影響,塑封材料吸附了水汽,在回流焊過程中受高溫影響,水汽加速釋放,導(dǎo)致塑封料與金屬接觸面分層。
3 失效機(jī)理分析
塑封器件是以樹脂類聚合物為材料封裝的器件,由于塑封料與焊盤及基板材料的熱膨脹系數(shù)不完全一致,熱應(yīng)力作用下塑封器件內(nèi)不同材料的連接處會產(chǎn)生應(yīng)力集中,應(yīng)力水平超過其中任何一種封裝材料的屈服強(qiáng)度或斷裂強(qiáng)度導(dǎo)致器件分層;同時,樹脂類材料本身并非致密具有吸附水汽的特性,封裝體與引線框架的粘接界面等處也會引入濕氣進(jìn)入塑封器件,塑封器件中水汽含量過高時會引起塑封料與基板界面上的樹脂離解,即溫度、濕度應(yīng)力會導(dǎo)致塑封器件分層。
4 糾正措施建議
為避免較大面積焊盤經(jīng)歷環(huán)境試驗(yàn)后出現(xiàn)的塑封器件分層情況,建議改進(jìn)焊盤設(shè)計(jì),將原區(qū)域化設(shè)計(jì)焊盤(圖5(a))優(yōu)化為單個焊盤設(shè)計(jì)(圖 5(b)),優(yōu)化后單個焊盤尺寸為 0.15 m m ×0.1 m m ,由該款塑封 SIP 集成模塊中其余較小面積焊盤試驗(yàn)后均無分層情況可以判斷,該優(yōu)化方案可行。
結(jié)合本次產(chǎn)品失效情況,提出如下塑封產(chǎn)品結(jié)構(gòu)可靠性設(shè)計(jì)注意事項(xiàng):
塑封器件分層不僅與塑封原材料選擇、工藝控制相關(guān),與器件結(jié)構(gòu)設(shè)計(jì)也息息相關(guān)。在高可靠性塑封產(chǎn)品結(jié)構(gòu)設(shè)計(jì)時,考慮產(chǎn)品電性能基礎(chǔ)上,需加強(qiáng)可靠性設(shè)計(jì),盡量避免使用較大面積整體區(qū)域化焊盤設(shè)計(jì)。當(dāng)塑封料附著于較大面積整體區(qū)域化焊盤時,粘接力下降,經(jīng)歷溫、濕度應(yīng)力試驗(yàn)后易出現(xiàn)輕微分層形貌,對產(chǎn)品長期使用可靠性產(chǎn)生影響。

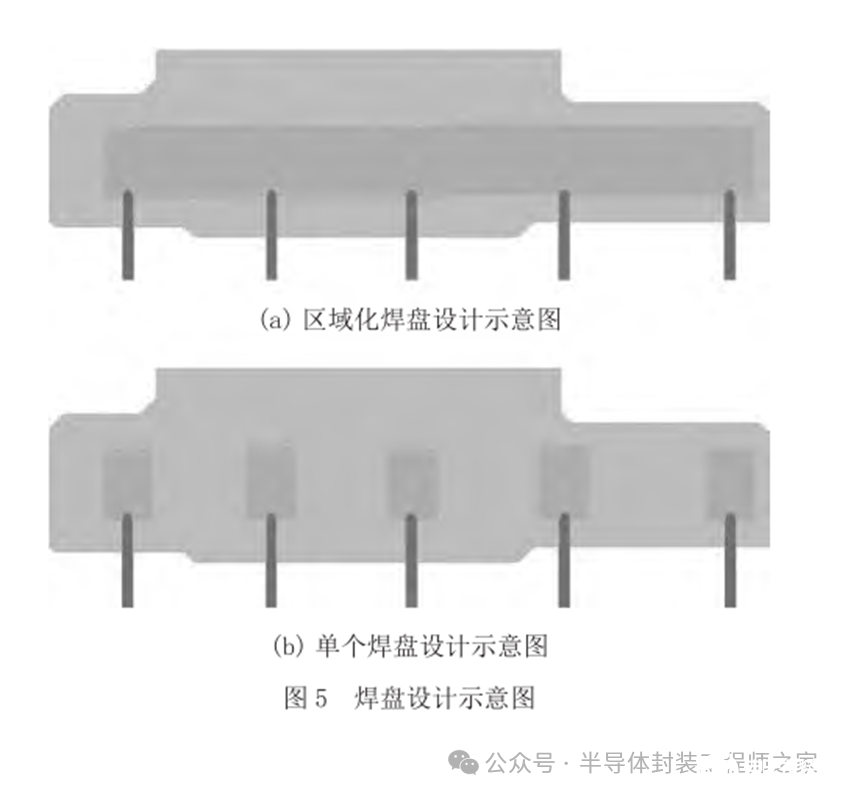
5 結(jié)論
面對復(fù)雜結(jié)構(gòu)的塑封模塊產(chǎn)品設(shè)計(jì),其可靠性與塑封原材料選擇、工藝控制、器件結(jié)構(gòu)設(shè)計(jì)均相關(guān)[3] ,較大面積區(qū)域設(shè)計(jì)將降低產(chǎn)品可靠性,在經(jīng)歷一定溫度、濕度應(yīng)力試驗(yàn)后表現(xiàn)出分層,甚至直接引起產(chǎn)品失效。在高可靠性產(chǎn)品結(jié)構(gòu)設(shè)計(jì)時,需考慮結(jié)構(gòu)設(shè)計(jì)的可靠性。
審核編輯 黃宇
-
SiP
+關(guān)注
關(guān)注
5文章
540瀏覽量
107732 -
封裝
+關(guān)注
關(guān)注
128文章
9249瀏覽量
148627 -
集成模塊
+關(guān)注
關(guān)注
0文章
52瀏覽量
12732
發(fā)布評論請先 登錄
什么是高可靠性?
MUN12AD03-SEC電源模塊性能、成本、可靠性三大優(yōu)勢
極端環(huán)境振動位移傳感器的可靠性分析與提升策略
集成電路可靠性介紹

【海翔科技】玻璃晶圓 TTV 厚度對 3D 集成封裝可靠性的影響評估

深入解析與使用感受:Isograph、Medini與REANA可靠性分析軟件對比

提升功率半導(dǎo)體可靠性:推拉力測試機(jī)在封裝工藝優(yōu)化中的應(yīng)用

網(wǎng)課回放 I 升級版“一站式” PCB 設(shè)計(jì)第三期:原理圖完整性及可靠性分析

提供半導(dǎo)體工藝可靠性測試-WLR晶圓可靠性測試
電機(jī)微機(jī)控制系統(tǒng)可靠性分析
IGBT的應(yīng)用可靠性與失效分析

聚焦塑封集成電路:焊錫污染如何成為可靠性“絆腳石”?

從IGBT模塊大規(guī)模失效爆雷看國產(chǎn)SiC模塊可靠性實(shí)驗(yàn)的重要性
IGBT模塊封裝:高效散熱,可靠性再升級!




 塑封SIP集成模塊封裝可靠性分析
塑封SIP集成模塊封裝可靠性分析





評論