共讀好書
A、內涵
封裝——Package,使用要求的材料,將設計電路按照特定的輸入輸出端進行安裝、連接、固定、灌封、標識的工藝技術。

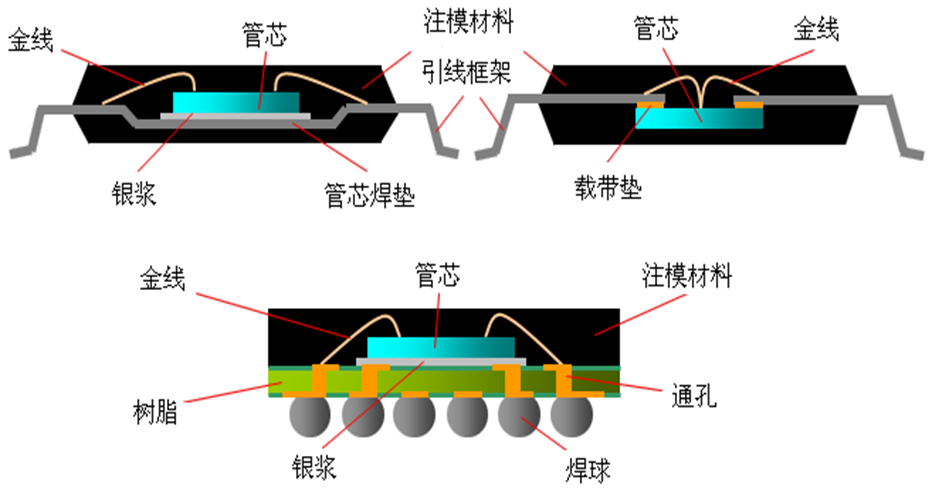
B、作用
a)保護:保障電路工作環境與外界隔離,具有防潮、防塵。
b)支撐:引出端及殼體在組裝和焊接過程保持距離和緩沖應力作用。
c)散熱:電路工作時的熱量施放。
d)電絕緣:保障不與其他元件或電路單元的電氣干涉。
e)過渡:電路物理尺寸的轉換。

a)晶圓裸芯片b)集成電路芯片c)板級電路模塊PCBA d)板級互連
e)整機f)系統
電子封裝技術發展歷程
20世紀50 年代以前是玻璃殼真空電子管
20世紀60 年代是金屬殼封裝的半導體三極管
20世紀70 年代封裝是陶瓷扁平、雙列直插封裝小規模數字邏輯電路器件出現
20世紀70 年代末表面貼裝技術SMT出現,分立元件片式化(玻璃)
20世紀80 年代 LSI出現,表面貼裝器件SMD問世,陶瓷、塑料SOP、PLCC、QFP呈現多樣化狀況
20世紀90 年代VLSI出現,MCM技術迅速發展,超高規模路小型化、多引腳封裝趨勢,塑料封裝開始占據主流,片式元件達到0201、BGA、CSP大量應用
21世紀始,多端子、窄節距、高密度封裝成為主流,片式元件達到01005尺寸,三維、光電集成封裝技術成為研究開發的重點
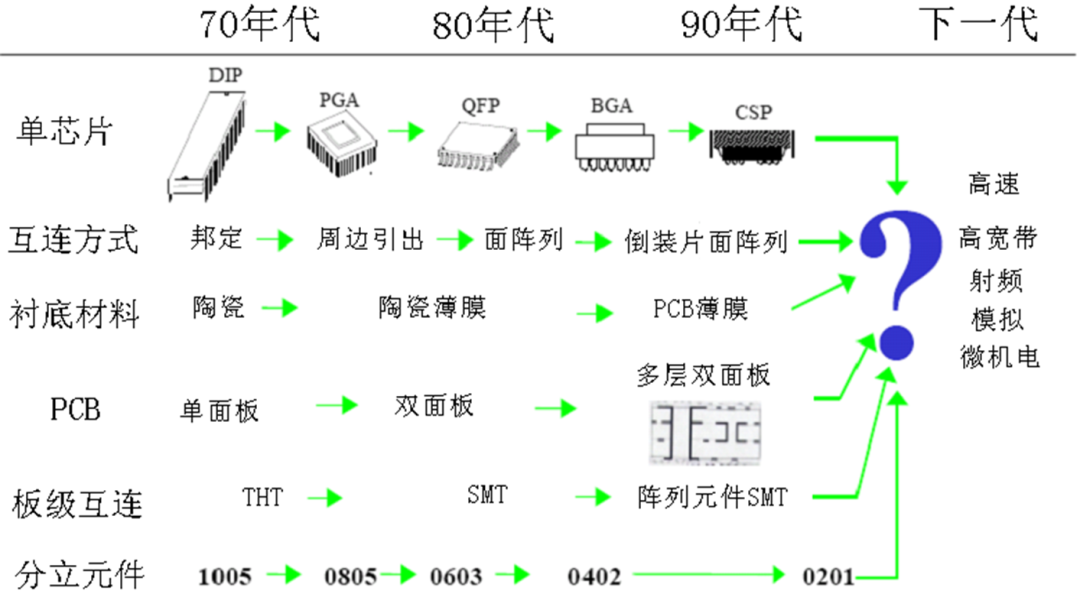
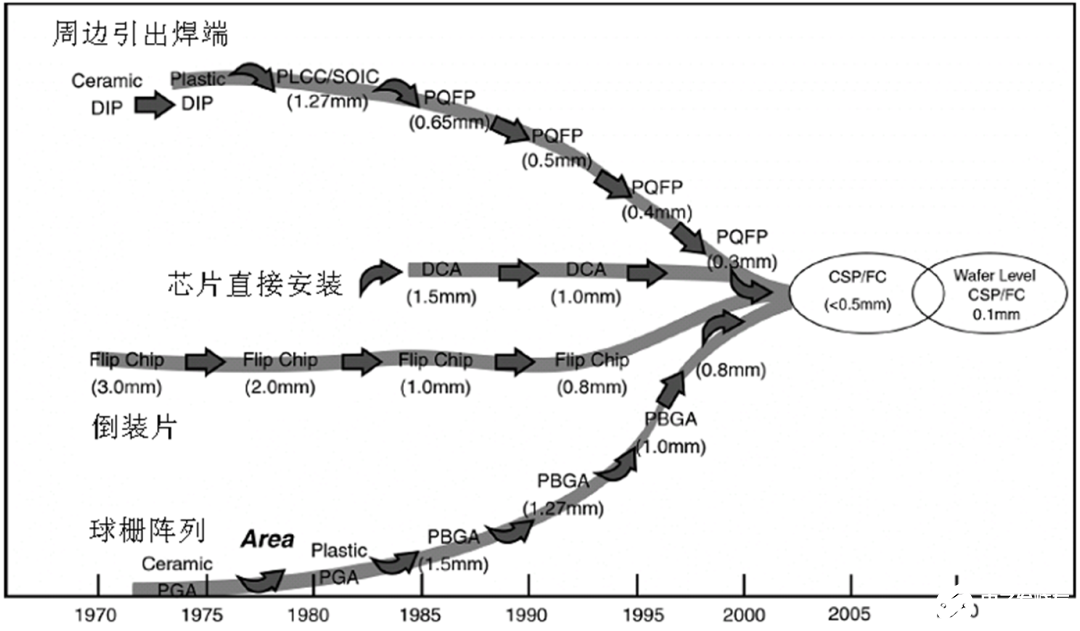
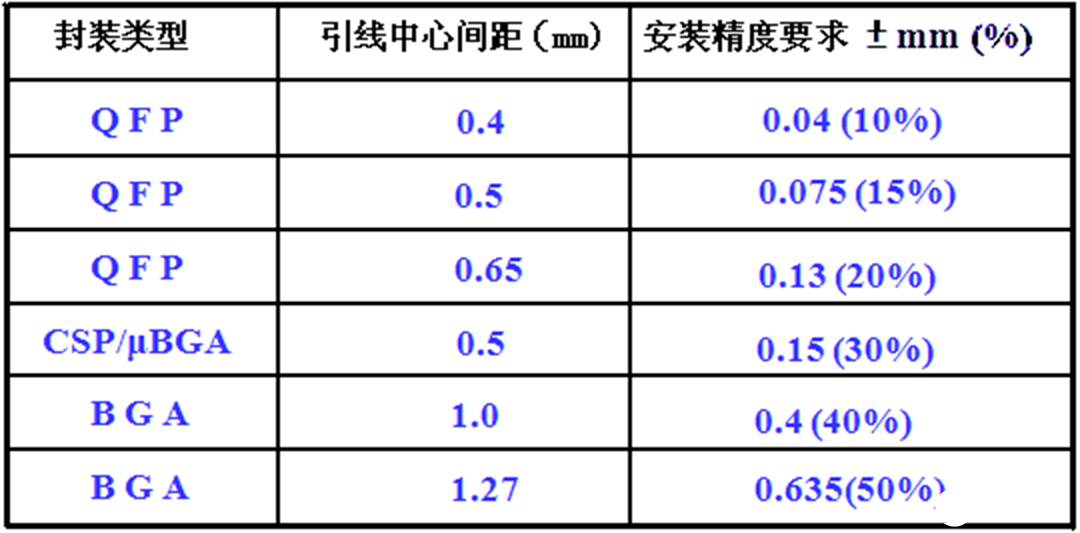
器件封裝引線中心間距變化對工藝裝備的精度要求
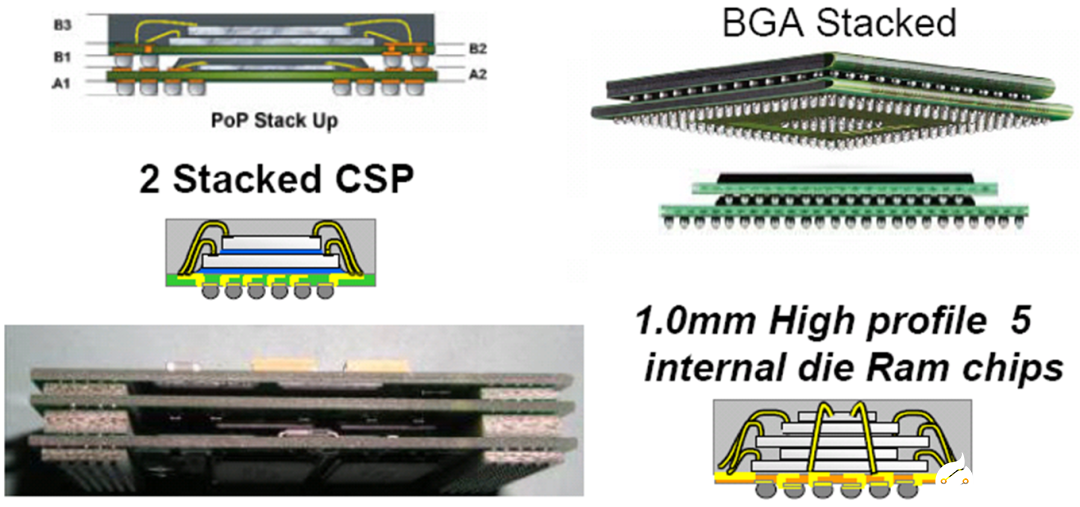
三維疊層元器件封裝
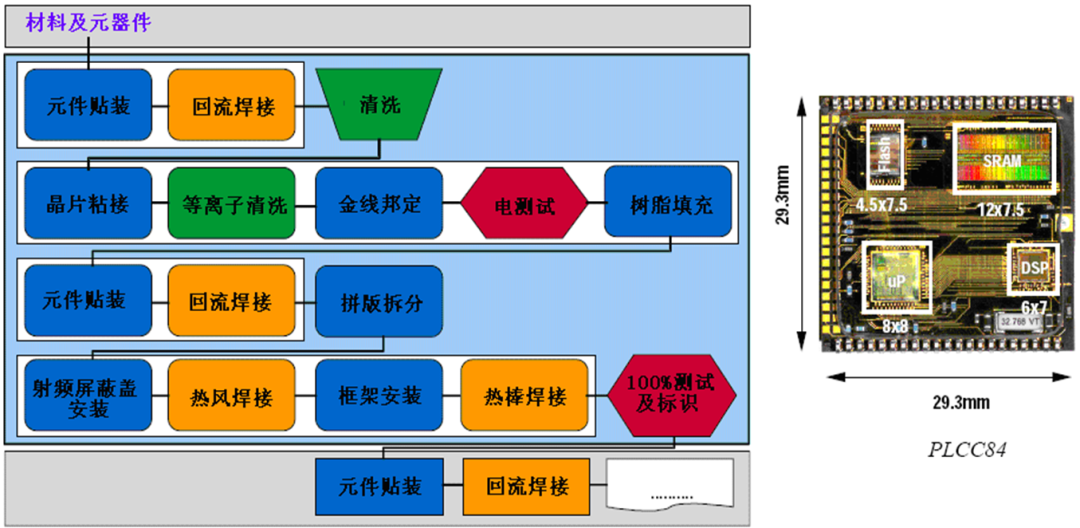
多芯片組件封裝與組裝工藝技術應用
C、發展趨勢
高密度、細間距、超細間距PCB
三維立體互連,應用于晶圓級、元件級和板級電路
光電混和互連。
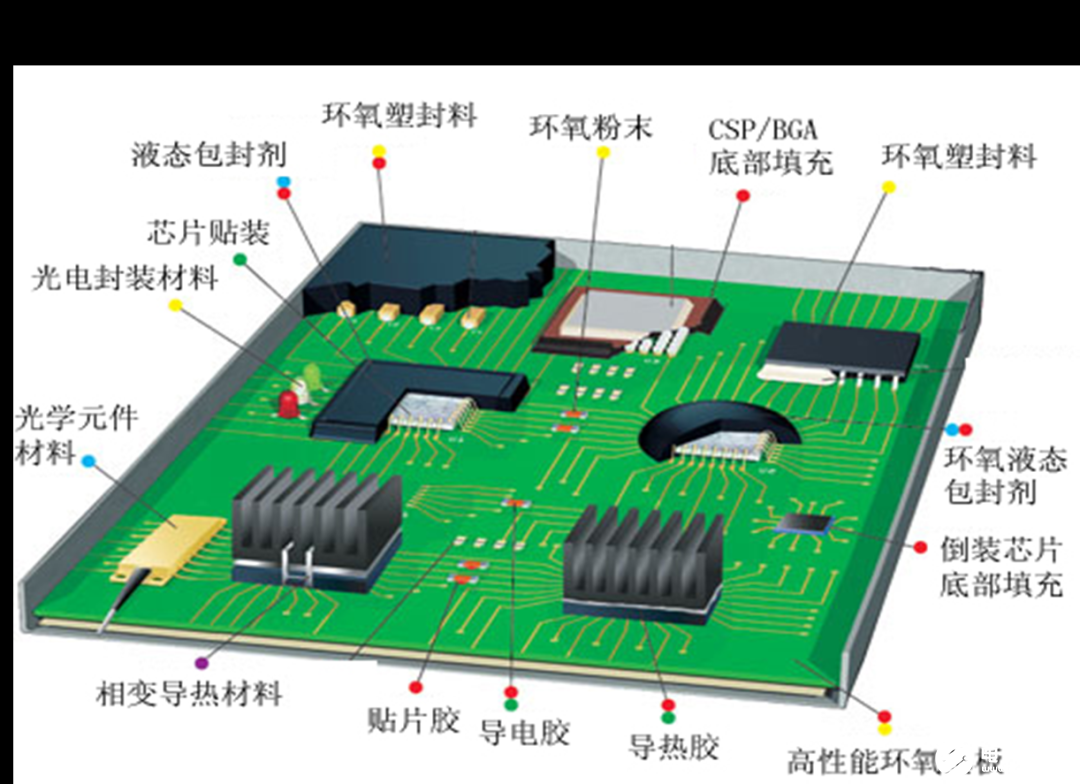
1)封裝材料
A、基本要求
封裝材料具有如下特性要求:
熱膨脹系數:與襯底、電路芯片的熱膨脹性能相匹配。
介電特性(常數及損耗):快速響應電路工作,電信號傳輸延遲小。
導熱性:利于電路工作的熱量施放。
機械特性:具有一定的強度、硬度和韌性。
B、材料應用類別
a)金屬:銅、鋁、鋼、鎢、鎳、可伐合金等,多用于宇航及軍品元器件管殼。
b)陶瓷:氧化鋁、碳化硅、氧化鈹、玻璃陶瓷、鉆石等材料均有應用,具有較好的氣密性、電傳輸、熱傳導、機械特性,可靠性高。不僅可作為封裝材料,也多用于基板,但脆性高易受損。
雙列直插(DIP)、扁平(FP)、無引線芯片載體(LCCC)、QFP等器件均可為陶瓷封裝。



c)塑料:
通常分為熱固性聚合物和熱塑性聚合物,如酚醛樹脂、環氧樹脂、硅膠等,采用一定的成型技術(轉移、噴射、預成型)進行封裝,當前90%以上元器件均已為塑料封裝。
始用于小外形(SOT)三極管、雙列直插(DIP),現常見的SOP、PLCC、QFP、BGA等大多為塑料封裝的了。器件的引線中心間距從2.54mm(DIP)降至0.4mm(QFP)
厚度從3.6 mm(DIP)降至1.0mm(QFP),引出端數量高達350多。
d)玻璃:

審核編輯 黃宇
-
電子元器件
+關注
關注
134文章
3895瀏覽量
113937 -
封裝
+關注
關注
128文章
9249瀏覽量
148628
發布評論請先 登錄
羅徹斯特電子為客戶提供廠內BGA封裝元器件重新植球服務
老年份的電子元器件是否可買
助力材料技術新發展!Aigtek安泰電子電子元器件關鍵材料會議高光回顧




 電子元器件封裝技術講解,精選好文!
電子元器件封裝技術講解,精選好文!








評論