上一章講到了IGBT的飽和電流,與MOS的飽和電流之間存在 的倍數關系,這使得IGBT飽和電流比MOS大很多。同時,增益
的倍數關系,這使得IGBT飽和電流比MOS大很多。同時,增益 是隨BJT集電極和發射極之間的電壓(
是隨BJT集電極和發射極之間的電壓( )變化而變化的,因此飽和電流也會隨電壓(
)變化而變化的,因此飽和電流也會隨電壓( )變化而變化。回顧“IGBT的若干PN結”一章中關于PNP增益的討論,
)變化而變化。回顧“IGBT的若干PN結”一章中關于PNP增益的討論, 。這里我們簡化分析過程,假設注入效率
。這里我們簡化分析過程,假設注入效率 ,即
,即 。
。 的表達式為:
的表達式為:

其中, 為非耗盡區寬度,
為非耗盡區寬度, 為雙極型載流子擴散長度。
為雙極型載流子擴散長度。

顯然,隨著 的增長,耗盡區會擴展,相應非耗盡區寬度
的增長,耗盡區會擴展,相應非耗盡區寬度 會減小,
會減小, 就會增大,IGBT的飽和電流也會隨之增大。回顧“IGBT的若干PN結”一章中關于PN結的討論,耗盡區寬度與外加電壓
就會增大,IGBT的飽和電流也會隨之增大。回顧“IGBT的若干PN結”一章中關于PN結的討論,耗盡區寬度與外加電壓 的關系如下:
的關系如下:

因為p-base濃度遠高于n-drift區域的濃度,因此耗盡區將主要集中于n-drift區域。忽略分子括號中的 ,假設芯片厚度為
,假設芯片厚度為 ,并將
,并將 替換成
替換成 ,那么就可以得到
,那么就可以得到 與
與 之間的關系如下:
之間的關系如下:

將 代入飽和電流的表達式,如下:
代入飽和電流的表達式,如下:

之所以要整理這個表達式,原因在于電阻是電壓與電流之比,所以必須找到增益 與電壓
與電壓 之間的關系,利用非耗盡區寬度可以建立起兩者之間的聯系。根據上述表達式,并假設IGBT飽和之后的電阻為
之間的關系,利用非耗盡區寬度可以建立起兩者之間的聯系。根據上述表達式,并假設IGBT飽和之后的電阻為 ,那么
,那么

將 表達式帶入上式,就可得到IGBT電阻
表達式帶入上式,就可得到IGBT電阻 與電壓
與電壓 之間的關系,如下:
之間的關系,如下:

該表達式略顯繁瑣,但推導過程并不難,感興趣的讀者可以嘗試自行推導一下。下面我們看一個實際案例,了解IGBT飽和電流之后的增益、體電阻隨電壓 的變化趨勢。
的變化趨勢。
舉例:假設IGBT芯片厚度120μm,元胞周期5μm,溝道深度3μm,柵氧厚度120nm,溝道載流子壽命10微秒,溝道電子遷移率 ,閾值電壓為5V,柵極施加電壓為15V。計算非耗盡區寬度、增益以及體電阻隨
,閾值電壓為5V,柵極施加電壓為15V。計算非耗盡區寬度、增益以及體電阻隨 的變化趨勢如下面三個圖所示。可以看出來,隨著
的變化趨勢如下面三個圖所示。可以看出來,隨著 從50V升高至500V,非耗盡區寬度從約90
從50V升高至500V,非耗盡區寬度從約90 減小到近30
減小到近30 ,相應的BJT增益從約0.15增大至超過0.7,電阻也減小了近10倍。所以,對于MOS器件來說,IGBT飽和電流隨
,相應的BJT增益從約0.15增大至超過0.7,電阻也減小了近10倍。所以,對于MOS器件來說,IGBT飽和電流隨 的變化要比MOS器件更明顯。
的變化要比MOS器件更明顯。
需要注意的是,隨著 電壓的增加,MOS溝道兩端所承受的電壓也會增加,回顧“IGBT中的MOS結構”一章,這會導致溝道縮短,這也會進一步地導致飽和電流值增大。
電壓的增加,MOS溝道兩端所承受的電壓也會增加,回顧“IGBT中的MOS結構”一章,這會導致溝道縮短,這也會進一步地導致飽和電流值增大。



-
IGBT
+關注
關注
1288文章
4331瀏覽量
263014 -
MOS
+關注
關注
32文章
1741瀏覽量
100720 -
BJT
+關注
關注
0文章
238瀏覽量
19227 -
電流電壓
+關注
關注
0文章
212瀏覽量
12421 -
飽和電流
+關注
關注
1文章
26瀏覽量
3148
發布評論請先 登錄
IGBT的物理結構模型—PIN&MOS模型(3)

高壓MOSFET與IGBT SPICE模型
無紋波控制系統仿真結構模型
IPTV的系統結構模型




 IGBT的物理結構模型—BJT&MOS模型(2)
IGBT的物理結構模型—BJT&MOS模型(2)

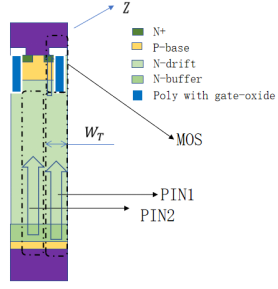
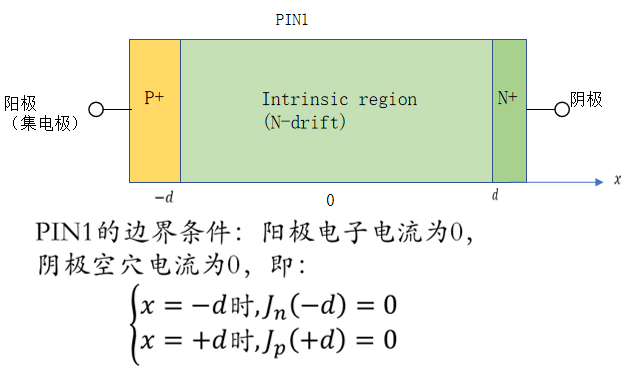
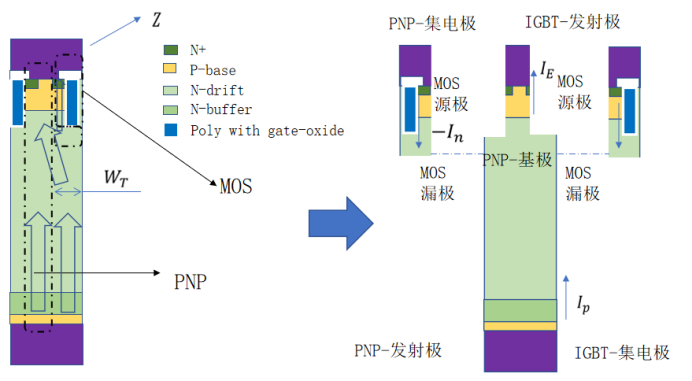




評論