一、案例背景
球柵陣列封裝(英語:BGA、Ball Grid Array,以下簡稱BGA)技術(shù)為應(yīng)用在集成電路上的一種表面黏著封裝技術(shù),此技術(shù)常用來永久固定如微處理器之類的的裝置。
BGA焊接失效問題往往直接關(guān)系到器件的質(zhì)量。基于此,下文針對BGA焊接出現(xiàn)開裂問題作出了分析。
二、分析過程
1.外觀分析
說明:一焊點(左)整體開裂(如放大圖所示),另一焊點無異常(右),且二者都呈現(xiàn)向內(nèi)扭偏的狀態(tài)。
2.SEM分析
說明:由于芯片PAD與PCB 焊盤未中心對齊,整體焊球向內(nèi)扭偏。
失效NG焊點
針對失效焊點的斷面SEM分析,開裂焊點局部圖示如下:
說明:開裂焊點特征是從IMC層開裂,開裂面有契合齒紋,斷面平整。Ni層狀態(tài)良好,無腐蝕異常。
良好OK焊點
針對良好焊點的斷面SEM分析,焊點局部圖示如下:
說明:未開裂焊點特征是IMC厚度主要在1μm左右,呈現(xiàn)晶枝狀特征,符合客戶提供標準要求。
3.成分分析
圖譜1:IMC
圖譜2:Ni層
說明:對焊點IMC層的成分分析表明其成分主要為Ni、Cu、Sn,含量比正常。Ni層P含量6.28%,在正常范圍內(nèi)。
三、分析結(jié)果
從上述檢測分析結(jié)果判斷, BGA有形成IMC層,焊點斷口平齊,在1.65μm左右,且有契合齒特征,因此可推斷焊點應(yīng)是在成型后,受到外部應(yīng)力的作用,導致IMC整體脆斷。同時應(yīng)力點集中于FPC焊盤側(cè),表明應(yīng)力可能是由FPC側(cè)傳導而來。
注:由于送樣切片樣品(僅兩個焊點)只能顯示一個剖面的狀態(tài),焊點受到何種應(yīng)力作用需要從原始外觀或者整體斷面上分析斷裂痕跡。
新陽檢測中心有話說:
本篇文章介紹了BGA焊接開裂失效的分析案例。如需轉(zhuǎn)載本篇文章,后臺私信獲取授權(quán)即可。若未經(jīng)授權(quán)轉(zhuǎn)載,我們將依法維護法定權(quán)利。原創(chuàng)不易,感謝支持!
新陽檢測中心將繼續(xù)分享關(guān)于PCB/PCBA、汽車電子及相關(guān)電子元器件失效分析、可靠性評價、真?zhèn)舞b別等方面的專業(yè)知識,點擊關(guān)注獲取更多知識分享與資訊信息。
最后,如您有相關(guān)檢測需求,歡迎咨詢。
審核編輯:湯梓紅
-
封裝
+關(guān)注
關(guān)注
128文章
9254瀏覽量
148677 -
焊接
+關(guān)注
關(guān)注
38文章
3564瀏覽量
63250 -
BGA
+關(guān)注
關(guān)注
5文章
584瀏覽量
51567
發(fā)布評論請先 登錄
LED失效分析方法與應(yīng)用實踐

LED失效原因分析與改進建議

漢思新材料:底部填充膠可靠性不足如開裂脫落原因分析及解決方案

芯片失效步驟及其失效難題分析!

LED失效的典型機理分析
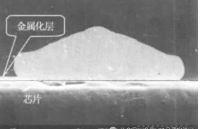
BGA失效分析原因-PCB機械應(yīng)力是罪魁禍首

PCBA 工程師必看!BGA 焊接質(zhì)量如何決定整塊電路板的 “生死”?
X-Ray檢測助力BGA焊接質(zhì)量全面評估
從捷多邦案例看X-Ray檢測在BGA焊接評估中的作用
電子元器件失效分析與典型案例(全彩版)
BGA焊盤設(shè)計與布線




 BGA焊接開裂失效分析案例
BGA焊接開裂失效分析案例

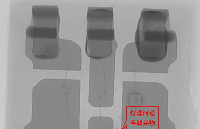




評論