各種拓撲結構中 SiC MOSFET 的出現帶來了巨大的性能和效率改進。但是,如果使用不當,工程師很快就會發現自己對設備故障感到沮喪。與客戶的看法形成鮮明對比,這些故障通常不是 SiC MOSFET 技術的內在弱點,而是圍繞柵極環路的設計選擇。尤其是對高端和低端器件之間的開啟交互缺乏關注可能會導致由錯誤的電路選擇引發的災難性故障。在本文中,我們展示了在柵極電路環路中使用柵極源極電容器的經典阻尼效果是 SiC MOSFET 柵極的巨大危險和經常隱藏的殺手。這種抑制門上振蕩的做法,為了改善開關瞬變實際上會導致柵極上的重應力。通過測量不容易看到這種應力,因為它們發生在內部柵極節點而不是外部可測量節點上,這要歸功于 CGS,似乎很好地抑制了。此外,我們還討論了必須關注 SiC MOSFET 體二極管的問題。對 SiC MOSFET 的體二極管存在許多誤解,以至于即使是資深技術專家有時也認為該體二極管是無反向恢復的。事實上,我們表明 SiC MOSFET 的體二極管,尤其是平面柵極器件,可能是造成柵極損壞的罪魁禍首。
為什么需要關注 SiC MOSFET 柵極?盡管具有傳統的 SiO 2柵極氧化物,但該氧化物的性能比傳統 Si 基半導體中的經典 Si-SiO 2界面更差。這是由于在SiC 的 Si 終止面上生長的 SiO 2界面處的本征缺陷。這使得氧化物更容易受到過電壓和其他電應力的影響,相對于基于硅的器件,V GSMax相當大。
圖 1 顯示了 SiC MOSFE 的活潑體二極管,小 Q RR和短 t rr可能難以測量,并且經常與測試系統寄生電容混淆。然而,在 I RR返回支路中可能出現>40 A/ns 的 di/dt 。這種超快 IRR 事件可以將設備本身的 V GS拉高超過伏特,并在每個開啟周期中造成嚴重的過應力。產生的超調量與 I RR速度成正比;最終,這種持續的壓力將導致災難性的失敗。

圖 1:反向恢復電流 SiC MOSFET
除了啟用門上的過應力外,禁用的門也會受到影響。如果V GS >V th,I D開始流入禁用設備。直通電流將導致諧振回路的進一步激勵,并且可能發生具有直通電流的自持振蕩。如圖 2 所示。

圖2:在碳化硅MOSFET的開關瞬態:V DD = 720V,我d = 20A,T c ^ = 175℃,R G ^ =10Ω,C GS = 10nF的
通常,設計人員會嘗試通過添加外部 C GS電容器來減輕這些振蕩影響(影響見圖 2)。這個電容器可以方便地抑制振蕩,似乎解決了這個問題,或者看起來是這樣。所監督的是這樣一個事實,即阻尼和由此產生的干凈的示波器圖像類似于真實門外的事件,設計師在現實中所做的事情正在惡化對真實門的影響。外部 C GS建立了一個額外的諧振槽,并惡化了快速 I RR瞬變(回彈)對柵極的影響。使用物理的、可擴展的 SPICE 模型,人們可以研究這些難以探測的效應,并且很快就會注意到 C GS電容器。圖 3 顯示了仿真原理圖,圖 4 顯示了結果結果,顯示了由快速 IRR 和添加的阻尼電容器的相互作用導致的 V GS上的 7 V 過應力。

圖 3:仿真示意圖
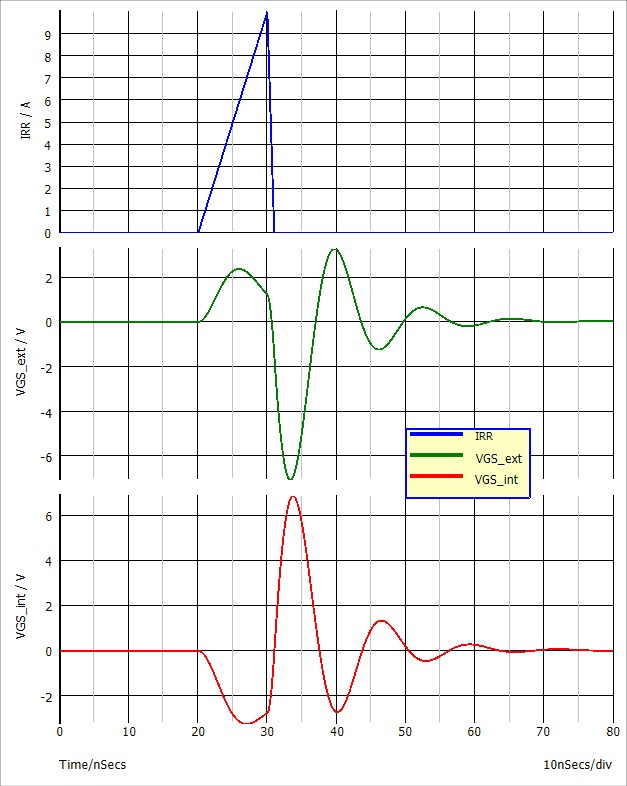
圖 4:仿真分析
使用 SiC MOSFET 成功實現高速開關的關鍵是適當調整柵極電路和所用器件的驅動條件,仔細閱讀數據表將很快發現當前器件內部 RG 的快速范圍。此外,移除外部 C GS電容器,設置正確的外部柵極電阻 R G,并使用具有源極檢測的封裝(TO-247-4L、D 2 PAK-7L 或類似),搭配正確的柵極回路設計將產生最好的切換。提供超過 120 V/ns 和 6 A/ns 的瞬變(采用同類最佳的 MOSFET),前提是回路的其余部分寄生電感得到處理。
審核編輯:劉清
-
電容器
+關注
關注
64文章
6958瀏覽量
107755 -
二極管
+關注
關注
149文章
10410瀏覽量
178453 -
MOSFET
+關注
關注
151文章
9674瀏覽量
233547 -
SiC
+關注
關注
32文章
3721瀏覽量
69409
發布評論請先 登錄
UCC5871-Q1:汽車應用中IGBT/SiC MOSFET的理想柵極驅動器
UCC5870-Q1:汽車應用中的高性能隔離式IGBT/SiC MOSFET柵極驅動器
用于SiC MOSFET的帶可配置浮動雙極性輔助電源的隔離柵極驅動IC
為什么MOSFET柵極前面要加一個100Ω電阻
傾佳電子功率半導體驅動電路設計深度解析:SiC MOSFET驅動挑戰與可靠性實現
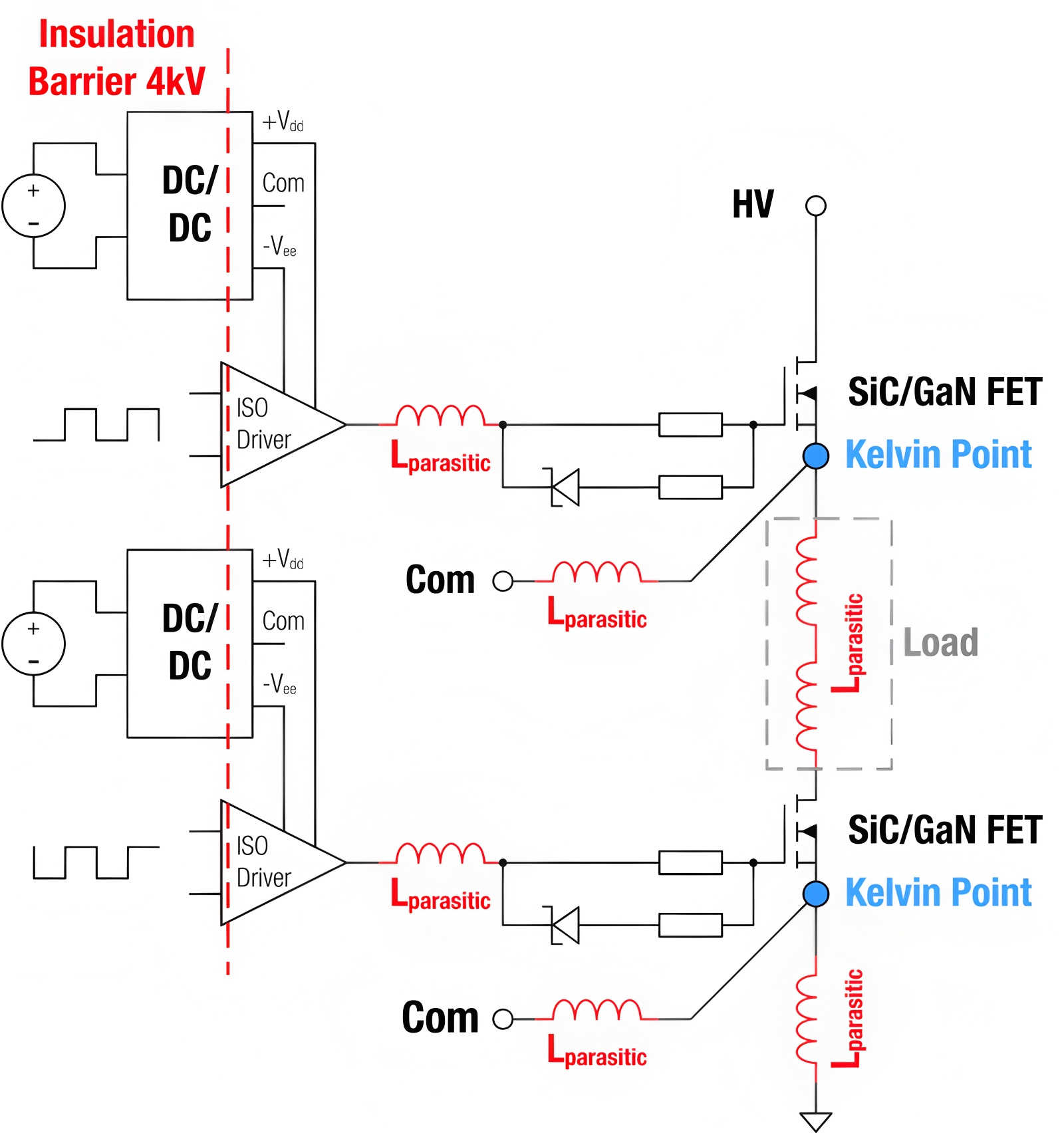
UCC21737-Q1 汽車級SiC/IGBT隔離柵極驅動器技術解析
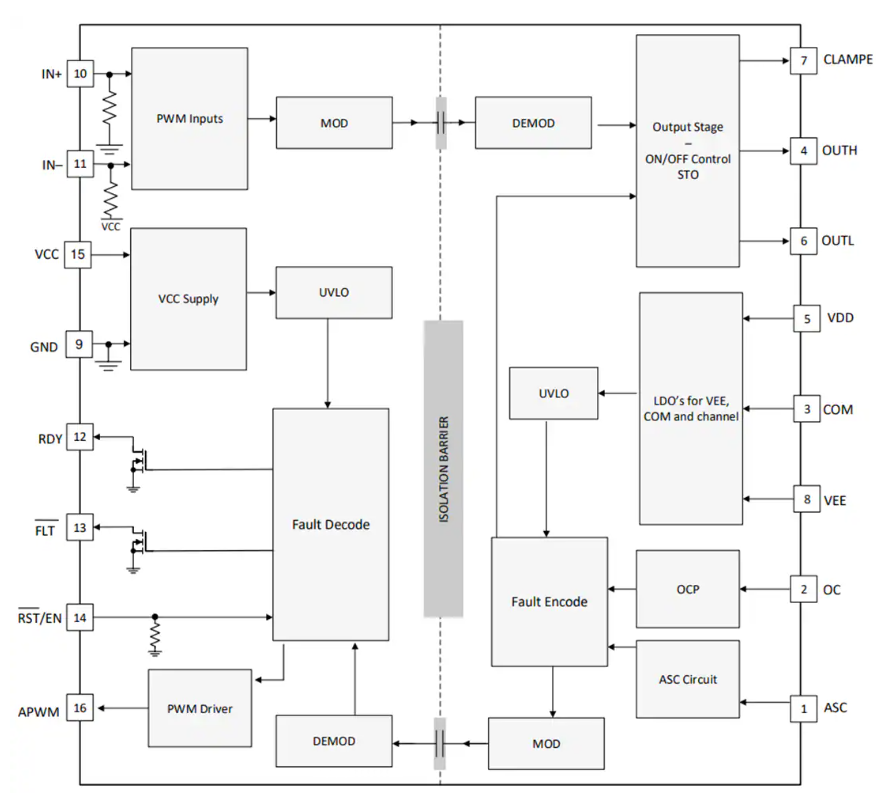
UCC21755-Q1汽車級SiC/IGBT柵極驅動器技術解析
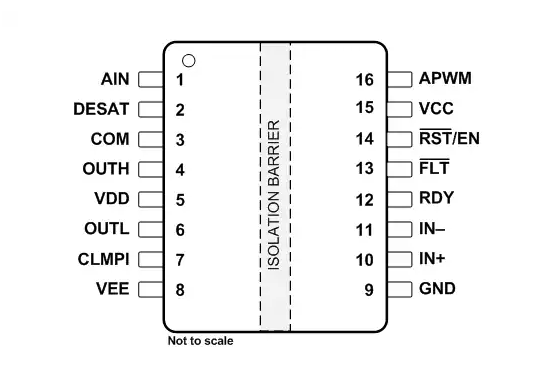
Littelfuse非對稱TVS二極管在SiC MOSFET柵極驅動器中的應用




 如何消除SiC MOSFET——柵極電路設計中的錯誤及其對穩健性的影響
如何消除SiC MOSFET——柵極電路設計中的錯誤及其對穩健性的影響

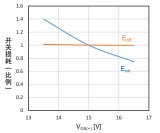

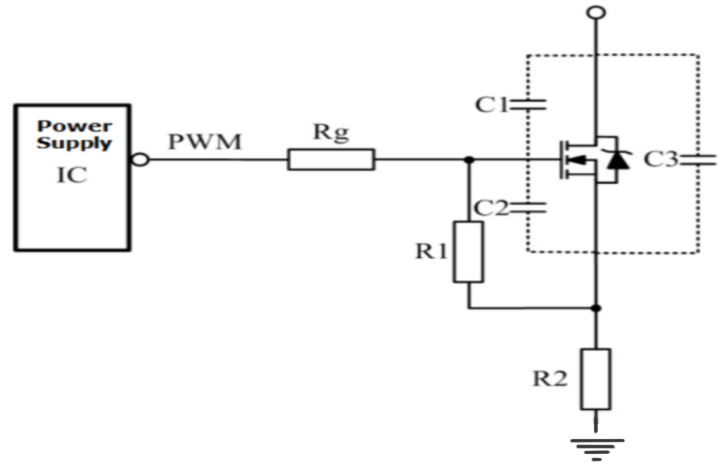



評論