在過去幾年中,SiC MOSFET 在高壓 (>600V) 和大功率應用中占據(jù)主導地位。熱導率、高臨界場、大大提高的開關(guān)效率以及在其表面形成二氧化硅的能力等優(yōu)勢使其能夠在關(guān)鍵工藝、設計和可靠性方面得到改進,從而使其能夠在一些高增長應用中大規(guī)模使用,例如在用于車載充電器、牽引逆變器和直流到直流轉(zhuǎn)換器、光伏逆變器、電機控制、運輸系統(tǒng)和電網(wǎng)的電動汽車。
早在 1990 年代,關(guān)于 GaN 的大多數(shù)研究都集中在藍色和最終白色 LED 和激光器的制造上。約 3.4 eV 的直接帶隙,通過金屬有機 CVD (MOCVD) 產(chǎn)生的異質(zhì)結(jié)層形成具有 Al、In、P 和量子限制的四元層的能力為此奠定了基礎(chǔ)。然后利用這項工作來利用高電子遷移率晶體管 (HEMT) 中實現(xiàn)的高電子遷移率和飽和速度來制造遠優(yōu)于其硅對應物的射頻器件。正是在 RF MMIC 領(lǐng)域,GaN PoweHEMT 工藝和設計技術(shù)得到了顯著改進,如今,它們構(gòu)成了一些重要的通信、雷達和電子戰(zhàn)設備的主干,其中一些設備的額定頻率超過或等于 RF X - 頻帶頻譜(8.5 至 11 GHz)。
這些射頻設備的電壓范圍通常在 <200V 范圍內(nèi)。橫向 HEMT 器件相對于垂直 V-DMOS 具有天然的缺點,通常用于SiC MOSFET 以創(chuàng)建 HV 器件(代表性器件橫截面見圖 1 (a) 和 1(b))。柵極和漏極之間的橫向漂移區(qū)中的高表面電場通常會限制高電壓限制,并且在塑造/降低電場的場板技術(shù)方面的一些進步將允許提高該額定值。
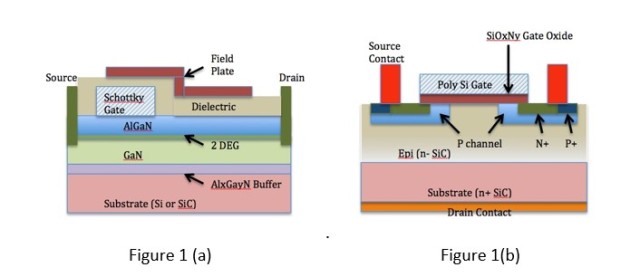
圖 1 (a) GaN Power HEMT 器件結(jié)構(gòu)和圖 1 (b) SiC VDMOS 器件結(jié)構(gòu)
表 1 列出了 SiC 和 GaN 的一些關(guān)鍵材料特性。
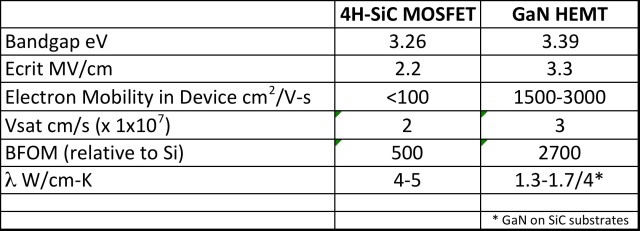
表 1:SiC MOSFET 和 GaN Power HEMT 的一些關(guān)鍵材料特性。BFOM 是 Baliga 品質(zhì)因數(shù)
應該注意的是,盡管文獻中引用的體 SiC 遷移率要高得多(~ 700 到 1000 cm2/Vs),但在 MOSFET 中獲得的遷移率要低得多,盡管這是由于 SiC/SiO2 處的陷阱位點界面。在形成器件傳導通道的 AlGaN/GaN 界面處形成的二維電子氣 (2-DEG) 上觀察并報告了 GaN Power HEMT 列出的遷移率。
從最初對射頻器件的關(guān)注開始,在 GaN 晶體管方面取得了巨大進展,以提供 HV 功率 FET 范圍內(nèi)的器件。Transphorm、ST Microelectronics、GaN Systems、Cambridge、Innoscience、GaN Power International 和 Texas Instruments 等多家公司提供額定電壓為 650V 或更高的器件。從電壓的角度來看,這達到了一些 EV 應用的最佳位置,例如 2 級車載充電器 (OBC) 和其他長期以來被認為屬于 SiC 領(lǐng)域的應用。GaN 提供更低的終端電容和更高的遷移率,允許器件縮放和更快、更高效的開關(guān)。沒有 pn 結(jié)也不會導致開關(guān)的反向恢復損失。傳熱和封裝成為關(guān)鍵限制,現(xiàn)在很多研究都集中在改善這一點。
下面的圖 2 和圖 3 說明了 GaN 在這些應用中的擴展空間。
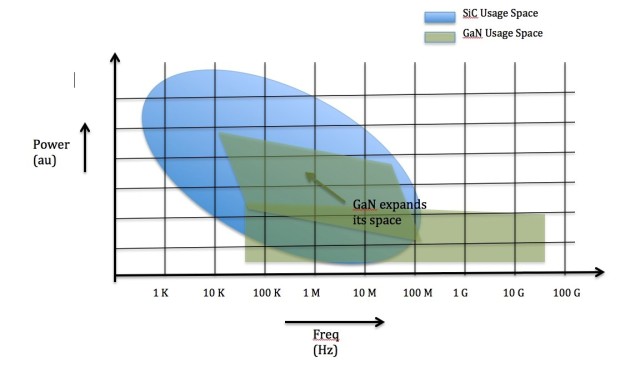
圖 2:GaN 在 SiC 功率 FET 領(lǐng)域的成長空間
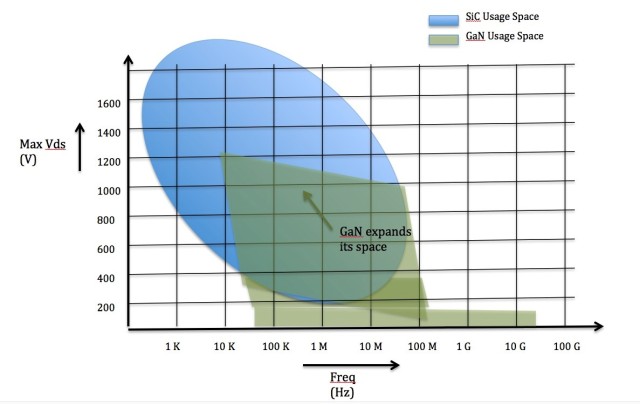
圖 3:GaN Power HEMT 的電壓與頻率空間使用情況
GaN 的生長通常在 SiC 或 Si 襯底上進行。緩沖層有助于緩解晶格失配造成的壓力。RF GaN 制造商通常選擇 GaN on SiC 方法,以利用 SiC 對高功率密度放大器的卓越熱能力。功率 FET 行業(yè)選擇了 GaN on Si 方法。硅襯底提供了一種更便宜的方法,也為 200 毫米晶圓制造提供了一條更簡單的途徑。Innoscience 在中國的 8 英寸 GaN on Si Fabs 已經(jīng)證明了這一點。
GaN Power HEMT 器件自然是耗盡模式器件(或 d 模式:常開,需要負 Vgs 才能關(guān)閉)。對于大多數(shù)功率 FET 應用,增強模式(或 e 模式:常關(guān),0V 應關(guān)閉器件)行為是必不可少的。為此,使用了兩種不同的方法。一方面,可以使用 p 型 GaN 或 AlGaN 柵極來修改勢壘高度,在該層下方創(chuàng)建一個耗盡區(qū),從而創(chuàng)建一個常關(guān)器件。這種方法受到許多人的青睞,用于生產(chǎn) e-mode HEMT 器件。另一種方法是將 LV Si-MOSFET 與 GaN 器件串聯(lián),如圖 4 所示。
兩種方法之間存在權(quán)衡。雖然單 e-mode 器件使用更簡單,并聯(lián)器件的復雜性更低,并提供出色的電容和反向恢復特性,但問題是由于 p-AlxGayN 的特性,很難實現(xiàn)遠高于 1.5V 的閾值電壓層。這使門容易受到開關(guān)噪聲和雜散器件行為的影響。

圖 4:級聯(lián)排列的 GaN d 模式 HEMT
使用共源共柵方案獲得了更加穩(wěn)健的柵極,Vt 處于有利的≥ 2.5V 范圍內(nèi)。較高的柵極裕度可以實現(xiàn)更直接的柵極驅(qū)動器。
為了比較設備行為以及每種方法的優(yōu)缺點,下面的表 2 中給出了參數(shù)分析。在此分析中,選擇了四個器件,兩個 SiC MOSFET 和兩個 GaN Power HEMT。所有四個都具有大約 650V 的最大 Vds 工作電壓和大約 20 mOhms 的 25C Rdson 額定值。兩個 GaN 器件標記為 G1 和 G2,而 SiC 器件標記為 S1 和 S2。此外,器件 S2 和 G2 使用相同的封裝,因此在這種情況下可以忽略封裝引起的某些 AC 特性的差異。

表 2:2 個 SiC 器件 S1、S2 與 2 個 GaN 功率 HEMT 器件 G1、G2 的參數(shù)比較
關(guān)注的參數(shù)以黃色突出顯示,有利的參數(shù)以綠色突出顯示。顯而易見的是,具有單一 e 模式器件的 G1 提供了 GaN 的一個關(guān)鍵優(yōu)勢,即沒有反向恢復電荷 Qrr。然而,高得多的 I gss柵極泄漏也突出了較差的柵極裕度。另一方面,G2 具有良好的柵極裕度,與 SiC 非常相似,但 Qrr 相應增加。
通常,較低的柵極電荷 Qg 在兩種 GaN 功率 HEMT 中都突出顯示。這可以顯著改進硬開關(guān)應用。
表 2 中突出顯示的 GaN 的一個明顯缺點是 Rdson 的溫度系數(shù)較差,在 150C 時 ≥ 25oC Rdson 的兩倍。也有人認為,如果目標是滿足某個 150oC 的 Rdson,則 GaN 器件實際上必須在 25oC 時有多余的裕量,并相應增加芯片尺寸和柵極/輸出電容。Rdson 的增加使得更并行的設備方法更加關(guān)鍵。由于寄生元件種類繁多,特別是在級聯(lián)排列中,并聯(lián) GaN 器件可能會帶來挑戰(zhàn)。具有自適應控制的集成柵極驅(qū)動器可能是一種可能的解決方案。
審核編輯 黃昊宇
-
半導體
+關(guān)注
關(guān)注
339文章
30751瀏覽量
264352 -
設計
+關(guān)注
關(guān)注
4文章
826瀏覽量
71328 -
SiC
+關(guān)注
關(guān)注
32文章
3726瀏覽量
69443 -
GaN
+關(guān)注
關(guān)注
21文章
2367瀏覽量
82513
發(fā)布評論請先 登錄
CHA6154-99F三級單片氮化鎵(GaN)中功率放大器
快充國產(chǎn)替代新突破!爭妍微650V GaN HEMT賦能300W USB-C PD,替代英諾賽科INN650D02

瞻芯電子G2 650V SiC MOSFET的魯棒性驗證試驗

PI技術(shù)白皮書 1250V/1700V PowiGaN HEMT在800VDC AI數(shù)據(jù)中心架構(gòu)中的應用
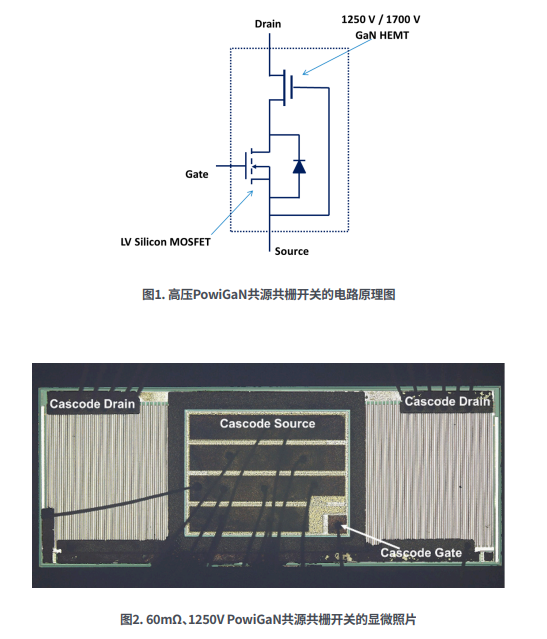
GaN HEMT器件的結(jié)構(gòu)和工作模式

東芝推出三款最新650V SiC MOSFET

三種功率器件的區(qū)別解析

功率器件測量系統(tǒng)參數(shù)明細
SGK5872-20A 是一款高功率 GaN-HEMT,其內(nèi)部匹配標準通信頻段,可提供最佳功率和線性度。
增強AlN/GaN HEMT
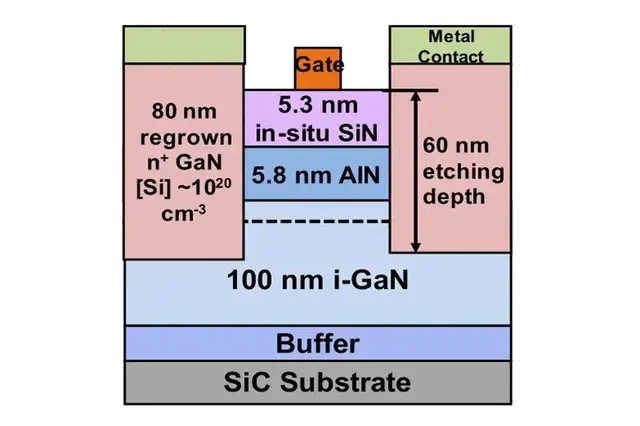
什么是IGBT/SiC/GaN HEMT功率芯片/模塊/模組?特性是什么?主要應用哪里?
深度分析650V國產(chǎn)碳化硅MOSFET的產(chǎn)品力及替代高壓GaN器件的潛力
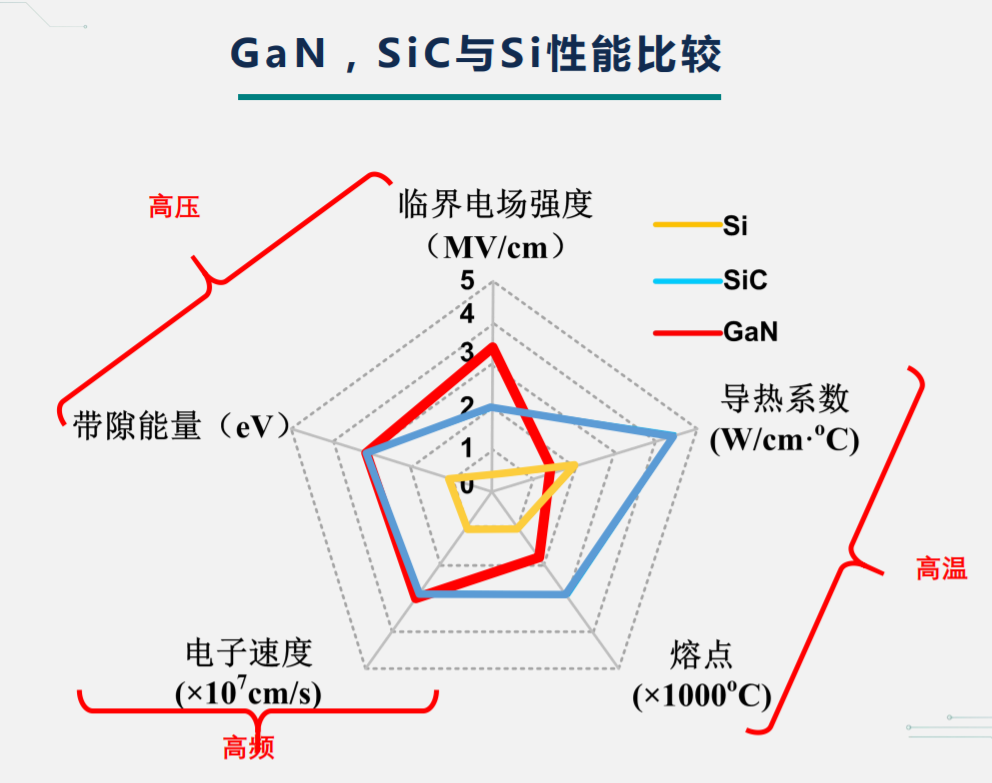
SiC MOSFET 開關(guān)模塊RC緩沖吸收電路的參數(shù)優(yōu)化設計
GaN HEMT的SPICE模型使用指南及示例
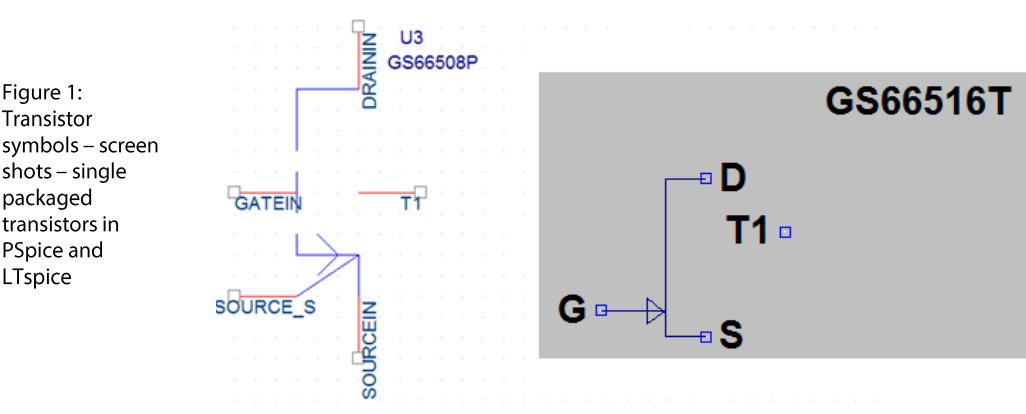



 GaN Power HEMT > 650 V:與 SiC MOSFET 的參數(shù)分析和比較
GaN Power HEMT > 650 V:與 SiC MOSFET 的參數(shù)分析和比較





評論