摘要
研究了在半導體制造過程中使用的酸和堿溶液從硅片表面去除粒子。結果表明,堿性溶液的顆粒去除效率優于酸性溶液。在堿性溶液中,顆粒去除的機理已被證實如下:溶液腐蝕晶圓表面以剝離顆粒,然后顆粒被電排斥到晶圓表面。實驗結果表明,需要0.25 nm /min以上的刻蝕速率才能使吸附在晶圓表面的顆粒脫落。
介紹
由于半導體器件正在追求更高水平的-集成度和更高分辨率的模式,ET清潔技術對于重新-移動硅片表面的污染物仍然至關重要。在1970年提出的RCA清洗工藝作為一種濕式清洗技術在世界各地仍在使用,以去除晶圓表面的污染物。雖然RCA凈化-過程中,NH4OH-H2O2-H2O溶液對-顆粒的去除效果非常好,但其顆粒去除機理尚不完全清楚。
實驗
采用五英寸CZ(1,0,0)晶片進行粒子吸附實驗。天然氧化物首先在0.5%的HF溶液中從晶圓表面去除。然后將晶片浸泡在含有顆粒的各種溶液中10分鐘,然后沖洗和干燥。天然氧化物在晶圓表面形成后,再在0.5%的HF溶液中移動,然后清洗和干燥。
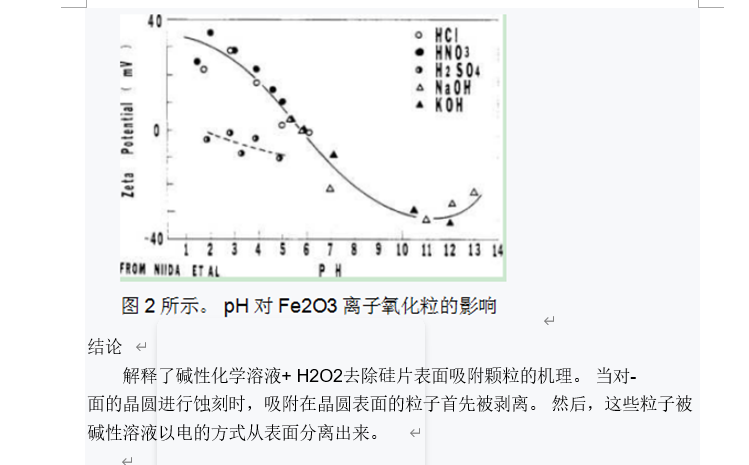
審核編輯:湯梓紅
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
半導體
+關注
關注
339文章
31055瀏覽量
265666 -
晶圓
+關注
關注
53文章
5434瀏覽量
132522 -
制造
+關注
關注
2文章
560瀏覽量
24841
發布評論請先 登錄
相關推薦
熱點推薦
襯底清洗全攻略:從濕法到干法,解鎖半導體制造的“潔凈密碼”
襯底清洗是半導體制造、LED外延生長等工藝中的關鍵步驟,其目的是去除襯底表面的污染物(如顆粒、有機物、金屬離子、氧化層等),確保后續薄膜沉積

濕法清洗過程中如何防止污染物再沉積
在濕法清洗過程中,防止污染物再沉積是確保清洗效果和產品質量的關鍵。以下是系統化的防控策略及具體實施方法:一、流體動力學優化設計1.層流場構建技術采用低湍流度的層流噴淋系統(雷諾數Re9),同時向溶液

半導體哪些工序需要清洗
半導體制造過程中,清洗工序貫穿多個關鍵步驟,以確保芯片表面的潔凈度、良率和性能。以下是需要清洗的主要工序及其目的: 1. 硅片準備階段
超聲波清洗機如何在清洗過程中減少廢液和對環境的影響?
超聲波清洗機如何在清洗過程中減少廢液和對環境的影響隨著環保意識的增強,清洗過程中的廢液處理和環境保護變得越來越重要。超聲波清洗機作為一種高效的清洗

wafer清洗和濕法腐蝕區別一覽
步驟,以下是兩者的核心區別: 1. 核心目的不同 Wafer清洗:主要目的是去除晶圓表面的污染物,包括顆粒、有機物、金屬雜質等,確保晶圓表面



 濕法清洗過程中硅片表面顆粒的去除
濕法清洗過程中硅片表面顆粒的去除






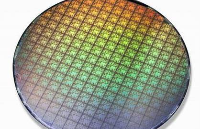





評論