2015年代號為Fiji的AMD Fury X顯卡發布,代表著HBM顯存第一次進入大眾視野。將傳統傳統的2D顯存引向立體空間,通過堆疊,單個DIE可以做到8GB容量,位寬也高達1024bit。相比之下傳統的顯存單Die只有1GB容量,位寬只有32bit。
因此HBM顯存可以很輕易的做到32GB容量、4096bit帶寬,同時不需要太高的頻率就能達到傳統的GDDR5顯存所無法企及的恐怖帶寬。
2017年,隨著Zen構架的銳龍處理器問世,AMD也讓我們見識到了MCM(Multichip Module)技術。采用模塊化設計的銳龍處理器單個CCD含有8個核心,將2個CCD封裝在一起就能變成4核,32核的撕裂者2990WX擁有4個CCD。
MCM技術的出現使得多核擴展變得更加簡單高效,同時也避免了大核心帶來的良率問題,因此在成本上要遠遠優于競品。
而2019年的Zen 2構架則將MCM技術再一次升級為Chiplet。通過將CPU Die與I/O Die進行分離,CPU Die可以做的更小,擴展更多核心的時候也相應的變得更加容易,同時也進一步降低的了多核處理器的制造成本。按照AMD的說法,在某些情況下,Chiplet設計可以將處理器制造成本降低一半以上。
在今天早上的AMD財務分析大會上,AMD CEO 蘇姿豐又向大家展示了一種名為X3D的封裝技術,它是在原有的Chiplet技術上加入了HBM的2.5D堆疊封裝。雖然AMD沒有明說,但是意圖非常明顯,未來的高性能處理器極有可能會引入HBM內存,從而將內存帶寬提升10倍以上。
如果順利的話,我們在Zen 4構架上就能看到這種設計,新一代AMD處理器的性能相當令人期待!
責任編輯:gt
-
處理器
+關注
關注
68文章
20255瀏覽量
252299 -
amd
+關注
關注
25文章
5684瀏覽量
139971 -
封裝
+關注
關注
128文章
9249瀏覽量
148626
發布評論請先 登錄
AMD 推出銳龍 AI 嵌入式處理器產品組合,為汽車、工業和物理 AI 領域提供 AI 驅動的沉浸式體驗

探秘HAL 39xy:新一代3D位置傳感器的卓越表現
AMD推出 EPYC 嵌入式 2005 系列處理器 滿足長期部署需求

納芯微正式推出新一代線性位置傳感器MT911x與MT912x系列
新一代高效電機技術—PCB電機
龍芯發布國產自研新一代處理器 龍芯中科新一代處理器3C6000/2K3000/3B6000M芯片面世 瞄準服務器和AI處理器

米爾NXP i.MX 91核心板發布,助力新一代入門級Linux應用開發
芯馳科技重磅發布最新一代AI座艙芯片X10
Nordic新一代旗艦芯片nRF54H20深度解析
芯原推出新一代集成AI的ISP9000圖像信號處理器,賦能智能視覺應用
異形拼接處理器支持哪些顯示技術?
AMD EPYC嵌入式9005系列處理器的功能特性




 AMD展示處理器新一代的X3D封裝技術,將在Zen 4構架上實現
AMD展示處理器新一代的X3D封裝技術,將在Zen 4構架上實現

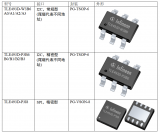




評論