基本概念與光路設置
透射電子顯微鏡(TEM)的成像系統由三級透鏡組構成,其中物鏡后焦面是衍射譜所在的位置。在該平面上插入可移動的“物鏡光闌”(objective aperture)后,可以人為地限定能夠進入后續透鏡并最終成像的電子束。
明場像(Bright-Field, BF) :把光闌孔徑對準透射束(000斑點),僅允許透射電子通過,其余衍射束及散射電子被擋掉,由此獲得的像稱為明場像。
暗場像(Dark-Field, DF) :將光闌孔徑移至任一衍射斑點位置,僅讓該衍射束通過,其余電子束被遮擋,得到的圖像即為暗場像。
中心暗場像(Centered Dark-Field, CDF) :為降低離軸像差,現代電鏡使用偏轉線圈把選定的衍射束(hkl)精確地折轉到光軸中心,再讓光闌孔徑仍保持原位。這樣得到的圖像既屬于暗場模式,也具備了更高的空間分辨率,習慣上稱“中心暗場像”。
光闌的位置與作用
物鏡光闌位于物鏡后焦面,它既能“過濾”掉不需要的散射電子,減少背景噪聲,又決定了圖像的襯度來源。改變光闌位置即改變成像電子束,從而切換明場與暗場模式。
襯度機制的互補與例外
1. 布拉格條件下的互補關系
在接近理想的雙束條件下(透射束+單一強衍射束),若忽略吸收與多次散射,則透射束強度 I_T 與衍射束強度 I_D 滿足 I_0 ≈ I_T + I_D(I_0為入射束強度)。
明場像中,滿足布拉格條件的區域因衍射強度高而透射強度低,呈現暗襯度;
暗場像中,同一區域因衍射強度高而呈現亮襯度。因此,雙束條件下的明、暗場像襯度近似互補,這也是教科書常見說法的來源。
2. 非理想條件與襯度非互易
當樣品取向偏離雙束條件,或存在多個強衍射束時,衍射花樣呈多束分布。不同衍射束對同一區域的衍射強度差異顯著;明場像的暗區未必在暗場像中全亮,反之亦然。以 Cu-12.7Al 合金馬氏體為例:
明場像(a)顯示若干灰度差異明顯的片層;
衍射花樣(b)揭示兩套疊加斑點,分別對應馬氏體變體;
分別用斑點 A、B 做 CDF(c、d)后,可見不同片層被選擇性點亮;
明場像的功能定位
1. 形貌與晶粒統計
明場像直觀給出樣品厚度、表面起伏、孔洞裂紋等宏觀形貌,且相鄰晶粒因取向差異導致衍射條件不同,呈現灰度差異,可直接用于晶粒尺寸分布統計。金鑒實驗室在進行試驗時,嚴格遵循相關標準操作,確保每一個測試環節都精準無誤地符合標準要求。
2. 缺陷可視化
晶體缺陷(位錯、層錯、孿晶)或局域應變會導致取向微小變化,在明場像中表現為彎曲消光輪廓或條紋,據此可判斷缺陷類型與密度。
3. 第二相識別
基體與第二相通常具有不同晶體結構或取向,衍射條件差異使兩者在明場像中呈現不同襯度,有經驗的研究者可快速評估第二相的形貌、分布與體積分數。
4. 非晶樣品表征
非晶材料缺乏衍射襯度,僅存在質量-厚度襯度,此時明場像仍是觀察顆粒形貌、測量尺寸的唯一手段。
暗場像的獨特優勢
1. 弱襯度結構的增強
當析出相與基體共格或取向差異極小時,明場像中兩者灰度接近,難以分辨。通過暗場像僅讓析出相的衍射束成像,可顯著增強其襯度,實現尺寸、形貌、分布的精準測量。
2. 高應變/細晶結構的統計
塑性變形引入的高密度位錯與取向梯度使晶粒在明場像中邊界模糊。選擇對應衍射束做暗場成像,可把畸變晶粒的衍射信號單獨提取出來,從而更準確地進行晶粒尺寸或織構分析。
3. 缺陷的定向觀察
位錯、層錯等缺陷在不同衍射矢量 g 下的可見性遵循 g·b 判據。通過依次選擇不同衍射束做暗場像,可逐一驗證缺陷的伯格斯矢量或慣習面方向,實現定量缺陷學分析。
結語
明場像與暗場像并非簡單“亮/暗”互換,而是基于衍射物理的兩種互補成像策略:明場像以透射束為主,適合宏觀形貌、缺陷初篩;暗場像以特定衍射束為主,擅長弱襯度結構、精細缺陷及晶體學參數的定向提取。
-
電子束
+關注
關注
2文章
135瀏覽量
14062 -
TEM
+關注
關注
0文章
123瀏覽量
11169 -
透射電子顯微鏡
+關注
關注
0文章
17瀏覽量
2351
發布評論請先 登錄
電子顯微術(Electron Microscopy,EM)的分類以及基礎知識
透射電鏡(TEM)
透射電子顯微鏡的結構與成像原理

透射電子顯微鏡成像原理資料下載

透射電子顯微鏡TEM的原理、參數及應用
【應用案例】透射電子顯微鏡TEM

透射電子顯微鏡的用途和特點
透射電子顯微鏡(TEM)的優勢及應用
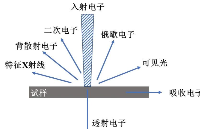
什么是透射電子顯微鏡(TEM)?

透射電子顯微鏡(TEM)與聚焦離子束技術(FIB)在材料分析中的應用




 透射電子顯微術中的明暗場成像:原理、互補關系與功能區分
透射電子顯微術中的明暗場成像:原理、互補關系與功能區分


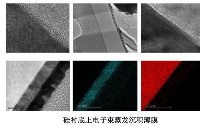


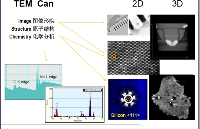



評論