近幾年,倒裝芯片(Flip-chip)技術(shù)越來(lái)越多地在消費(fèi)類電子、高性能產(chǎn)品上應(yīng)用。在倒裝芯片封裝過(guò)程中,無(wú)鉛錫膏可被用于基板凸點(diǎn)制作、模塊及板級(jí)連接等。在實(shí)際應(yīng)用中應(yīng)該選擇什么樣的無(wú)鉛錫膏呢?
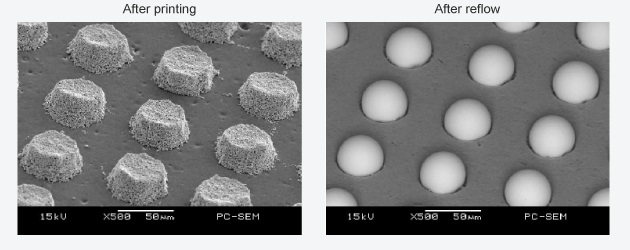
結(jié)合自身情況考慮工藝特性
由于無(wú)鉛錫膏性質(zhì)特點(diǎn),無(wú)鉛錫膏許多特性間存在需要取舍的矛盾關(guān)系,這就造成了不可能有完美的產(chǎn)品,而需要根據(jù)工藝特性選擇錫膏。例如,當(dāng)選定合金焊料后,若要增大錫膏在被焊金屬表面的潤(rùn)濕性,就需要增大錫膏助焊劑的活性,而活性的增大就會(huì)增大焊接后被焊表面被助焊劑殘留物腐蝕的可能。

還要考慮倒裝芯片多次階梯回流的要求。芯片倒裝焊接后,還需要進(jìn)行模塊或板級(jí)互聯(lián),維持焊料熔點(diǎn)層級(jí)要求必須在選擇錫膏是考慮。
考慮焊接后倒裝芯片互聯(lián)結(jié)構(gòu)的可靠性
熱疲勞可靠性、跌落沖擊可靠性以及電遷移可靠性等是影響倒裝芯片互聯(lián)結(jié)構(gòu)可靠性的重要影響因素。
有研究表明,對(duì)于不同周期的熱循環(huán),不同合金成分錫膏焊點(diǎn)所顯示的焊點(diǎn)疲勞壽命不同。在0~100℃、120min的長(zhǎng)周期熱循環(huán)條件下,低Ag含量[2.1%(質(zhì)量分?jǐn)?shù))]無(wú)鉛錫膏焊點(diǎn)的熱疲勞壽命最長(zhǎng),而在0~100℃、30min的短周期熱循環(huán)條件下,高Ag含量[3.8%(質(zhì)量分?jǐn)?shù))]無(wú)鉛錫膏焊點(diǎn)的疲勞壽命最長(zhǎng)。可見(jiàn),在選用錫膏時(shí)還需要根據(jù)工藝條件選擇合適的錫膏提高可靠性。
倒裝芯片封裝應(yīng)該選擇什么樣的無(wú)鉛錫膏是一個(gè)需要多方面綜合考慮的問(wèn)題,既要包括工藝條件又要包括錫膏特性。選擇一個(gè)適合的倒裝芯片無(wú)鉛錫膏對(duì)于SMT等工藝具有重要的意義,不能盲目篩選,需要具體咨詢相關(guān)專業(yè)工程師比較可靠,福英達(dá)愿意為此提供免費(fèi)的咨詢解決方案,歡迎垂詢!
審核編輯:湯梓紅
-
封裝
+關(guān)注
關(guān)注
128文章
9303瀏覽量
148937 -
倒裝芯片
+關(guān)注
關(guān)注
1文章
123瀏覽量
16865
發(fā)布評(píng)論請(qǐng)先 登錄
如何選擇適合的錫膏生產(chǎn)廠家

低溫錫膏和高溫錫膏的區(qū)別知識(shí)大全
關(guān)于固晶錫膏與常規(guī)SMT錫膏有哪些區(qū)別

無(wú)鉛錫膏和有鉛錫膏的對(duì)比知識(shí)

無(wú)鉛錫膏規(guī)格型號(hào)詳解,如何選擇合適的錫膏

佳金源錫膏廠家為你總結(jié)錫膏的熔點(diǎn)為什么不相同?

從工藝到設(shè)備全方位解析錫膏在晶圓級(jí)封裝中的應(yīng)用

晶圓級(jí)封裝的 “隱形基石”:錫膏如何決定芯片可靠性?

錫膏使用50問(wèn)之(35-36):BGA 封裝焊點(diǎn)空洞率超標(biāo)、 倒裝封裝錫膏印刷偏移導(dǎo)致短路怎么解決?短路

倒裝 LED?芯片焊點(diǎn)總 “冒泡”?無(wú)鉛錫膏空洞難題如此破!

除了固晶工藝還有哪些封裝連接技術(shù)?錫膏為何成為高端制造的 “剛需”?




 倒裝芯片封裝選擇什么樣的錫膏?
倒裝芯片封裝選擇什么樣的錫膏?







評(píng)論