通過測量晶片上的殘留物得知,晶片上已經分配并干燥了含有金屬鹽作為示蹤元素的溶液。假設有兩種不同的沉積機制:吸附和蒸發沉積。
第一種機制是污染物和晶圓表面之間吸引相互作用的結果,而第二種機制是由于干燥過程中的液體蒸發。
對于第二種情況,蒸發膜厚度被引入作為所研究干燥過程的品質因數。將旋轉干燥與兩種基于 Marangoni 的干燥進行了比較:在垂直移動的晶圓上和在水平旋轉的晶圓上。
結果表明,對于旋轉干燥,會發生兩個連續的階段:在旋轉的前幾秒,液體對流去除是主要機制,隨后是蒸發接管的階段。旋轉干燥過程中液體蒸發量與旋轉速度的平方根成反比。這表明晶片表面上的氣流夾帶液體是蒸發的主要機制。這一發現與描述旋轉基板夾帶的氣體流動的流體動力學模型一致。在垂直移動的晶圓上和水平旋轉的晶圓上。
審核編輯:湯梓紅
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
芯片
+關注
關注
463文章
54017瀏覽量
466305 -
半導體
+關注
關注
339文章
30751瀏覽量
264339 -
晶圓
+關注
關注
53文章
5411瀏覽量
132312
發布評論請先 登錄
相關推薦
熱點推薦
定義光刻精度標準——華林科納顯影濕法設備:納米級圖形化解決方案
提供可靠的圖形化保障。以下深度解析其工藝優勢與技術創新。 一、設備核心工藝流程 華林科納四步閉環工藝,實現亞微米級圖形保真 (1)預處理(Pre-wetting) 去離子水浸潤:均勻潤濕晶

晶圓去膠工藝之后要清洗干燥嗎
在半導體制造過程中,晶圓去膠工藝之后確實需要進行清洗和干燥步驟。以下是具體介紹:一、清洗的必要性去除殘留物光刻膠碎片:盡管去膠工藝旨在完全去除光刻膠,但在實際操作中,可能會有一些微小的


晶圓清洗后如何判斷是否完全干燥
判斷晶圓清洗后是否完全干燥需要綜合運用多種物理檢測方法和工藝監控手段,以下是具體的實施策略與技術要點:1.目視檢查與光學顯微分析表面反光特性觀察:在高強度冷光源斜射條件下,完全干燥的

晶圓邊緣 TTV 測量的意義和影響
摘要:本文探討晶圓邊緣 TTV 測量在半導體制造中的重要意義,分析其對芯片制造工藝、器件性能和生產良品率的影響,同時研究測量方法、測量設備精度等因素對測量結果的作用,為提升


提供半導體工藝可靠性測試-WLR晶圓可靠性測試
隨著半導體工藝復雜度提升,可靠性要求與測試成本及時間之間的矛盾日益凸顯。晶圓級可靠性(Wafer Level Reliability, WLR)技術通過直接在未封裝晶
發表于 05-07 20:34
濕法刻蝕:晶圓上的微觀雕刻
在芯片制造的精密工藝中,華林科納濕法刻蝕(Wet Etching)如同一把精妙的雕刻刀,以化學的魔力在晶圓這張潔白的畫布上,雕琢出微觀世界的



 華林科納的半導體晶圓干燥的研究
華林科納的半導體晶圓干燥的研究



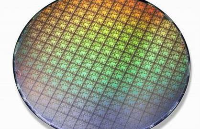







評論