摘要
濕清洗后,用原子分辨掃描隧道顯微鏡對氫端Si表面進(jìn)行觀察。當(dāng)將Si晶片浸入稀釋的含高頻溶液中時,通過堆積小梯田和臺階來構(gòu)建表面。當(dāng)用超純水沖洗樣品時,可以清楚地觀察到一些特征,如露臺內(nèi)的鋸齒狀鏈、階梯邊緣的一行和露臺上孤立的鋸齒狀鏈,并確定它們的原子排列。然而,過度的沖洗產(chǎn)生了納米高度的脊?fàn)罱Y(jié)構(gòu),這可以用水中氫氧化物離子的各向異性蝕刻來解釋。
介紹
硅晶片是半導(dǎo)體器件的一種有前途的襯底,因為用自由基氧化法制備的硅的空穴遷移率已經(jīng)達(dá)到硅的2.4倍。人們對采用硅襯底制造超大規(guī)模集成電路器件重新產(chǎn)生了興趣。為了實現(xiàn)比現(xiàn)在更高性能的互補(bǔ)金屬氧化物半導(dǎo)體電路,有必要平坦化柵極絕緣體和硅襯底之間的界面,因為界面粗糙度決定了金屬氧化物半導(dǎo)體晶體管的載流子遷移率。為此,在形成柵極絕緣體之前,需要濕法清洗過程來用氫原子終止硅表面,并在原子尺度上將其平坦化。已經(jīng)進(jìn)行了許多嘗試來研究各種濕法清洗工藝對原子尺度上的硅或硅的表面結(jié)構(gòu)的影響。這項研究的目的是闡明原子氫封端的硅表面浸入稀含氟化氫溶液后的結(jié)構(gòu),即對硅片進(jìn)行初步清洗,然后用超純水沖洗。提出了一種獲得原子級平坦氫封端硅表面的方法。
實驗
在本研究中,所有樣品都是n型硅,其電阻率為10伏厘米。在形成犧牲氧化物后,將每個樣品浸入H2SO 4 97wt %的溶液中。 H2O230wt%重量=4:1(按體積計)10分鐘,然后用超純水沖洗10分鐘。然后將每個樣品浸入50wt %的氫氟烷烴溶液中。H2O2 s30%重量。H2O=1:1:98(按體積計)持續(xù)3分鐘,以去除犧牲的氧化物并用氫原子終止表面(樣品A)。因此,在濕法清洗過程中避免了硅表面的有機(jī)碳?xì)埩艉徒饘傥廴尽1砻娴氖杷曰蚋道锶~變換紅外光譜測量證實每個樣品表面都是氫封端的。在濕法清洗過程的15分鐘內(nèi),硅樣品被引入超高真空(UHV)室。
圖1顯示了浸入含氟化氫的稀溶液后表面的典型掃描隧道顯微鏡圖像(樣品甲)。

結(jié)果和討論
水中的氫氧離子會腐蝕硅表面。5–7圖中的表面原子很可能處于高反應(yīng)性位置。優(yōu)先在用超純水沖洗的短時間內(nèi)被去除,以形成圖1所示的表面結(jié)構(gòu)。表面的放大圖像(樣品B)如圖所示。其中掃描面積為7.037.0 nm2.形成階梯和臺階的原子圖像清晰可見。圖2中的主要特征。
圖5顯示了在稀釋的含HF溶液中清洗并隨后用超純水沖洗60分鐘后Si樣品的典型STM圖像(樣品c)。RPV和Rrms分別為1.65 nm和0.22 nm。沿著圖110中的f 110g方向所獲得的帶有臺階和臺階的表面。圖5與圖1非常相似。2.然而,沿著f 110g方向的納米高度的脊?fàn)罱Y(jié)構(gòu),如圖1中的箭頭D所示。5、經(jīng)常被觀察。據(jù)報道,各向異性蝕刻在超純水中進(jìn)行,以顯示硅或硅晶片上的面。很可能在60分鐘的沖洗過程中,在硅表面上發(fā)生各向異性蝕刻以形成微相,這導(dǎo)致如圖1中箭頭D所示的脊?fàn)罱Y(jié)構(gòu)的形成。


結(jié)論
總之,氫封端的硅表面在浸入含氟化氫溶液中,然后用超純水沖洗后,用掃描隧道顯微鏡在原子尺度上觀察到。當(dāng)硅晶片浸入含氫氟化合物溶液中時,其表面由沿不同方向排列的小平臺和臺階構(gòu)成。結(jié)果表明,用超純水適度沖洗可形成均勻的硅表面,其微觀粗糙度得到改善。即形成大的階地,大部分臺階邊緣沿f 110g方向延伸。另一方面,由于超純水各向異性刻蝕出現(xiàn)微形貌,過度的清洗會使具有納米高度脊?fàn)罱Y(jié)構(gòu)的硅表面粗糙化。這些結(jié)果表明,在用含氫溶液清洗后,硅晶片的清洗持續(xù)時間應(yīng)得到控制,以獲得原子級平坦的氫封端表面。
審核編輯:湯梓紅
-
半導(dǎo)體
+關(guān)注
關(guān)注
339文章
30751瀏覽量
264352 -
晶體管
+關(guān)注
關(guān)注
78文章
10396瀏覽量
147832 -
蝕刻
+關(guān)注
關(guān)注
10文章
428瀏覽量
16624
發(fā)布評論請先 登錄
濕法清洗和干法清洗,哪種工藝更適合先進(jìn)制程的硅片

集成電路制造中常用濕法清洗和腐蝕工藝介紹

晶圓刻蝕清洗過濾:原子級潔凈的半導(dǎo)體工藝核心
革新半導(dǎo)體清洗工藝:RCA濕法設(shè)備助力高良率芯片制造
襯底清洗全攻略:從濕法到干法,解鎖半導(dǎo)體制造的“潔凈密碼”

硅片濕法清洗工藝存在哪些缺陷

濕法清洗尾片效應(yīng)是什么原理
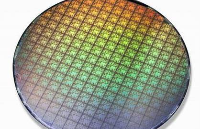
如何選擇合適的濕法清洗設(shè)備

濕法刻蝕是各向異性的原因

半導(dǎo)體濕法flush是什么意思
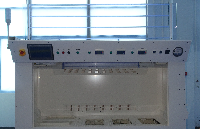
晶圓蝕刻后的清洗方法有哪些




 濕法清洗后氫封端表面的原子級分析
濕法清洗后氫封端表面的原子級分析




評論